高压功率模块封装绝缘的可靠性研究综述
转自半导体在线
(原文来源:中国电机工程学报
上海交通大学 李文艺,王亚林,尹毅)
摘要:
随着高压功率模块在直流输电、高速铁路和新能源发电等领域的普及和应用,高压功率模块的可靠性问题将越来越突出。本文阐述了高压功率模块封装结构、绝缘材料、放电检测、失效机理以及可靠性改进等方面研究的最新进展。首先,针对现有的高压功率模块封装结构,分析了广泛应用的高压硅基IGBT和SiC MOSFET模块的封装结构以及高压功率模块封装绝缘材料的类型与特性。随后评述了高压功率模块封装绝缘的老化和失效机理以及现有的局部放电评估标准和测量方法。此外,总结了高压功率模块封装绝缘可靠性改进的方法。在综述的基础上,结合高压功率模块小型化、集成化、耐高温化的发展趋势,指出了高压功率模块封装绝缘的主要威胁、挑战和发展趋势。
0 引言
近年来,功率芯片和模块的研发取得了长足的进步。功率器件和模块的高压化、大功率化、高功率密度化是未来重要的发展方向。目前硅(Si)基半导体芯片的性能已达到材料的理论极限,新一代宽禁带(Wide Band Gap,WBG)半导体材料,例如碳化硅(SiC)和氮化镓(GaN),由于具有比 Si更好的电、机械和热性能而逐渐成为研究热点。用WBG 半导体代替 Si 基半导体可以承受更高的击穿电压,实现更快的开关速度,更低的开关损耗和更高的工作温度。因此,具有出色性能的 WBG 功率器件和模块被广泛用于汽车电机驱动、油气钻探和提取、航空电子电源和军事等领域。
然而,受封装技术研发的限制,现有的高压功率模块生产商诸如Cree和Infineon等公司可提供的SiC 或 GaN功率模块产品的工作电压和工作温度远未达到宽禁带半导体材料的极限参数。虽然科研人员已经成功在实验室研发出 15 kV 的 SiCMOSFET 以及 20 kV 的 SiC IGBT 芯片和模块,但封装技术的不足却放慢了高压宽禁带功率模块投入市场的脚步,需要解决的瓶颈问题之一就是高压功率模块封装材料在多物理场耦合应力作用下的可靠性问题。加入功率半导体行业交流群,加VX:tuoke08。在工业应用过程中,与封装相关的失效形式主要包括冷热循环造成的焊料层开裂、基板金属层与陶瓷层开裂以及局部放电发展所造成的绝缘击穿等,与封装相关的失效在功率模块所有的失效形式中占据很大的比例。为提高电能转换效率、增加功率密度以及降低系统投入成本,高压功率模块的尺寸越来越小,工作电压和工作温度却越来越高,直接导致封装绝缘材料承受更大的电应力和热应力,这对封装材料的绝缘性能提出了更高的要求。
本文重点就高压功率模块的封装结构与绝缘材料、封装绝缘失效机理与试验方法以及封装绝缘可靠性改进 3 个关键方面对现有的高压功率模块的封装绝缘研究进行了分析与梳理,并总结高压功率模块封装绝缘所面临的机遇和挑战。
1 典型高压功率模块的封装结构
由于应用场合与设计目标的多样性,功率模块针对不同的使用要求具有多种多样的结构。一般来说,功率模块的封装结构主要可以分为键合线型和非键合线型。键合线型功率模块通常具有较高的寄生电感。寄生电感在开关器件的快速开关过程中造成电压过冲,进而导致瞬态电压升高、损耗增加和强的电磁干扰等问题,威胁高压功率模块封装绝缘的可靠性。杂散参数与开关换流回路的拓扑和封装结构有关,金属键合连接方式、元件引脚以及多个芯片的布局方式是影响寄生电感的重要因素。
为了降低模块封装中的寄生电感,一些研究人员选择倒装芯片技术和低温烧结陶瓷技术降低通态电阻;用印刷电路板(Printed Circuit Board,PCB)与直接覆铜陶瓷基板(Direct Bonding Copper,DBC)结合、DBC 与 DBC 结合或者柔性 PCB与 DBC 结合形成混合封装模块;采用端子直连的焊接方法实现与电源板直接键合;采用SiPLIT 结构实现平面互连;将电源开关和控制器、芯片嵌入到模块中形成集成式模块;用双面冷却结构来降低热阻和寄生参数;用 3D 结构实现极低的寄生电感(小于 1nH)。然而,迄今为止,这些低电感封装主要在额定电压为1.2kV 或更低的 Si 和 SiC 模块上应用。对于高压功率模块封装优化设计的研究很有限。
1.1 键合线型高压功率模块
键合线型功率模块由于研发历史久,技术成熟,成本低,在工业中得到广泛应用。键合线型功率模块的封装结构通常包括功率芯片(chips)、键合线(bond wire)、基板(substrate,也有翻译成衬底)、焊料(solder)、底板(baseplate)和灌封(encapsulant)等,如图 1 所示。高压功率模块的主要封装绝缘材料包括灌封绝缘材料和基板绝缘材料。具有不同电位的基板金属电极相隔一段绝缘距离覆盖在基板陶瓷上,灌封绝缘材料同时包裹基板金属电极和基板陶瓷,因此基板金属电极、基板陶瓷和灌封绝缘构成了不均匀电场下的“三固体”绝缘结构。基板金属、基板陶瓷和灌封绝缘三结合点处由于几何结构的原因导致电场畸变最严重,局部放电和老化现象容易在该部位发生,最终导致绝缘失效。
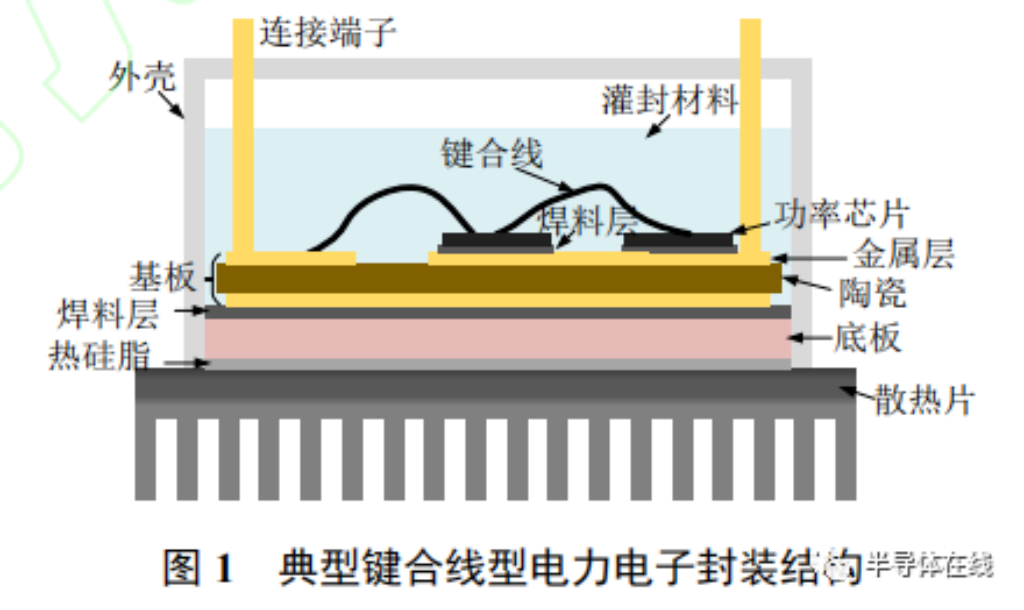
1.1.1 键合线型 SiC MOSFET 高压功率模块
2010 年,Wolfspeed 公司发布了第一个商用10kV、120A SiC MOSFET 模块。模块使用 24 个 SiCMOSFET和12个肖特基二极管焊接在AlN基板上,DBC 焊盘直接镀镍用于管芯附着和引线键合。然而,该功率模块并联芯片的功率环路电感的不对称导致了显著的动态电流不平衡。此外,键合线型封装结构的回路电感和杂散电容较大,限制了模块的工作性能。
此后,Wolfspeed 开发了第三代模块化、低电感、低热阻的 10kV SiC MOSFET 模块。端子沿封装对称分布,减少了并联芯片之间的功率回路电感不对称,通过最小化功率环路长度以降低模块寄生电感。此外,还采用高热导率的封装材料来降低模块的热阻。第三代功率模块相比第一代性能有了明显的改进,电流密度增加了一倍,结壳热电阻几乎减少了一半,分布式电源端子结构使得功率环路电感低了 57%。但是该产品仍然具有改进的空间:
整个功率回路的寄生电感仍然有 16nH,寄生电感带来的问题仍然存在;
第三代模块的面积只比第一代小 5%,基板寄生电容仍很大,导致开关过程中高 dv/dt 产生较大的电磁干扰和电压过冲,进而影响绝缘可靠性。
1.1.2 键合线型 Si 基 IGBT 高压功率模块
相比于 SiC MOSFET 功率模块,Si 基 IGBT 高压模块发展较早,价格较低,应用更为广泛。ABB公司采用高压软穿通(SPT)技术研究了一种运用在 3.3kV 和 6.5kV IGBT 模块中的 HiPakTM封装结构。SPT 结构保证了良好的开关可控性和软开断波形,不需要 dV/dt 或峰值电压限制器(例如缓冲器或箝位电路),允许更高的开关速度,从而产生更低的开关损耗。为了降低杂散电感,ABB 公司又开发了一种 3.3kV LinPak 半桥模块,可以容纳尽可能多的芯片,不仅大大降低了杂散电感,还将电流密度提高了 14%。但目前 LinPak 结构还未能在更高电压的功率模块中得到应用[48-49]。
1.2 非键合线型高压功率模块
非键合线型高压功率模块相比键合线型,具有耐受电流大、散热性能好、寄生参数小等特点。非键合线型高压功率模块的封装形式主要分为焊接式和压接式两种,焊接式结构使用金属块直接将芯片两面和基板金属导体焊接起来,往往利用互感抵消等技术减小寄生参数。压接式则利用弹力来平衡模块内部的压力,保证模块内部芯片间的对称性,保持电流均衡。
1.2.1 焊接式高压功率模块
弗吉尼亚理工大学设计了一种高密度、无引线键合的焊接式 10kV SiC MOSFET 半桥模块。每个MOSFET 对的正上方都有一组去耦电容来提供低电感高频环路。该模块使用钼柱和直接键合铝的基板代替引线键合将芯片互连的三维结构。由此测量流出功率模块的共模电流减少了十倍,并且封装绝缘的局部放电起始电压提高了 53%,模块功率回路和驱动回路电感分别为 4.4nH 和 3.8nH。这种布置还具有提供屏蔽以减小电容耦合引起的共模干扰的优点。
1.2.2 压接式高压功率模块
压接式封装也使用金属块引出芯片的不同电极,但是模块中不存在任何钎焊及金属线键合,所有的电气连接均由封装压力完成,如图 2 所示。因此,压接式封装减小了键合线引入的杂散电感。相较于键合线式封装模块,弹簧压接式功率模块表现出优异的机械性能。每个芯片单独配备了压接弹簧保证其钳位压力相等,芯片之间实现良好的均流,便于多模块的串联堆叠[。不同于键合线式封装绝缘结构采用灌封胶作为绝缘介质,压接式封装绝缘结构中通常采用气体固体混合绝缘。气体介质的绝缘强度一般低于固体介质,并且压接式高压功率模块同时受到外施压力和热应力的作用,内部耦合问题十分复杂,因此可能导致压接式封装的绝缘设计难度更大。
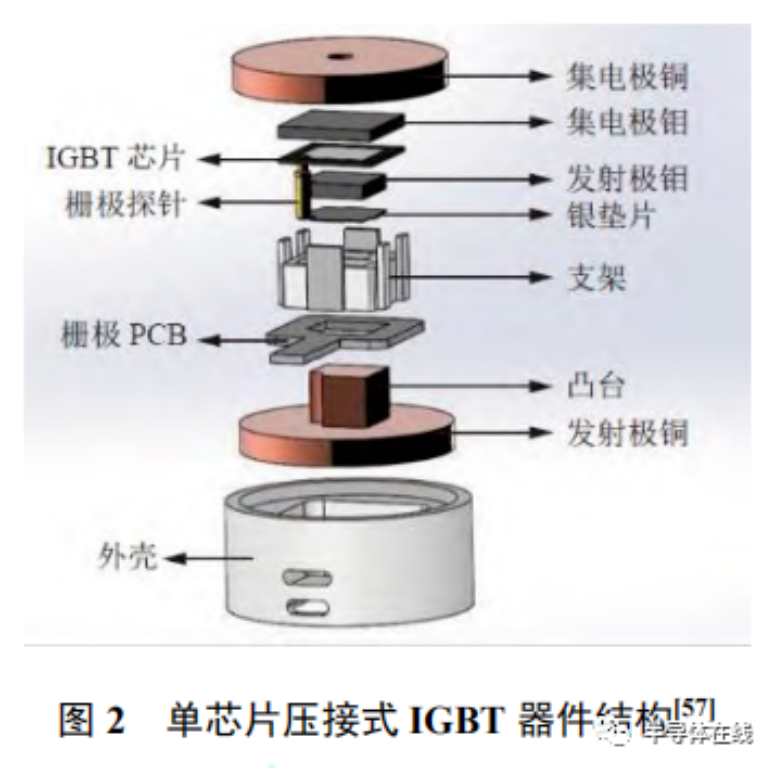
1.3 高压功率模块的封装绝缘材料
除了高压功率模块的封装结构,封装材料的机械、热和电特性也会随着使用环境发生变化,对模块绝缘性能和可靠性产生很大的影响。功率模块使用的封装绝缘材料主要包括基板和灌封绝缘材料。
1.3.1 基板材料
基板为功率模块提供绝缘和机械支撑,隔离电路的各种导电路径,同时基板必须具备良好的导热性能,从而能有效消散元件工作过程中产生的热量。功率模块基板由金属和绝缘层(一般为陶瓷层)组成,表 1 列出了四种常用的基板材料以及与SiC 的性能对比。
Al2O3 陶瓷制作技术成熟且便宜,热膨胀系数(coefficient of thermal expansion,CTE)相对较大,介电常数高,但是相比其他陶瓷材料,热导率很低,因此在高功率密度系统中不利于散热;BeO 陶瓷制作技术也很成熟,热导率最高,但是在加工过程中形成的粉尘颗粒具有毒性,对人体和环境有害;AlN陶瓷相对来说是一种比较安全和有前景的材料,其导热性仅次于 BeO,远远高于 Al2O3,并且它的 CTE与 SiC 接近,匹配性更强,抗弯强度和热循环寿命与 Al2O3 相似;Si3N4 是应用历史较短的新材料,它的 CTE 与 SiC 匹配的最好,机械断裂韧性最高,其高抗弯强度使其在热循环过程中可以与厚铜板搭配,承载大电流而不容易断裂。
1.3.2 灌封材料
灌封材料的作用是保护芯片和金属互连部分免受恶劣环境如湿气、化学物质等的影响,并且在导体之间提供额外的绝缘保护,同时也可以作为散热介质。表 2 列出了一些常用的灌封材料及其特性。硅凝胶是使用最广泛的灌封材料,但是它只能在250°C 内长期使用。为了提升硅凝胶的耐温特性,研究人员使用无机填料或改性的有机硅弹性体作为灌封绝缘,可以承受高于 250°C 的温度。一些聚合物例如聚酰亚胺(PI)和聚对二甲苯(Parylene)也被用作芯片表面的钝化剂,以防止芯片外绝缘在高压情况下被击穿。另外,环氧树脂等热固性材料具有足够的机械强度,也被用作硬灌封材料。然而,硬灌封材料在热循环过程中经常会出现裂纹缺陷,而软密封剂在高温下会出现热不稳定现象,因此灌封材料的选择常常在热稳定性和柔软性之间进行权衡。随着高压功率模块的发展,需要研究适用于高电压等级功率模块的封装绝缘材料和封装技术。
2 高压功率模块封装绝缘的老化和失效
如前所述,施加高压导致绝缘材料放电老化是影响高压功率模块的可靠性问题之一。局部放电是封装绝缘老化并导致失效的重要原因。需要指出的是,封装绝缘的失效也与环境因素如温度、湿度和气压等密切相关,限于篇幅,本文只讨论导致绝缘失效的直接原因即放电行为。
2.1 高压电力电子模块封装绝缘局放产生机理
基板金属电极、基板陶瓷绝缘和灌封绝缘共同构成的“三固体”绝缘结构与传统的电力设备诸如变压器和电缆的绝缘形式有所差别,带有不同电位的金属电极平行布置于陶瓷基板上,陶瓷基板和灌封绝缘形成的固体-固体界面处的电场既有平行于界面方向的分量也有垂直于界面方向的分量,三种材料的结合点位置往往是局部电场集中的位置。此外,在模块生产制造过程中也可能在陶瓷和金属层界面处引入空隙等缺陷,降低了局部放电的起始放电电压。


除了传统的由固体绝缘中引入气体缺陷而导致局部放电外,固体绝缘中的空间电荷积累也是导致封装绝缘中局部放电发生的重要原因。如前所述,常见的高压功率半桥模块内部一般包含多个开关芯片(MOSFET 或 IGBT),由于体寄生二极管和外并联二极管的存在,开关芯片诸如 MOSFET 在关断时漏极承受的电位高于源极,开通时漏极和源极的电位几乎相等,因此隔离不同电位的封装绝缘材料往往承受单极性的方波电压或直流电压。在单极性的方波电压和直流电压作用下,由三结合点处形成的自由电荷容易被陷阱捕获而形成空间电荷。受陷电荷在平行于界面的电场作用下又可能发生脱陷,并向对面电极迁移,在迁移过程中不断发生入陷、脱陷和复合等过程,并伴随着电荷能量的变化。三结合点处的空间电荷的输运行为直接导致了封装绝缘内电场分布的动态变化,进而影响放电的发生。空间电荷是影响高压功率模块封装绝缘失效的重要原因之一,但目前对于该方面的研究报道很少。
本文作者对功率模块的硅凝胶灌封绝缘材料的空间电荷特性进行了测量,样品中空间电荷时空分布如图 3 所示。随着施加电场的增加,空间电荷的注入深度增加,并且更多同极性电荷在阴极和阳极附近积累。值得注意的是,即使在短路后,仍然还有相当多的电荷,这表明即使经过很长时间,空间电荷也很难从陷阱中逸出。随着施加电压的增加和电荷注入的增强,试样内部的最大电场强度超过外施电场强度,电场畸变越来越严重。当三结合点处发生受空间电荷积聚而产生严重的电场畸变,或者由于金属连接线端部曲率半径过小而导致电场集中,以及在硅胶中或者硅胶与陶瓷基板间产生微气孔或气隙时,局部放电将难以避免。
当发生局部放电时,放电通道所在位置的温度非常高,导致放电通道附近的硅胶降解成气态产物,从而引起更大范围绝缘强度下降,最终导致绝缘失效。另外,环境条件对局部放电也有一定的影响,有研究表明,随着温度从 20 ℃升高到 100 ℃,封装硅凝胶的局部放电起始电压大幅度降低。
2.2 高压功率模块封装绝缘系统的评估标准与局部放电测量方法
2.2.1 高压功率模块封装绝缘系统的评估标准
专门针对在 1.5 kV 以上的电压下工作的功率模块绝缘评估标准较少,目前只有 IEC 61278-1 对用于铁路机车牵引的功率模块提出局部放电评估标准。标准规定对功率模块施加幅值为 1.5 倍的模块最大阻断电压的均方根或者更高的交流均方根电压,模块的局部放电幅值不得超过 10 pC。但是 IEC 61278-1 中规定的实验在交流正弦波下进行,很多学者已发现方波下的局部放电行为诸如局部放电起始电压和放电频率与正弦波下不同,因此现有标准不能充分评估模块在脉冲宽度调制(PWM)方波应力下的绝缘可靠性。
此外,IEC 61287-1 规定功率模块的所有端子都需要被短路并施加高电压,底板接地。但这种方法只测试了基板陶瓷的绝缘能力,封装绝缘的其他部分如灌封绝缘并没有得到有效评估[64]。为此,有研究者提出了一种新的测试标准,测试电压为叠加在直流电压上的交流电压,施加在两个功率端子之间,并在栅极施加负偏压保证关断(如图 4)。该测试虽然可以部分提供在正常运行时可能出现的局部放电信息,但也增加了雪崩击穿和二极管反向导通的风险,而且这种方法也并不能完全代表逆变器中功率模块承受的方波应力。因此目前针对高压功率模块还没有一个统一的标准来评估封装绝缘可靠性,这也是未来亟待解决的问题之一。
2.2.2 方波下高压功率模块封装绝缘局部放电的测量方法
高压功率模块工作在方波电压下,器件的开关过程十分迅速,在开断过程中电压幅值的变化率非常大,将产生较大的位移电流并在空间内激发频率可达几 GHz 的高频电磁波,对目前局部放电测量广泛使用的脉冲电流法和特高频(UHF)法造成极大的干扰,甚至可能掩盖原有的局部放电信号,使用传统的方法对方波下高压功率模块封装绝缘的局部放电进行测量具有一定的难度和挑战性。
目前测量方波下局部放电的方法主要有电学法和非电学法等[64]。国内有学者利用特高频法,对变频电机漆包线绞线进行局部放电测试,分别在不同重复频率短脉冲及方波电压下检测放电幅值和相位;也有研究人员在直流下检测 IGBT 模块的局部放电,对电压和电流进行综合波形分析探讨电压和绝缘结构对放电性能的影响,可以鉴别直流电压下 IGBT 模块局部放电的原因[70];有学者分别在方波脉冲下和工频下对匝间绝缘电磁线在老化与未老化情况下进行了局部放电测量,对两种情况下局部放电的相位分布特征并对比;此外,国内外研究者们发现重复电压脉冲/方波的特性影响着局部放电特性,即使在相同的峰值电压和频率的情况下,局部放电参数如起始放电电压(PDIV)也可能与正弦电压下的测量结果有很大的不同。对于50 Hz 正弦波形和 50 Hz 基频脉宽调制(PWM)波形的局部放电,发现在相同幅值下正弦波形未检测出局部放电,而脉宽调制波形下却存在强烈的放电活动。为了解决传统局部放电检测技术难以测量开关电场下的局部放电的问题,本文作者提出了如图5所示的基于超高频SHF和下混频技术的方波下功率模块封装绝缘局部放电检测方法,通过检测频率 3 GHz 及以上的局部放电信号,以避开功率模块开通和关断形成的电磁干扰以及手机等移动设备的通讯信号造成的干扰,从而提高了测量结果的可靠性。此外,使用的下混频技术将 SHF 频段的局部放电信号频谱搬移到较低频段,大大降低了对采样设备的要求,适合在现场带电检测中应用。局部放电的非电学方法具有有效避免电磁干扰的优点。ABB 公司设计了一种记录场致发光和局部放电光斑的光学局部放电检测装置(如图 6),电致发光测量和光学局部放电检查分别可以用来识别高电场的关键区域和局部放电故障的直接原因(如突起或者不规则边缘形状等);国外学者设计了一套能够通过改变脉冲转换速率的模拟工作模式下的局部放电的实验装置,研究不同电压波形下的局部放电,利用常规电学技术和光学技术成功记录了IGBT 绝缘在不同电压下的局部放电行为,记录了压力和电压波形的影响,结果表明电压转换速率在影响局部放电起始放电电压的因素中占主导地位;也有学者采用光学局部放电测量技术,在固体正弦电压、缓慢上升电压和快速上升的方波电压下的局部放电,结果显示快速上升方波电压具有最低的局部放电起始电压,而正弦电压具有最高的局部放电起始电压,分析认为是由于同极性和异极性电荷不同积累过程所致。电压转换速率在影响局部放电起始电压和放电大小等因素中占主导地位。然而,光学检测法只能检测放电部位暴露在外的情况,光学探头也需要对准放电部位,因此不适用于对商用模块封装绝缘的内部放电进行探测。
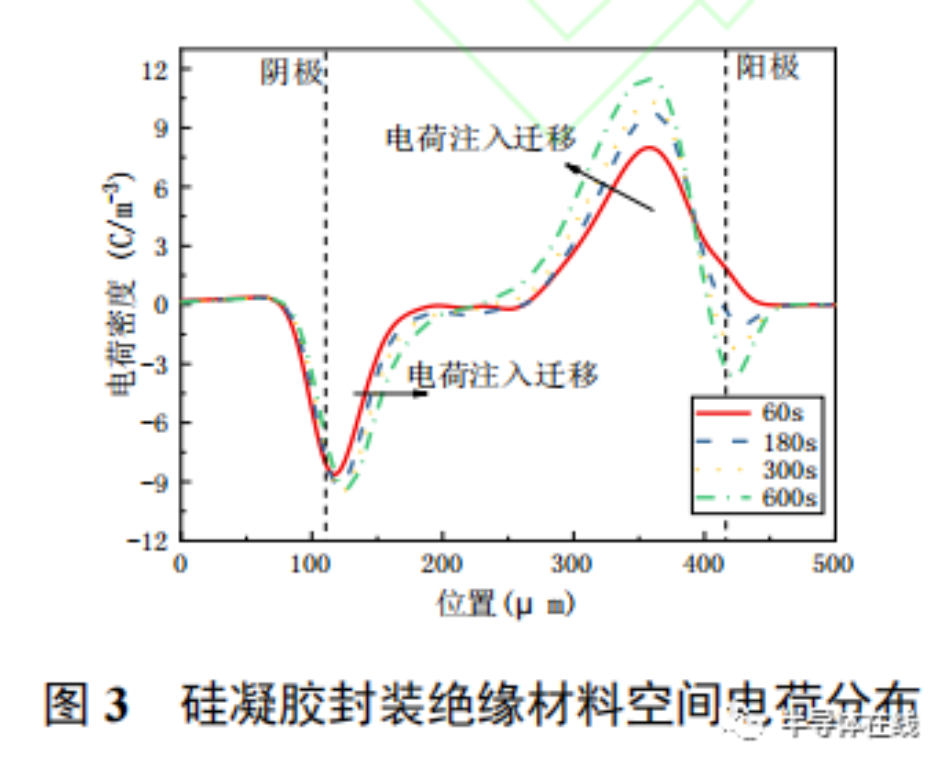

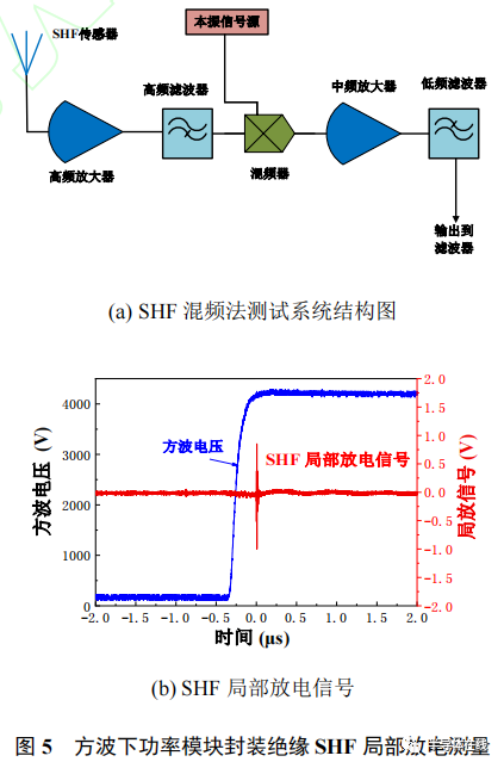

评估高压功率模块封装绝缘在 PWM 快速方波下的局部放电特性的重点和难点一方面是在于如何避免快速开关导致的电磁干扰,提出合适的局部放电测试手段,另一方面是研究绝缘在 PWM 快速方波下放电老化的机理,通过这两方面的研究达到提高封装绝缘的可靠性的目的。
2.3 高压功率模块封装绝缘材料的老化
2.3.1 硅凝胶的老化
研究表明,陶瓷层和金属层界面孔隙中的局部放电产生的放电幅值较小,而金属边缘的局部放电幅度在几 nC 的范围内,导致硅凝胶分解成气态产物,降低了材料的绝缘能力。国外学者利用电学测量和快速可视化技术研究硅凝胶封装绝缘中金属凸起造成的局部放电和树枝化现象。在脉冲电压下,硅凝胶显示出的自愈能力有限,只对孤立的、非重复的局部放电有效,而在一系列局部放电后绝缘性能无法恢复。局部放电起始电压随着封装绝缘材料的属性变化而发生巨大的改变。除了提高封装质量,如消除气泡、平滑金属边缘等方法来降低放电可能性外,还可以对硅凝胶介质体系进行改进,寻找与基板更加匹配的胶体材料来缓解硅凝胶介质中的局部放电现象。
2.3.2 环氧树脂的老化
相对于具有弹性的硅凝胶封装绝缘材料,环氧树脂具有较高的杨氏模量,但易在冷热循环中发生开裂等机械失效。国内学者通过实验发现,环氧树脂内部微小气泡处易发生气隙局部放电,放电后界面处的含氧量显著增多;有学者研究了脉冲上升时间对环氧树脂电树引发和生长特性的影响规律(如图 7)。结果表明相比较于传统正弦电压,脉宽调制电压增加了电树引发概率和生长速度:在一定温度下,随着上升时间的减小,电树引发的概率增高、电树生长速率增大、电树形态逐渐由树枝状演变为丛林状。因此,选用环氧树脂作为电力电子器件封装材料的时候,要充分考虑脉宽调制电压上升时间、载波频率和热效应对绝缘性能影响。

因此,为了降低封装中发生局部放电的可能性,应确保在基板金属层处与硅凝胶界面无孔隙,同时应当也应确保环氧树脂中无微孔。除了上述的要求外,为了进一步提高高压功率模块封装绝缘的可靠性,还需要在封装结构、封装材料以及工艺等方面开展更多的研究工作。
3 高压功率模块封装绝缘可靠性的改进
为了提高高压功率模块封装绝缘的可靠性,降低绝缘材料的老化程度,研究人员主要从改变封装绝缘结构和调控绝缘材料特性的角度进行了探索。
3.1 改变封装几何结构控制最大电场
基板陶瓷层和金属层的结合方式会影响界面位置的几何结构,进而影响“三结合点”处的最大电场。研究表明常规使用的金属钎焊(AMB)技术容易在金属化层下面的铜焊处产生非常尖锐的边缘,容易引起局部放电(如图 8)。
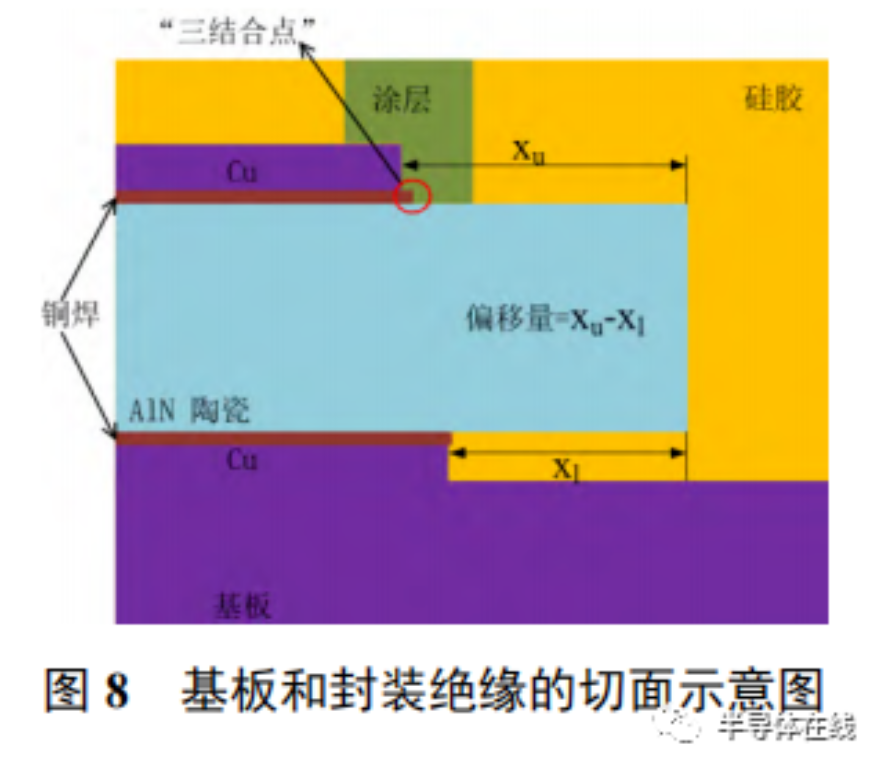
针对改变封装几何结构,研究人员已经提出了若干方法来降低“三结合点”处的电场强度:
1) 增加陶瓷基板的厚度,但是增加陶瓷厚度对电场改善的效果有限,陶瓷厚度增加一倍并不会导致电场减半,也不会使 PDIV 增加一倍。另外,增加陶瓷基板厚度会减小散热效率,不符合功率模块小型化的要求;
2) 调整基板金属层偏移量[66,83],金属层偏移量定义为上、下金属层距离陶瓷边缘的距离之差(如图 9)。随着金属层偏移量的减小,最大电场强度减小,但是改善效果有限;
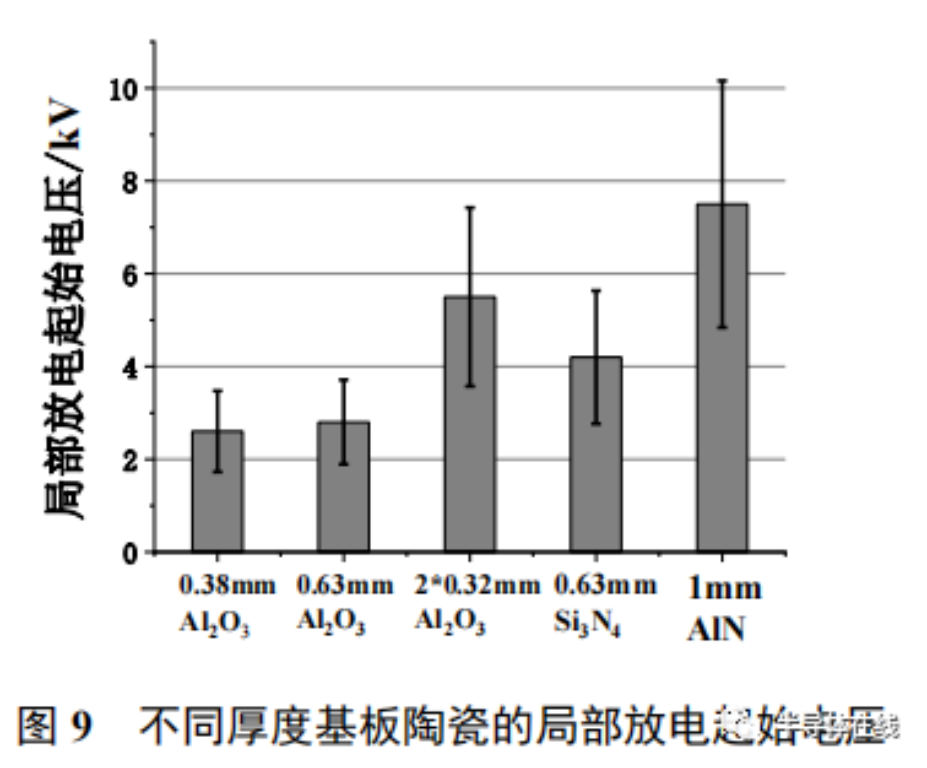
3) 改善焊盘尺寸和转角曲率:有研究发现局部放电的次数和幅值随着 DBC 焊盘尺寸的增加和转角曲率半径的减小而增加;
4) 使用基板堆叠,即将一个 DBC 基板叠加在另一个 DBC 基板之上,不仅增加了总绝缘厚度,也可以将中间电位钳制住,从而大大减小陶瓷内和三结合点处的电场强度。局部放电测试结果显示(如图 9),与单个 0.63 mm 的基板相比,通过堆叠两个 0.32 mm 的 Al2O3 陶瓷基板,局部放电起始电压提高 94%。但进一步增加堆叠层数对抑制局部放电的效果不是十分显著,比如采用三层陶瓷基板叠加时,相比两层陶瓷基板叠加,局部放电起始电压只增加了 15%。此外,如果基板叠层的中间金属层保持浮动,则电场减弱效应将大打折扣。
3.2 调控绝缘材料介电参数抑制放电
3.2.1 介电常数调控材料
由于灌封材料和陶瓷基板的介电常数不匹配,界面结合点位置的电场强度最大。研究发现,改变三结合点的位置并使用合适的介电涂层覆盖结合位置,可以使得三结合点不再成为电场最高的地方(如图 8)。国外学者在 50 Hz 正弦电压下测试了填充高介电常数纳米钛酸钡的硅凝胶,结果表明其介电常数随着所施加电场增加而增加,局部放电起始电压和击穿电压也显著提升,通过增强极化机制,钛酸钡颗粒可以减缓电场集中达 29%;国内有学者采用环氧树脂为基体,与高导热微米氮化硼以及纳米氮化硼分别制备高介电复合材料,可以减缓电场集中大约 10%。但是当纳米或微米氮化硼掺杂质量分数达到 15%时,击穿强度相较纯环氧分别下降 25.3%和 34.2%。
3.2.2 非线性电导材料
研究表明在基板金属边缘应用非线性电导层,可以通过传导电流流过该层来改变电场分布,降低放电发生概率。但该方法需要精准调控非线性电导率随电场的变化的关系,因为当电导率的电场依赖性太弱则电场均匀效果不明显,当电导率对电场的依赖性太强则非线性层表现为金属化的延伸,反而缩短了绝缘距离,导致较大的漏电流和放电概率。
西门子公司采用等离子体增强化学气相沉积(PECVD)工艺,在嵌入硅胶的金属化 AlN 陶瓷边缘涂了一层厚度为 300 nm 的高阻抗掺杂非晶体硅(a-Si:H),将该层的电导率调节至 10-5S/m 来均化陶瓷边缘的电场强度。试样在有效值 10.5kV 的电压下局部放电幅值不超过 10pC。但是该线性电阻材料的性能取决于施加电压的频率,其优势随着频率增加而减小。非线性电导材料则不存在频率的限制:ABB 公司发现在基板的金属边缘层应用填充 ZnO 的聚酰亚胺非线性电阻层可以显著降低三结合点的电场;也有国内学者在硅氧烷弹性体中加入微纳米尺寸的 BN 和 SiC,发现所形成的复合材料的电导率随着施加电场的增加而增加,并且当二者掺杂含量越高时,非线性电导率越明显,局部放电发生的概率越小。
3.2.3 导热绝缘材料
高压功率模块在高频下工作产生的热量更加集中,热量积累更多,并显著影响模块的寿命和可靠性。这就对高压功率模块封装材料的散热性能提出了更高的要求。聚合物封装材料是热的不良导体,缺乏导热路径来导出热量。研究表明向聚合物中添加陶瓷纳米/微粒可以提高复合材料的热导率。国内有学者将 14%体积的碳酸钡添加在硅凝胶中,不仅将介电常数提高了 1.6 倍,还把凝胶的热导率提高了 37%;也有学者研究发现当填充15%质量分数的 BN 到环氧树脂中时,复合材料的热导率是纯环氧热导率的 3.2 倍。若把 BN 与环氧简单地复合,二者之间存在较大的接触热阻,很大程度上阻碍了复合体系导热性能的提升,如何在环氧基体内构建有效的 BN 三维导热网络仍是制备高导热环氧复合材料的关键问题[;有学者采用钛酸酯偶联剂 LD–144 制备环氧/AlN 高导热电子封装材料。随着填料 AlN 含量的增加,复合材料的导热性能提升明显。
提高封装材料导热性和电气性能的思路是将灌封绝缘中掺杂微米粒子或纳米粒子形成复合材料,通过以上研究可以看出,复合材料可以将各组分的性能优点结合,使得复合材料整体性能更加优异,但是填料的制备和性能调控十分复杂且成本较高,因此仍然需要研究和开发更加简单、低成本以及适合大规模生产的制备工艺和方法[95]。
4 讨论
高压功率模块封装绝缘的可靠性研究主要集中在失效机理、放电检测以及可靠性提升这三个方面,分别从物理机理、实验手段和实际应用这三个层面层层递进。掌握封装绝缘材料失效背后的物理原因,提高封装材料的导热性和电气性能,从而在失效机理研究的基础上选择合适的绝缘材料和改性方法,提高高压功率模块封装绝缘的可靠性。
4.1 高压功率模块封装绝缘可靠性的主要威胁
高压功率模块封装失效的主要原因之一是电应力引起的局部放电,进而造成老化最终失效。高压大功率电力电子模块封装最脆弱的电气位置是灌封绝缘、基板金属边缘和基板陶瓷的三结合点位置。陶瓷和金属层界面中的空隙以及金属边缘的空隙是局部放电的主要易损点。除了经典的“三电容”气隙模型局部放电机理外,直流和单极性方波下固体绝缘中的空间电荷累积也是影响局部放电的重要因素。针对方波下高压功率模块封装绝缘局部放电的产生机理,还需要做更深入的研究和探讨。
4.2 高压功率模块封装绝缘的主要挑战
1) 针对高压功率模块封装绝缘系统,现行的评估标准是 IEC 61278-1,但该标准使用的条件是在交流电压下,而方波下的局部放电行为和正弦波不同,该标准并不能充分评估模块在实际 PWM 应力下的可靠性。
2) 高压功率模块的开断导致具有快速上升沿和下降沿的方波施加在封装绝缘上,由此产生位移电流以及在空间中内激发高频电磁波,对常用的局部放电电学测量方法产生极大的干扰,掩盖原有的局部放电信号。对于逐渐小型化集成化的功率模块来说,非电学方法诸如光学法由于测量方式的限制,将其大规模应用于现场测量仍有一定的困难。
3) 高压功率模块封装绝缘中的局部放电和老化与材料的制作和封装工艺具有紧密的联系。为了提高封装的可靠性,封装绝缘中的缺陷如气泡和裂纹应尽量避免。
4.3 高压功率模块封装绝缘的发展趋势
随着高压功率模块器件向着小型化、集成化、耐高温化的方向发展,未来还需要完成很多工作:
1) 耐高温、低电感和高可靠性的集成封装结构的设计和验证。在键合线型和非键合线型高压功率模块中,如何设计并优化封装结构,尽量减小杂散电容和电感,降低开关损耗和过电压应力,提高模块导热能力和可靠性是封装结构研究的重点。
2) 高压功率模块封装老化和失效机理的研究与评估。如何通过方波下局部放电观测等手段来提取封装绝缘状态的关键信息,以评估模块封装绝缘的老化程度。亟需研究能体现功率模块实际运行中承受应力的标准,以对高压功率封装模块绝缘系统进行可靠性评估。此外,对高压功率模块封装绝缘局部放电的测量方法也需要进一步研究,为在线监测状态评估提供实验手段。
3) 高压功率模块封装绝缘可靠性提升的研究。增加基板的厚度、金属层偏移、改变三结合点的位置并使用合适的介电涂层等方法都能在一定程度上减小封装绝缘内的最大电场强度,进而降低放电概率并提高可靠性。随着功率模块朝着小型化和集成化的方向发展,如何对封装绝缘材料性能进行调控,在不影响功率模块性能的前提下提升可靠性,降低材料使用成本仍然需要进一步的研究。
5 结论
本文对高压功率模块的可靠性研究进行了梳理,分析和探讨了高压功率模块封装绝缘中的几个关键问题:
1) 典型的高压功率模块封装结构特征。讨论了不同封装结构的优缺点,键合线型高压功率模块技术成熟、成本低、应用广泛,但杂散参数相对高;非键合线型高压模块可以减小由键合线引入的杂散电感,具有散热性能好、易于串联等优点,但内部多物理场耦合问题复杂,绝缘设计难度较大。设计高压大功率模块应具有高功率密度、低杂散参数和低电场应力集中等特点。
2) 高压功率模块封装绝缘老化和失效的机理以及现有的评估标准和局部放电测量方法。空间电荷在直流和方波电压下的输运行为对封装绝缘中的放电具有重要的影响。现行的标准不足以评估方波下功率模块的可靠性,而由于快速变化的方波导致的位移电流和空间电磁波导致方波下封装绝缘的局部放电测量方法受到很大干扰,亟需研究可靠的,能够适用于在线监测的功率模块局部放电测量方法。
3) 提升高压大功率电力电子封装模块可靠性的方法。可以从调控和改变封装几何结构控制最大电场,例如增加基板厚度、改变金属层偏移量、改变三结合点位置、使用介电涂层、改变焊盘尺寸和转角曲率、基板堆叠等;也可以从材料改性角度出发,提高封装材料热导率和击穿场强,在硅胶、环氧树脂等封装绝缘材料中填入功能性微米和纳米粒子,调控介电常数、电导率和导热系数,使其能够承受更高的电应力并具有更好的导热性和热稳定性。
免责申明:本文内容来源中国电机工程学报 上海交通大学 李文艺、王亚林、尹毅。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。
关键词:先艺电子、 XianYi、先艺、金锡焊片、Au80Sn20焊片、Solder Preform、芯片封装焊片供应商、芯片封装焊片生产厂家、低温共晶焊料、Eutectic Solder、光伏焊带、太阳能焊带、银钎料、银基钎料、助焊膏、高温助焊剂、共晶助焊膏、高温焊锡膏、paste flux、flux paste、气密性金属封装、气密性封焊、共晶键合、激光器巴条封装、覆膜预成形焊片、热沉、heatsink、光电子器件封装、MEMS器件封装、预成型锡片、纳米银、微纳连接技术、AuSn Alloy、flux coating solder、TO-CAN封装、低温焊锡膏、喷印锡膏、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、silver sinter paste、金锡衬底、金锡焊料封装、芯片到玻璃基板贴片 (COG)、铟焊料封装、共晶焊、金锡烧结、金锡共晶烧结、金锡薄膜、金锡合金薄膜、合金焊料、金锡焊料、SMT锡片、Au50Cu50焊片、Au80Cu20焊片、Au焊片、Au88Ge12焊片、Au99Sb1焊片、Sn焊片、激光巴条金锡共晶焊、激光巴条焊接材料、背金锡、预置金锡盖板、贴膜包装焊片、金锡薄膜热沉、SMT用预成形焊片、载带式预成形焊片、锡银焊料片、IGBT大功率器件封装、IGBT焊料片、锡锑焊料片、中高温焊片、异形焊料片、先艺、焊锡片、金锡焊膏、纳米银锡膏、微组装焊料、金锡凸点、金锡bump、激光巴条共晶、Au80Sn20、AuSn Solder、晶振金锡封盖、电镀金锡、共晶贴片、铟铅焊片、铟铅合金、锡铋焊片、锡铋焊料、金锡薄膜电路
先艺电子、xianyi、www.xianyichina.com
广州先艺电子科技有限公司是先进半导体封装连接材料制造商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成型焊片,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








