干货分享丨BGA、LGA的Void(空洞)分析改善
转自:SMT之家
背景目的
1-1背景:
随着实装的高密度化的推进,元件特别是IC、端子等电极的构造变化显著。
根据电极的变化,以前的焊接技朮已经不能正确的焊接元件了,其中最有代表性的是采用LGA、BGA的IC工厂。
LGA、BGA等CHIP元件由开放型焊接向密闭型焊接变化。
LGA、BGA-IC最大的问题是在接合部发生的“Void”。
1-2目的:
1) LGA、BGA-IC不产生Void焊接技朮成为实用化。
2) 能够在高密度实装基板、大型主板上没有Void进行实装,提高接合的可靠性。
LGA和BGA的VOID发生原因:
为防止LGA、BGA的void发生,解开void发生的原理相当重要。
为防止LGA、BGA的void发生是受锡膏的熔融的变化影响的。
解开这些变化过程,就可以提出void的对策。
发生原理:
1、因为焊锡表面张力,焊锡向中心部集中。
2、因为表面张力void密闭
3、要排除void抑制焊锡表面张力是很必要的。
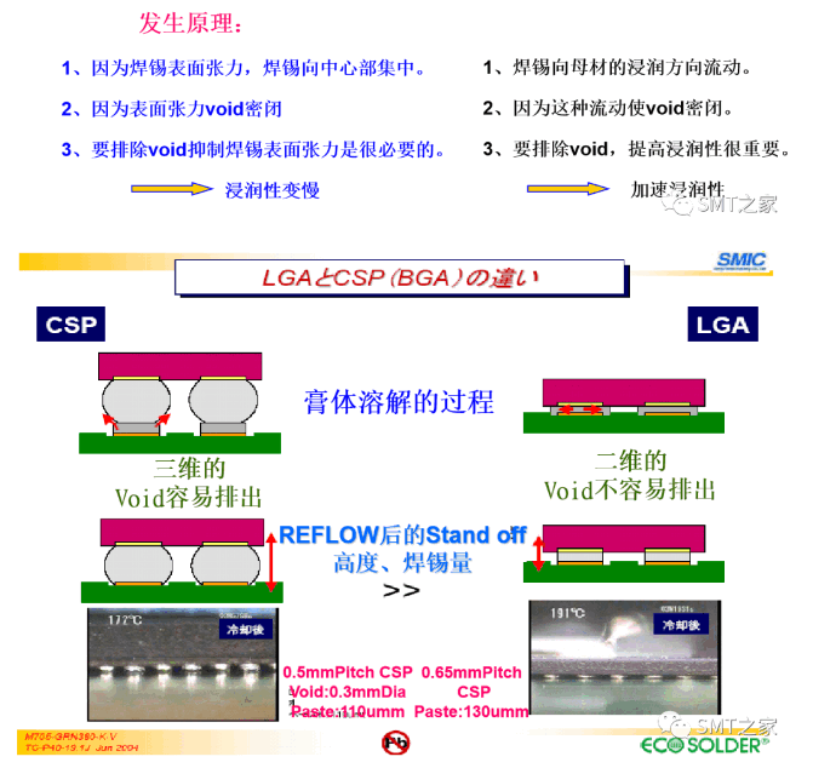
模拟回流炉中LGA Solder Past的变化
为了解开实际的LGA、BGA的焊接有必要做模拟。

Void抑制方法的检验
原因分析的结果,为了防止BGA、LGA发生Void,要推进以下工作:
1、Reflow Profile 锡膏助焊剂的设计。
2、锡膏印刷。
3、 Reflow Profile 的3项目须同时改善,一个一个改善没有效果。
Void抑制方法的检验

LGA的Reflow Profile和void发生量的检验
Reflow Profile的void发生量的检验按照下面3项记录条件执行﹕1、公司内一般使用的Profile;2、改善的Profile;3、考虑现在生产的Profile。
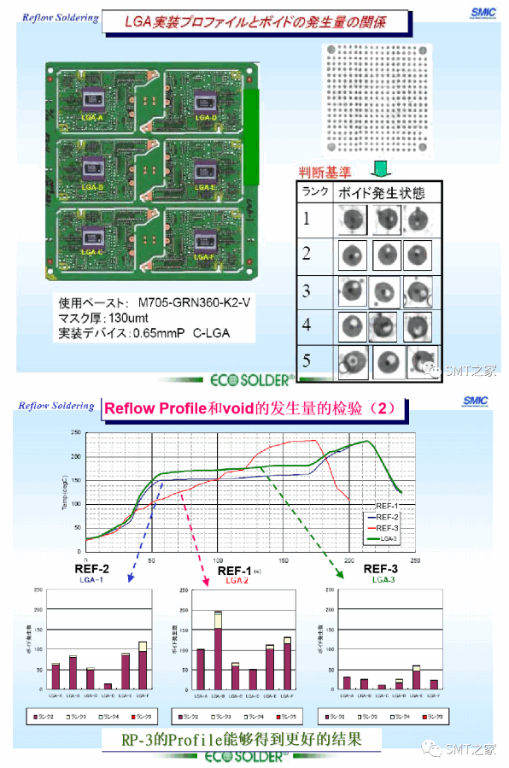
LGA的锡膏和void的发生量的验証
做LGA的solder paste的void发生量试验

LGA的solder paste和void发生量的验証
结论:void对策品的VL取得良好的结果,比较符合密闭型的焊接, FLUX的变化稳定。solder paste(粒度、FLUX)的使用重要。
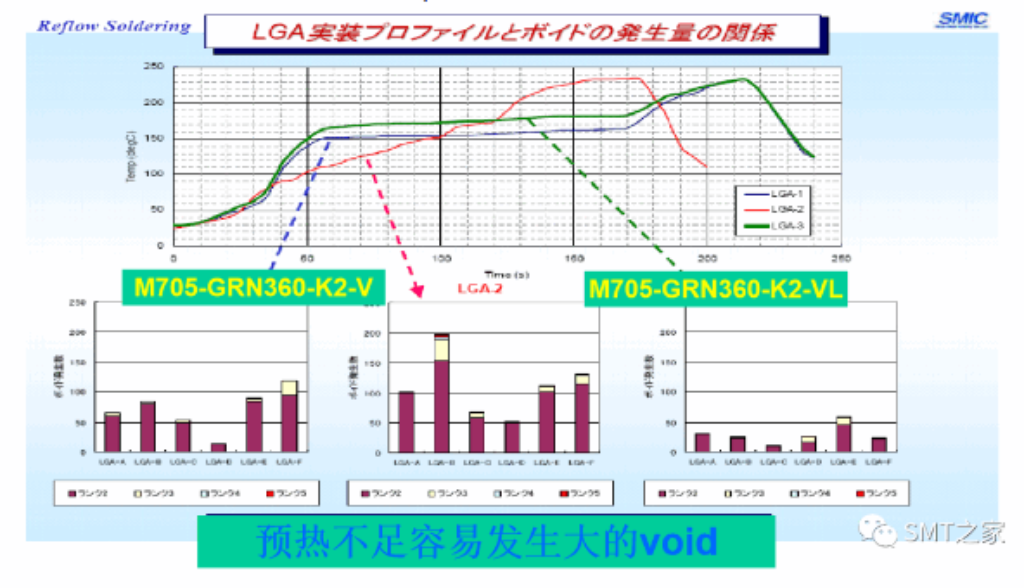
做LGA的solder paste印刷厚130um和150um瓦斯排出和印刷形状的有无条件。
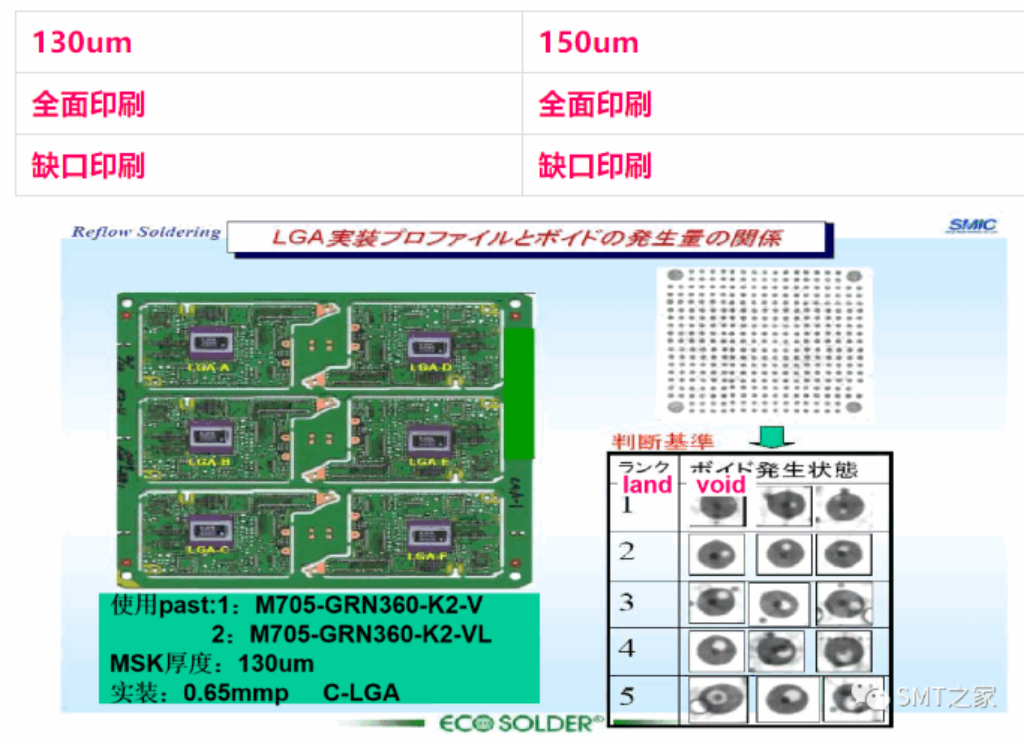
LGA的solder paste印刷量和void发生的检証
结论 :因为印刷厚度引起的void发生量很少。 从FLUX发生的瓦斯被排出。缺口印刷效果大。要有充足的锡膏印刷量确保能够排出瓦斯的印刷形状。

BGA的Void不良零技朮
按照以前的观念,表面实装技朮上还不能实现Void为零,为了实现Void零不良需要满足以下条件,在实际生产上要严密考虑元件电极和PAD间锡膏印刷,装载元件以及Reflow等条件。
LGA、BGA的void零不良技朮
(1)元件电极和基板Pad的Space(容积)。根据电极的种类电极size和pad size不同,要对一个一个元件分别测量。要注意元件有平面电极和凹面电极。
(2) Space(容积)熔融后必要的焊锡量(焊锡容积)的设计 熔融后根据锡膏的种类不同大约是印刷焊锡量的50-60%.
(3)确保必要的焊锡量,防止void发生,要设计锡膏的印刷厚度和印刷形状(钢网设计)。
(4)使用锡膏的选定。防止void的发生,焊锡的size、活性剂、溶剂的种类。推荐值:焊锡粒子:25-45um,活性剂多,溶剂:标准高沸点低。
(5)Reflow Profile的设计。参考使用锡膏推荐值。
零件低面Pad-Viod零技朮
熔融后锡膏厚度测定
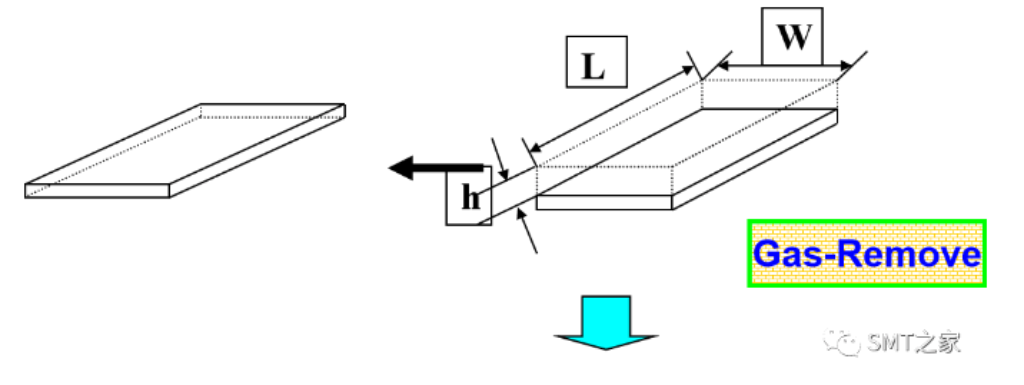
现在 ﹕
1﹑Pad size :钢网开口部1﹕1;
2﹑钢网0.127。

void対策钢网开口例(1)
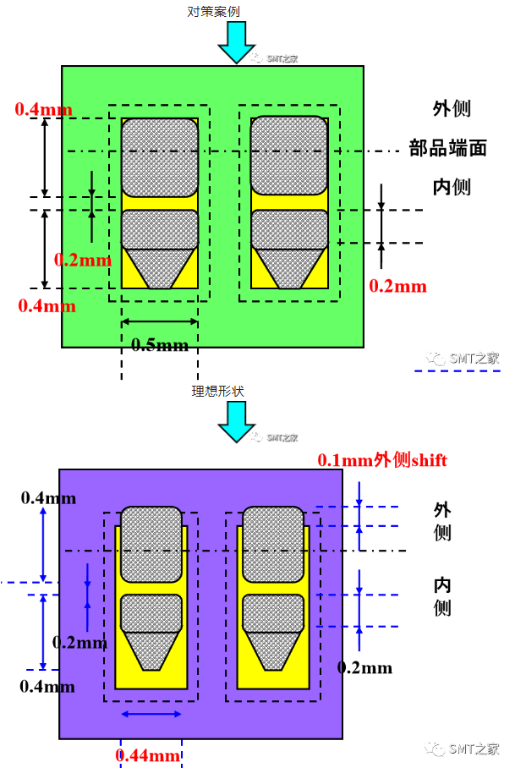
void対策钢网开口例(2)
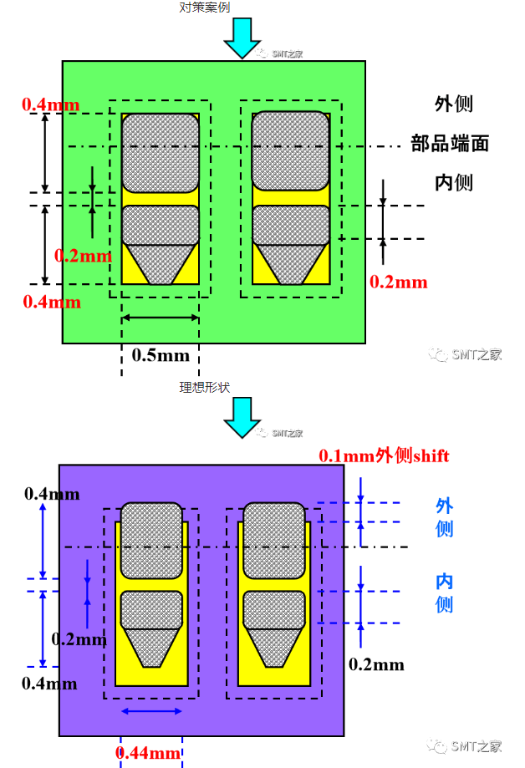
Void对策钢网开口例
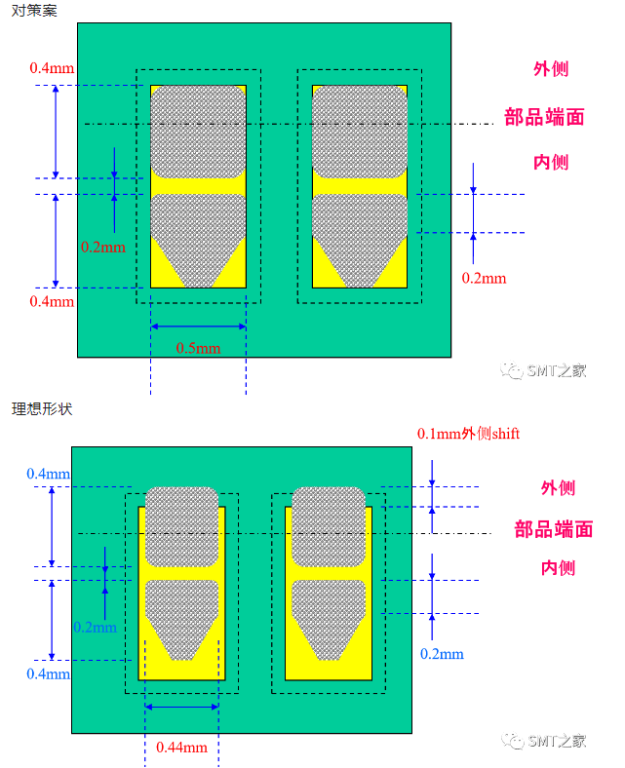
BUMP变形的推定原理

Reflow中BUMP变形的过程
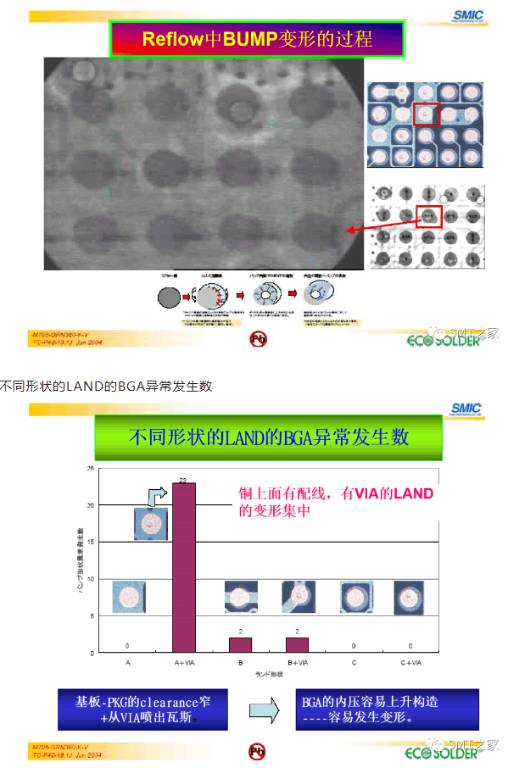
1、2次面实装后的LGA刮刀中BUMP变形
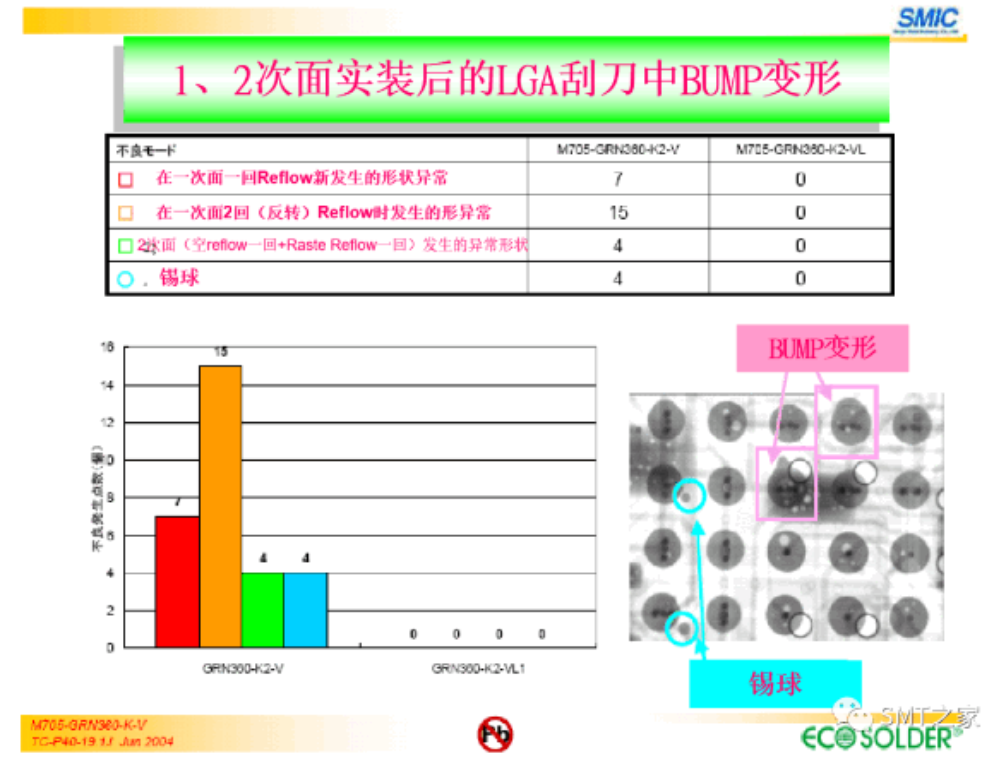
在同一视角下K2-V和VL的REFLOW状态(X线)

免责申明:本文内容转自:SMT之家。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10 Solder Preforms。
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








