基于新工艺技术的高功率裸芯片模块微流体系统的散热技术
基于新工艺技术的高功率裸芯片模块微流体系统的散热技术
来源/作者:李丽丹 钱自富 张庆军 刘压军 李治 李鹏
转自:热管理技术
摘要:为解决高功率裸芯片的散热问题,本文在功率模块腔体上设计了一种自循环一体化微流道散热系统,并对有无微流道、平直流道以及交联流道的散热特性进行对比。研究表明:有微流道的裸芯片散热特性优于无微流道,有交联流道的裸芯片散热特性优于具有平直流道;将裸芯片共晶焊接到金刚石热沉,再将热沉共晶焊接到功率模块腔体,裸芯片到功率模块腔体之间的传导热阻降至传统工艺热阻的1/360~1/280;仿真与实验能够相互验证,最大偏差仅为7.16%。该微流道系统具有较强的散热能力,可解决环境温度为70℃,热流密度为320W/cm2时的裸芯片散热问题。
关键词:散热 微流道 共晶焊 金刚石
随着电子设备小型化和高性能的发展趋势,芯片集成度要求越来越高,芯片在工作时的热流密度也随之不断升高。功率芯片产生的热量不能及时散发,设备长期在高温工况下工作,会直接影响器件的工作寿命,甚至直接失效。随着温度的升高,电子设备的可靠性和平均故障时间(meantimebetweenfailures,MTBF)急剧下降,其失效概率呈指数增长趋势。因此如何提升芯片散热能力是学者们研究的重点问题。芯片的散热能力直接关系到系统性能,电子设备中常用的散热方式如表1所示。相比传统散热技术,微流体散热技术能够提供更大的传热面积和更高的传热系数,且易于集成在芯片模块内部,从而提高芯片散热性能。D. B.Tuckerman等在1981年首次提出微通道散热器的设计思路,研究设计了平行直流道的微通道散热器,在芯片上可实现790W/cm2的散热量。表明微通道散热器可解决高功率热流密度器件的散热问题,为电子芯片的散热提供新思路。在此之后,国内外学者对微通道散热进行了更加全面、系统的研究,聚焦于微通道的结构、尺寸、形状的优化设计等诸多方面,如多孔介质、分形网络等微流体散热系统装置。研究目的主要为两方面:1)不断提高系统的散热能力;2)尽可能减小热阻。使电子元器件的温度始终在其运行工作范围内,确保其工作的稳定性和可靠性。

本文设计了一种自闭环一体化微流体散热系统。一方面采用裸芯片共晶焊接到热沉,热沉共晶焊接到功率模块腔体,有效降低裸芯片到功率模块腔体的传导热阻;另一方面,采用一体化设计方式将微通道散热器集成于功率模块腔体内部,并将微流道设计为交联流道的形式,进一步增加散热能力。
1 原理分析
1.1 微系统的工作原理
微系统主要由循环泵、微通道散热器、裸芯片、热沉、换热器、流体管路以及内部工质等组成。压电微泵驱动换热介质在管路中流动,整个系统通过换热器与外界进行热交换。当裸芯片工作时,微通道散热器从裸芯片吸收热量,通过管路中的散热介质把热量传输给换热器,最终将热量散给外界环境。系统工作原理如图1所示。

1.2 裸芯片低热阻传热设计
热传导过程如下:

式中:R为热阻,K/W;L为材料的厚度,m;Kc为接触面等效导热系数,W/(m·K);A为接触面积,m2;ΔT为两接触面的温差,℃;Q为传导过程的总热量,W。
由式(1)、式(2)可知,接触传导产生的温差主要与热传递过程中的热阻和传递的总热量有关,而传递过程中的热阻与材料的厚度以及导热系数密切相关。在相同传导面积下,热传导路径越短,材料导热系数越高,热传导热阻越低。裸芯片的传统安装方式如图2所示。裸芯片采用AuSn焊接在钨铜垫片上,钨铜垫片再通过导电胶粘接在功率模块腔体底部。功率裸芯片与散热系统为接触热传导散热,由于路径上热阻相对较高,将产生较大温差。为降低其传导热阻,引入导热系数更高的热沉,将钨铜垫片更换为金刚石铝/金刚石铜,同时采用共晶焊代替传统胶粘,将有效降低传热路径上的热阻实现传热路径上的高效传热,如图3所示。

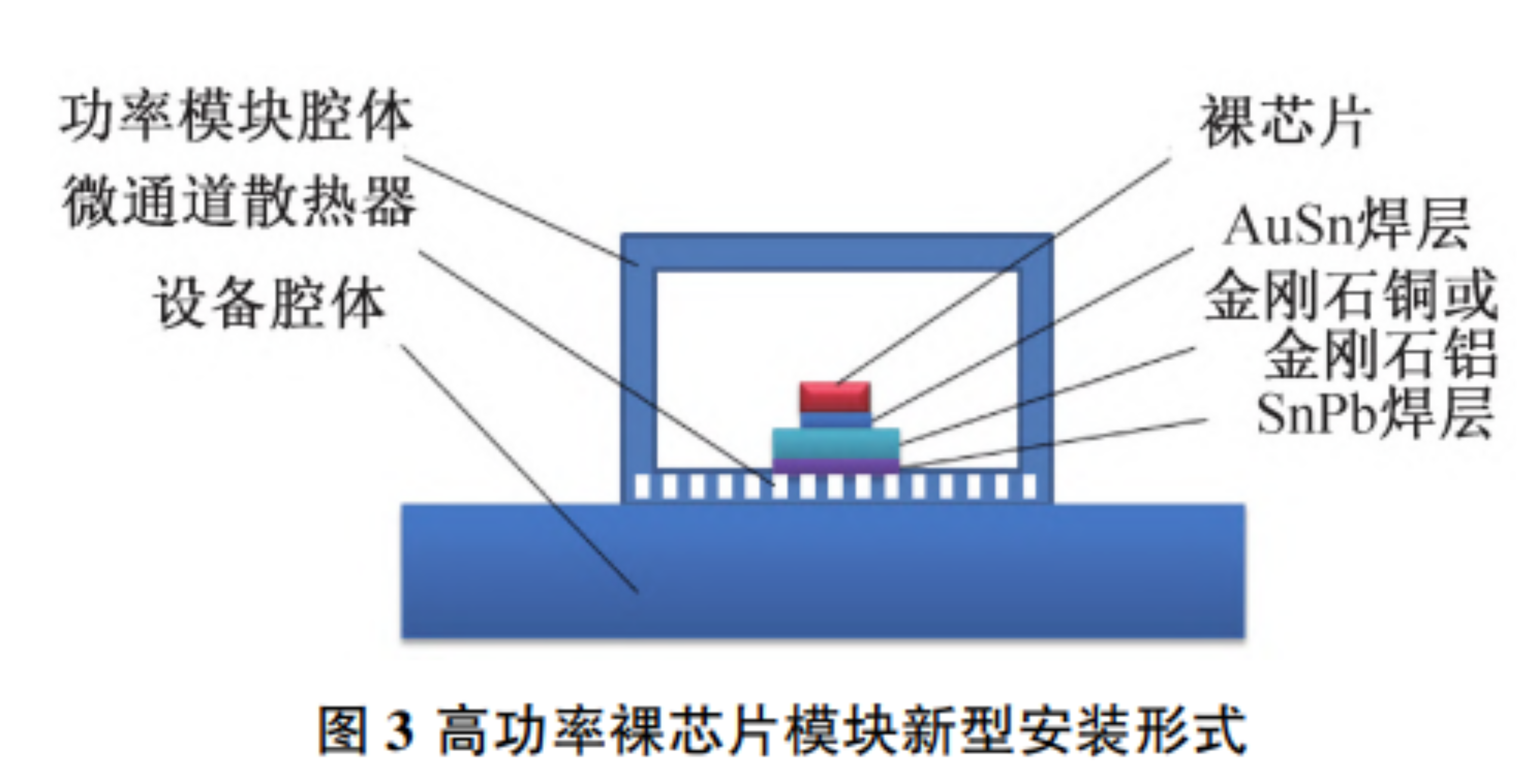
相对于传统的工艺方案,新工艺方案用金刚石代替钨铜垫片,用共晶焊接代替导电胶,同时在功率模块腔体中加入微流道散热器。粘胶及共晶焊接、钨铜垫片和金刚石的导热性能参数如表2所示。由表2可知,共晶焊接的热阻是导电胶热阻的1/360~1/280。即当传统方案裸芯片热沉两端接触面温差为10℃时,采用新方案的温差仅为0.025~0.033℃。焊接工艺技术的使用,将有效降低裸芯片到功率模块腔体的接触热阻,有效提升裸芯片的散热性能。同时,新方案采用共晶焊接可提高裸芯片在功率模块腔体上的可靠性。

本项目采用Au80Sn20合金共晶的方式(熔点为280℃)将祼芯片共晶焊接在热沉上,然后将焊接后的组件通过Sn63Pb37共晶的方式焊接在微通道腔体上,并将芯片与热沉焊接层的空洞率控制在10%之内以及热沉与腔体焊接层的空洞率控制在15%之内,保证其热阻较小。
2 实验装置
为验证微流体散热系统的实际散热性能,需搭建测试系统,测试了环境温度为70℃时微流体散热系统的散热能力,测试系统中采用的设备主要有:
1)功率模块,实物如图4所示,上层采用透明的玻璃盖板,便于观察裸芯片的工作情况。功率模块腔体的材料选用为AlSi42,导热系数为140W/(m·K),具有加工性能好、成本低等优势。功率模块腔体内部微流道有两种设计模式:模式一是在平直流道上进行3次打断设计,为交错型流道,宽度设计为0.8mm,高度为1mm,当量直径为0.89mm,如图5(a)所示;模式二为平直流道,尺寸大小与模式一相同,如图5(b)所示。
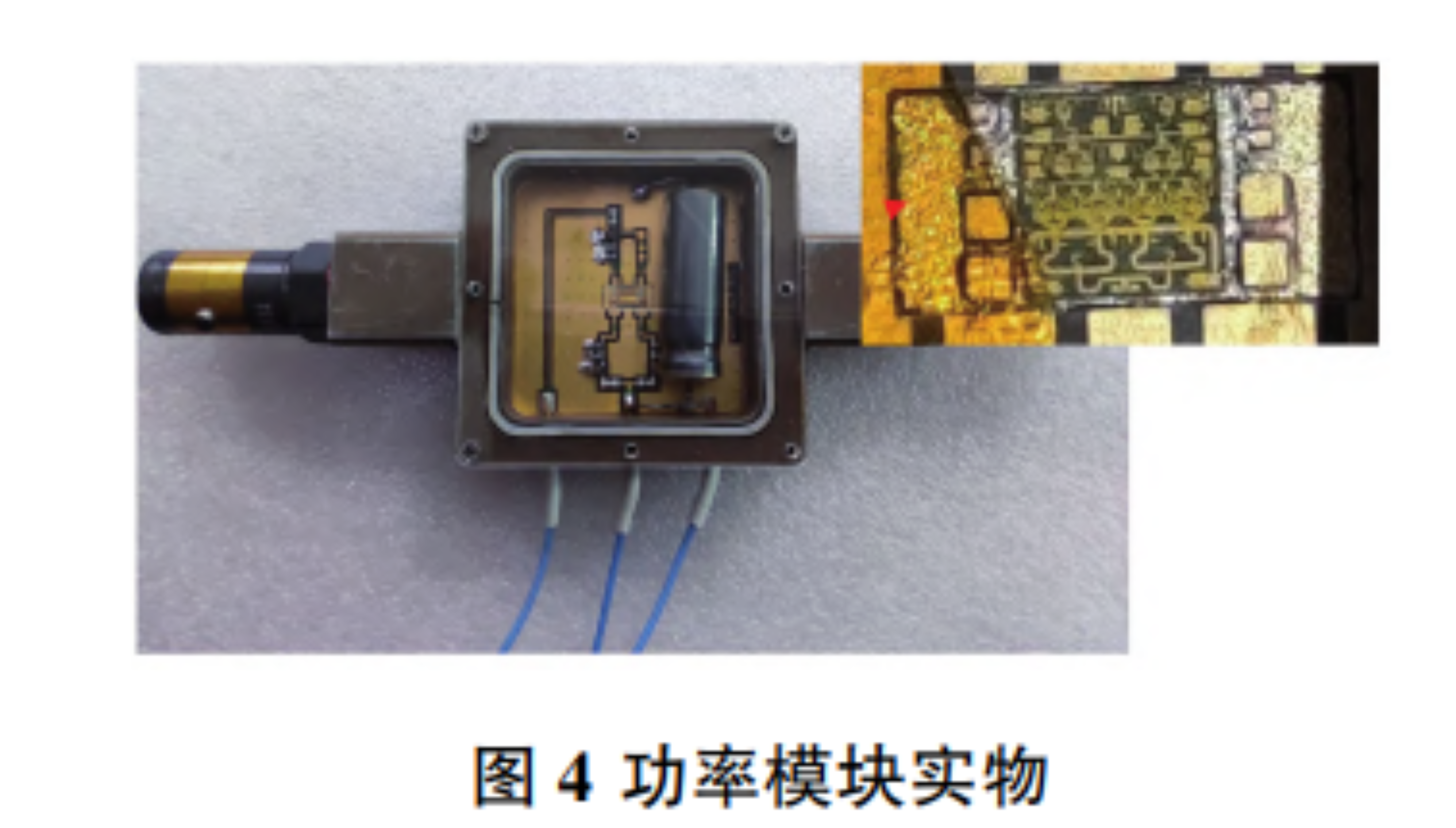
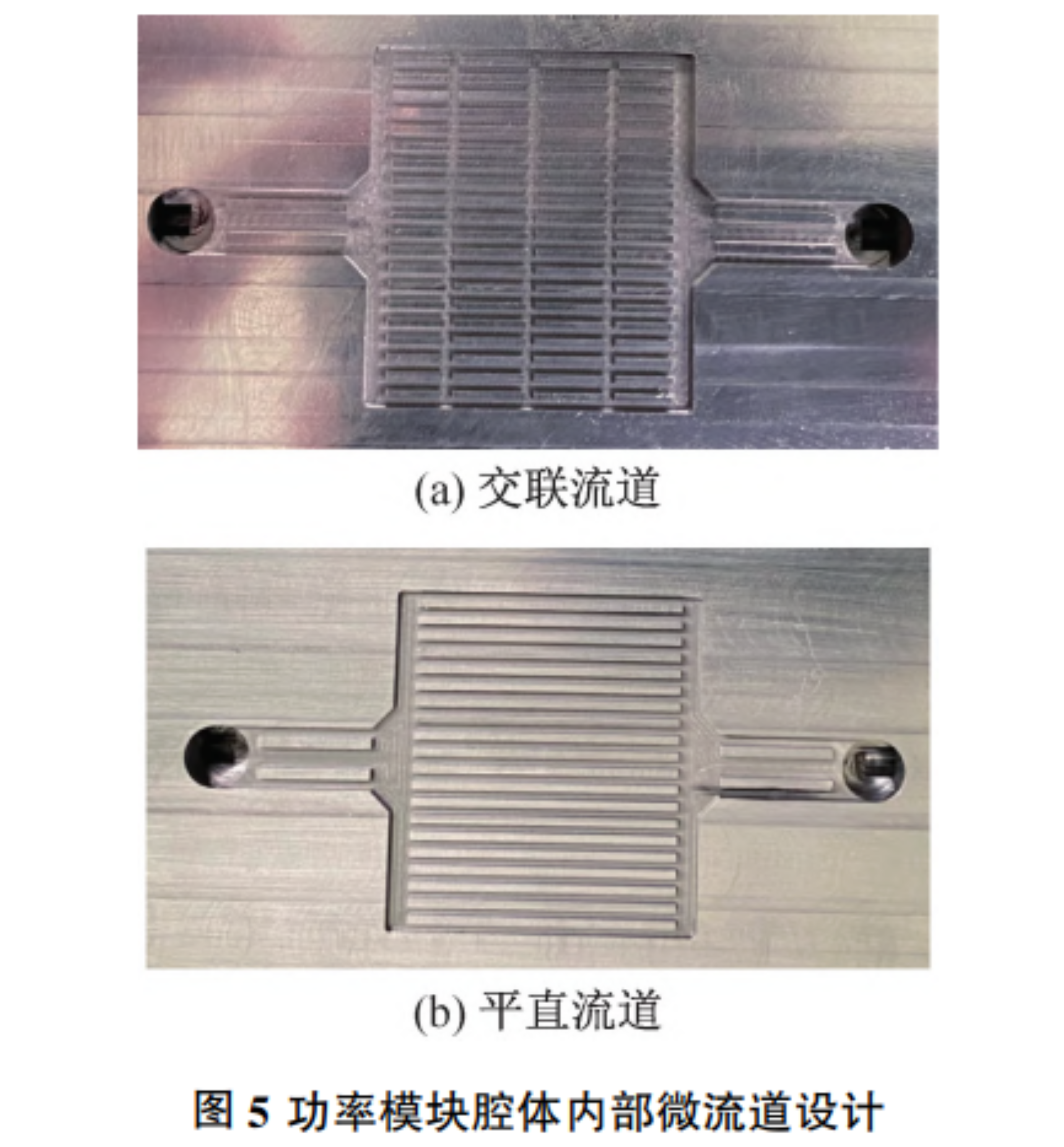
2)裸芯片选用功率放大器芯片NC11613C-1618P30,该芯片是中国电子科技集团公司第13研究所制造,焊接温度小于300℃时,可保证芯片的正常工作,不会因为温度过高造成芯片被烧毁,芯片尺寸为3.6mm×3.5mm×0.1mm(长×宽×高),当漏压设置为28V、栅压设置为最大-2V、静态电流为2.5A、最大静态功率为70W时,芯片表面积为3.15px2、最大表面热流密度可达555W/cm2、最大结温为175℃。
3)实验用热沉材料为金刚石铝,厚度为200μm,导热系数为800W/(m·K)。
4)换热器选用40mm×40mm(长×宽)风机作为风冷源,对系统中吸收裸芯片热量升温后的流体进行散热,换热器尺寸为52mm×41mm×40mm(长×宽×高)。
5)压电微泵流量约为350mL/min,该微流泵需要可调频、调压的驱动电源,以产生相应的偏转位移。实验中使用的驱动电源,具有电压、频率便捷可调的功能。
6)储液器在系统中起到补偿冷却液损失和排空气的作用。系统中使用的循环冷却介质为AF65航空冷却液,该冷却液具有显著的低温性能和防腐蚀性能,在航空、火箭、雷达电子设备等应用领域使用广泛。
7)稳压直流电源为整个系统供电,K型热电偶测试器件表面温度,测试精度为±0.1℃,OMEGA温度数据采集仪采集及处理热电偶测试数据。
根据GJB150.3A—2009《军用装备实验室环境试验方法》,军用机载设备最严酷的使用环境温度为70℃,因此将整个测试系统放置在70℃的高温箱内,测试平台如图6所示。

实际测试过程中因芯片面积较小,且芯片上分布压点,热电偶传感器无法粘贴在芯片上进行测量,而红外测量又无法满足测量精度,因此测量时选取芯片旁边印制板上一点作为测量点,要求此点在不影响键合金线的前提下尽量靠近芯片,测量点位置如图7所示。为了获得芯片最高温度,对微流体散热系统进行仿真,通过仿真得到的监测点和芯片的温度差来近似代替实验测试的监测点和芯片的温度差,再加上实验获得的监测点的温度获得芯片最高温度。
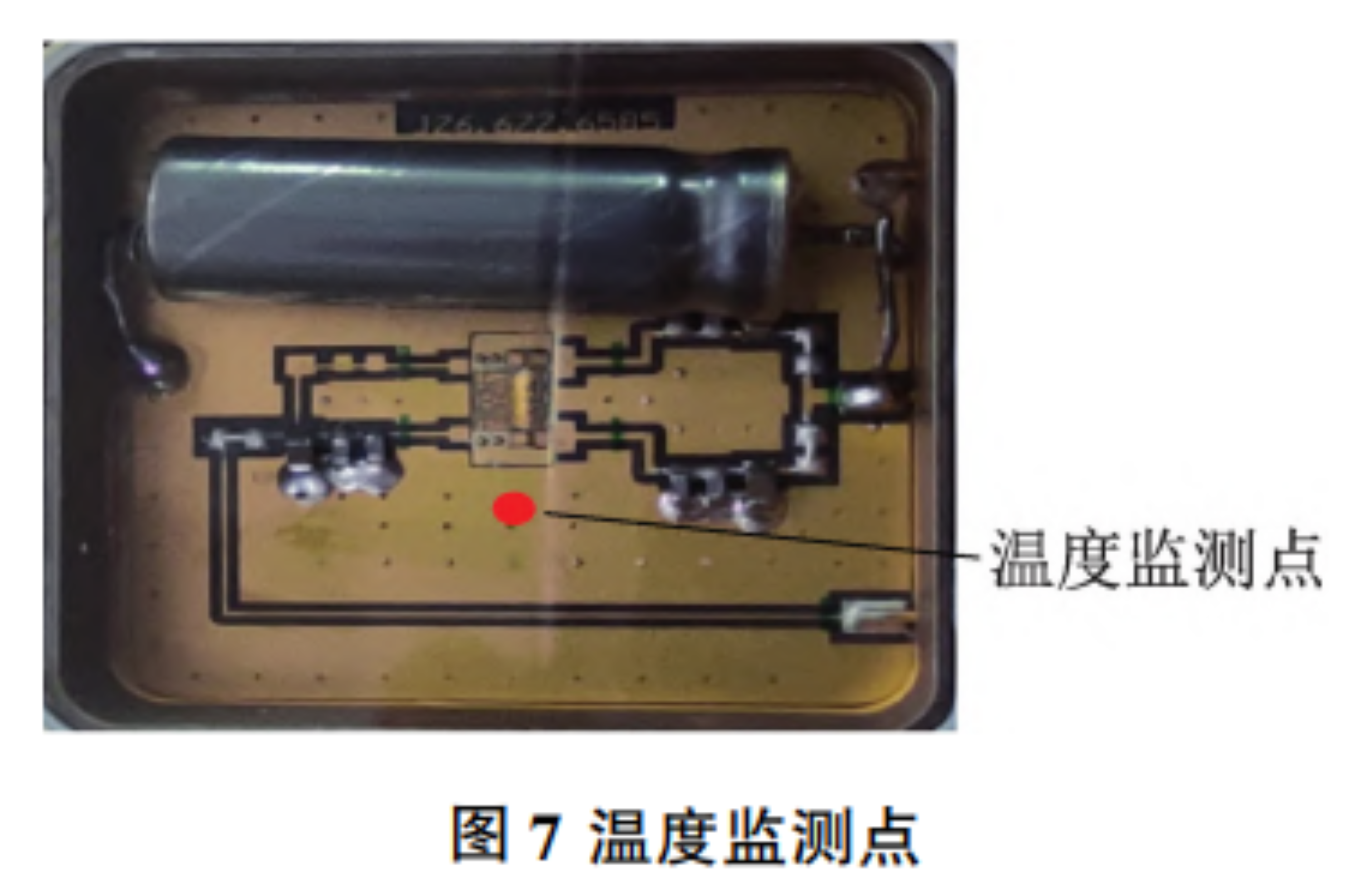
3 结果分析
3. 1 实验分析3. 1. 1 交联流道散热器在热流密度为 80 W/ cm 2 下 的温度测试
实验过程中,设置热流密度为80W/cm2(裸芯片功率为10W),在不开液冷泵的条件下让裸芯片在70℃的高温箱中持续工作,记录观察点温度,直至监测点温度达到稳定状态后开启液冷泵,让冷却液循环整个系统,给腔体内的裸芯片散热。图8所示为监测点温度的变化。由图8可知,高温箱温度为70℃且不开液冷泵时,裸芯片以10W的功率持续工作,监测点温度由70℃不断升高,在约755s时监测点温度达到平衡约为97.8℃。此后开启液冷泵对裸芯片进行循环冷却散热,监测点温度迅速下降,稳定后温度为71.7℃,温升仅为1.7℃。相比不进行循环冷却的状态,裸芯片的温度下降26.1℃,由此可知在新工艺状态下的微流体系统具有较高的散热能力。
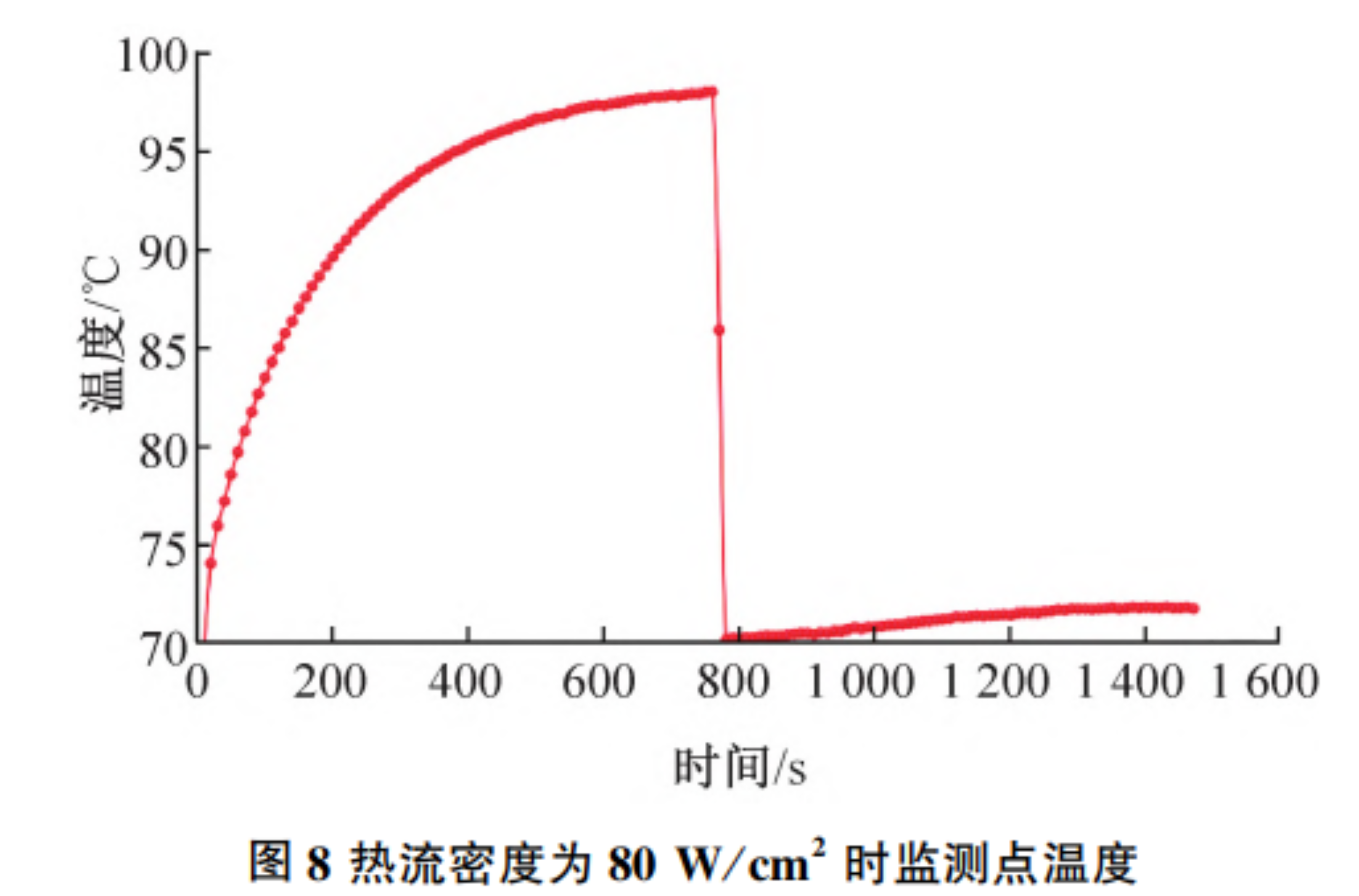
3. 1.2 交联流道与平直流道散热器在多种热流密度下的散热分析
开启液冷泵,改变裸芯片上的热流密度(裸芯片功率),观察监测点的温度变化。图9(a)所示为热流密度为160W/cm2(裸芯片功率为20W)、320W/cm2(裸芯片功率为40W)时,交联流道与平直流道散热器监测点温度随时间的变化;9(b)所示为热流密度为240W/cm2(裸芯片功率为30W)、360W/cm2(裸芯片功率为45W)时,交联流道与平直流道散热器监测点温度随时间的变化。由图9可知,热流密度为360W/cm2时,交联流道和平直流道散热器监测点的最高温度分别为80.5、83.8℃,两种微通道散热器的最大温升均在15℃以内,表明微通道散热器具备良好的散热能力。由图9还可知,在相同时间、功率密度状态时,功率模块在平直流道下要比交联流道下监测点温度偏高;在热流密度较高为320、360W/cm2时,交联流道与平直流道监测点温度的温差比热流密度为160、240W/cm2时更高。表明交联流道散热器的散热能力高于平直流道,尤其在热流密度较高的情况。这是由于交联微通道是一种基于热边界层中断理论设计的具有交错结构的新型微通道结构,针对传统的平直微通道将部分流道进行打断,使工质在流动方向上的边界层重新发展,产生连续的入口发展段热流动边界层,代替平直微通道中的稳定边界层,从而提高散热器的散热性能。
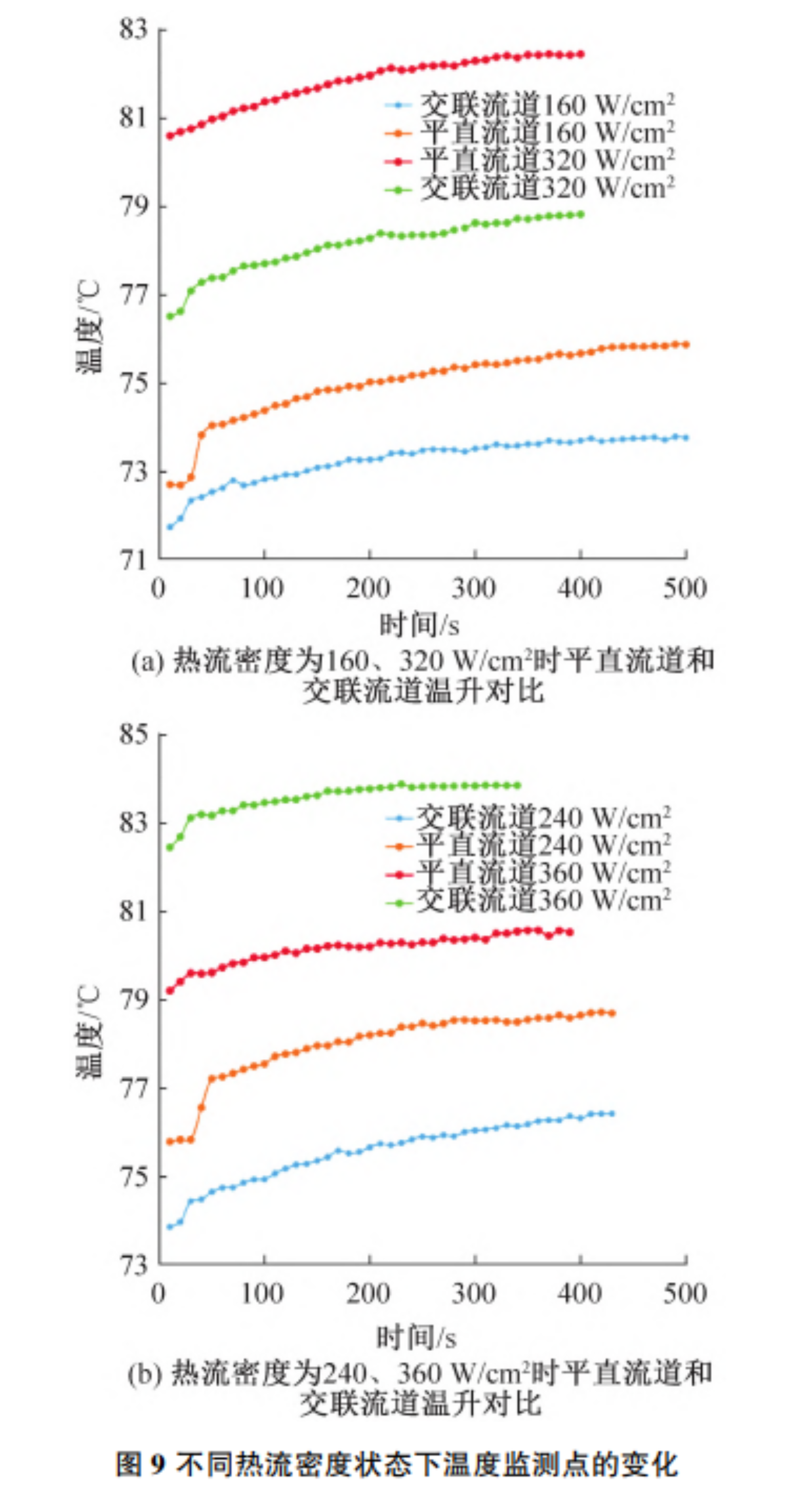
本文后续实验和仿真设计均采用具有交联流道散热器的功率模块。
3.2 实验仿真对比分析
设置仿真环境温度为70℃,对热流密度为80、160、240、320、360W/cm2时,整个微通道散热系统进行散热仿真。选取热流密度为80W/cm2时系统的散热仿真进行分析。热流密度为80W/cm2时,系统的温度分布云图如图10所示。由图10(a)可知,整个系统的最高温度为86.9℃,最低温度为71.2℃;由图10(b)~图10(d)可知,功率模块上最高温度出现在中间芯片的发热位置,裸芯片的最高温度为86.8℃;由图10(e)、10(f)可知,裸芯片上的最低温度为79.8℃,整个系统的最高温度出现在裸芯片正随着热流密度的增加,实验监测点温度和仿真监测点温度也随之增加;同时,仿真监测温度与实验监测温度之间的误差也增加,最低误差为2.71%,最高误差为7.16%,监测点的偏差均在8%以内,仿真结果可靠。在热流密度为360W/cm2时,芯片达到最高温度144℃;当热流密度为320W/cm2时,芯片最高温度为136℃。根据GJB/Z35—1993《元器件降额使用准则》Ⅱ级降额要求,裸芯片的最高结温为200℃,按照Ⅱ级降额标准最高温度应不超过140℃,即在热流密度为360W/cm2时,芯片最高温度超过了Ⅱ级降额最高温度,新工艺下的微流体散热系统已无法解决。此微流体散热系统可解决320W/cm2热流密度的热耗。
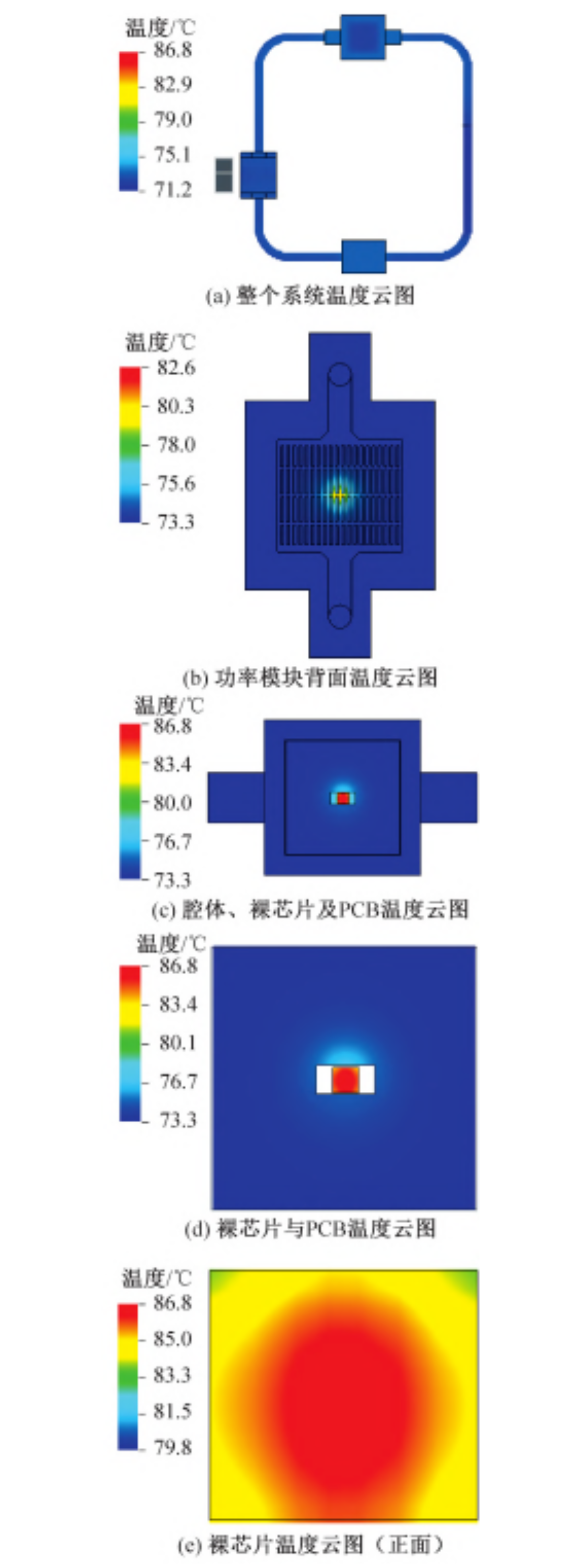
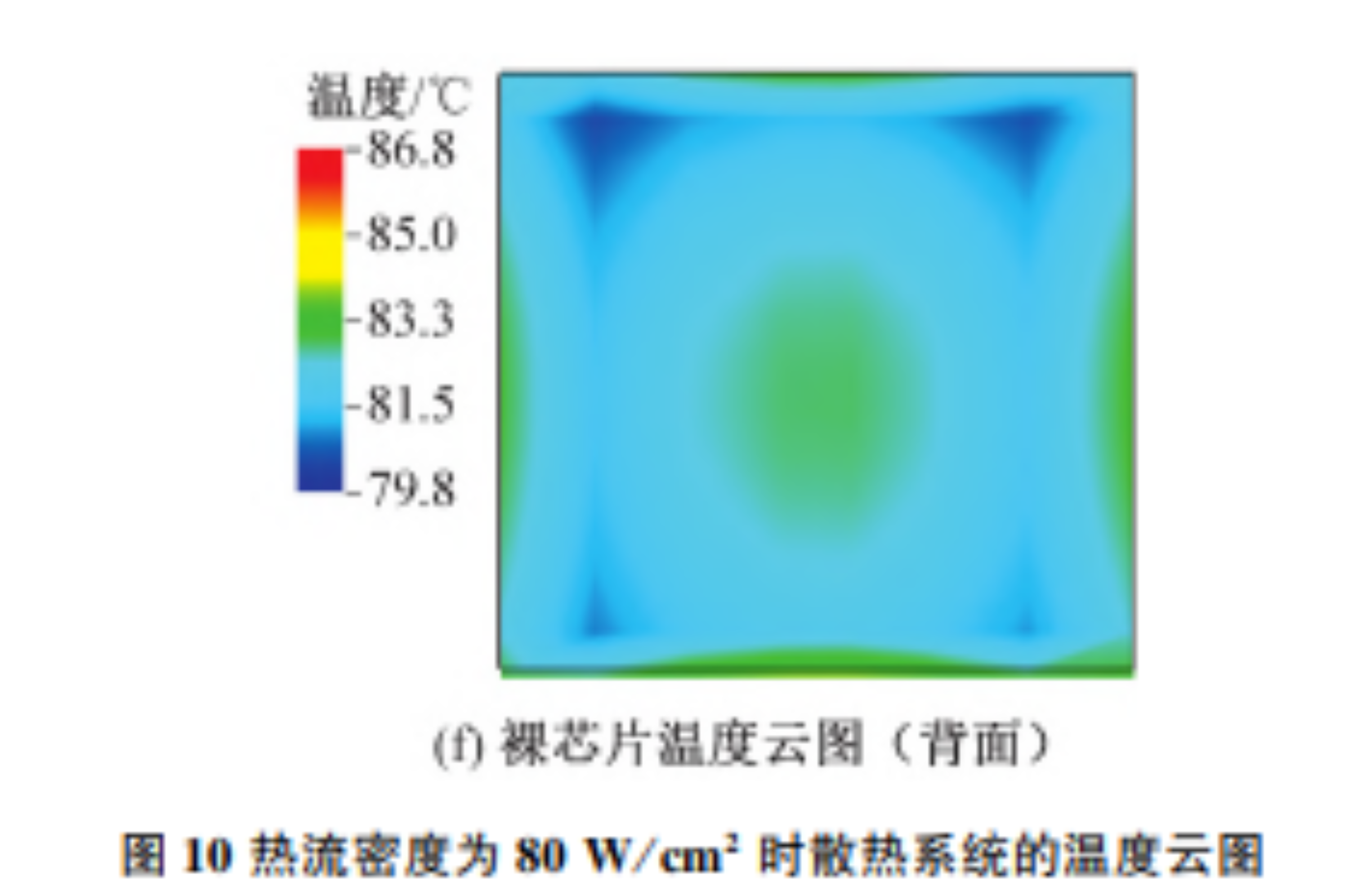
4 结论
本文设计了一种自闭环一体化微流体散热系统,并采用新工艺技术降低了热量从裸芯片到功率模块腔体的传导热阻。得到如下结论:
1)采用共晶焊接替代传统的导电胶粘接模式,新工艺设计方法使得热阻仅为传统工艺热阻的1/360~1/280。
2)热流密度为80W/cm2时,具备循环冷却微通道散热器的裸芯片温升,相比于传统无微通道状态,温度降低26.1℃。
3)利用芯片内嵌微通道技术,将微通道散热器集成于功率模块内部,设计了具有交错结构的交联微通道和普通平直结构的微通道。在多种热流密度状态下(热流密度为80~360W/cm2),具备交错结构的微通道其散热能力要比平直结构更强。
4)环境温度为70℃时,多种热流密度工况下,仿真和实验的最大偏差在8%以内,表明仿真结果可靠。通过实验和仿真分析可知,具备新工艺技术和微流道循环冷却系统的高功率裸芯片,可解决320W/cm2热流密度的裸芯片散热,具备较强的散热能力。
来源/作者:李丽丹 钱自富 张庆军 刘压军 李治 李鹏
四川九洲电器集团有限责任公司
免责申明:本文内容转自:热管理技术,来源/作者:李丽丹 钱自富 张庆军 刘压军 李治 李鹏。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
先艺电子、XianYi、先艺、金锡焊片、Au80Sn20焊片、Solder Preform、芯片封装焊片供应商、芯片封装焊片生产厂家、光伏焊带、银基钎料、助焊膏、高温助焊剂、高温焊锡膏、flux paste、陶瓷绝缘子封装、气密性封装、激光器巴条封装、热沉、heatsink、IGBT大功率器件封装、光电子器件封装、MEMS器件封装、预成型锡片、纳米银、纳米银膏、微纳连接技术、AuSn Alloy、TO-CAN封装、低温焊锡膏、喷印锡膏、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、silver sinter paste、Ceramic submount、低温共晶焊料、低温合金预成形焊片、Eutectic Solder、低温钎焊片、金锡Au80Sn20焊料片、铟In合金焊料片、In97Ag3焊片、锡银铜SAC焊料片、锡锑Sn90Sb10焊料片、锡铅Sn63Pb37焊料片、金锡Au80Sn20预成形焊片、Au80Sn20 Solder Preform、大功率LED芯片封装焊片生产厂家、TO封帽封装焊片、In52Sn48、铟银合金焊片、纯铟焊片供应商、铟In合金预成形焊片、锡银铜SAC305(Sn96.5Ag3.0Cu0.5)焊片、锡银铜预成形焊片焊箔供应商、锡锑焊片、Sn90Sb10 Solder Preforms、锡铅焊片、锡铅Sn63Pb37焊片供应商、锡铅Sn63Pb37焊片生产厂家、锡铅预成形焊片、金锡合金焊片选型指南、低温合金焊片应用、低温合金焊片如何选择、预成形焊片尺寸选择、xianyi electronic、半导体芯片封装焊片、光电成像器件的盖板密封焊接、无助焊剂焊片、圆环预成形焊片、方框预成形焊片、金属化光纤连接焊片、金基焊料、金锗焊料、金硅焊料、器件封装焊料、预涂助焊剂、带助焊剂焊片、金锡助焊剂、共晶助焊膏、预置焊片、金锡封装、箔状焊片、预制焊锡片、预镀金锡、预涂金锡
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








