AMB陶瓷覆铜载板的关键特性及失效形式
AMB陶瓷覆铜载板的关键特性及失效形式
AMB陶瓷覆铜载板由陶瓷和铜通过活性钎焊的方式复合得到,同其它钎焊产品一样,界面空洞率是非常关键的性能指标。不同应用领域对钎焊界面空洞率有着不同的要求,空洞率直接影响产品的导热、绝缘放电、结合可靠性等使用性能。
对于界面空洞率,高功率电子器件封装一般要求低于1%,通常在0.1%-0.5%之间;电子散热器通常要求在0.5%以下;LED、医疗电子、汽车电子一般要求低于1%;航空航天电子会要求到0.1%以下。
以上是各领域对钎焊封装界面空洞率的一般要求,行业内对AMB陶瓷覆铜载板的界面空洞率尚没有统一的标准,但是可以确定的是低空洞率甚至无空洞对应用性能和可靠性是有利的。AMB陶瓷覆铜板标准尺寸是7.5x5.5 inch,如此大的焊接面积在钎焊过程中很难避免空洞出现,如图1的样品界面C-SAM图片。目前,先艺电子的AMB陶瓷覆铜载板产品在批量生产实践中能够很好的将界面空洞率稳定控制到极低水平,如图2的产品界面C-SAM图片。
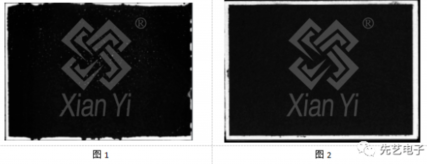
对于常规的钎焊封装结构,一般界面空洞是失效的源头,但是对于AMB陶瓷覆铜载板,温度冲击下的界面失效通常发生在铜的边角处,如图3样品在温度冲击后的界面C-SAM图片,这是由于边角处是陶瓷和铜热失配应力的主要集中位置,与AMB陶瓷覆铜载板在温度冲击下的热应力模拟分析结果是一致的。对于Si3N4-AMB陶瓷覆铜载板,界面剥离一般发生在钎料层与Si3N4陶瓷表面的互连界面处(如图4),但是对于AlN-AMB陶瓷覆铜载板,由于AlN的机械强度不如Si3N4陶瓷,且陶瓷自身脆性较强,界面剥离则一般发生在陶瓷侧内部,剥离形式也呈现出偏韧性剥离和脆性崩裂的差异。
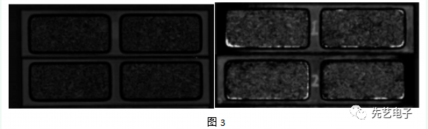
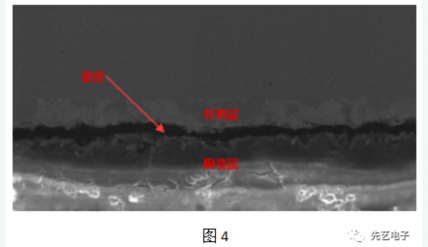
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10 Solder Preforms
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








