电子封装低温互连技术研究进展(上)
电子封装低温互连技术研究进展(上)
黄天 甘贵生 刘聪 马鹏 江兆琪 许乾柱 陈仕琦 程大勇 吴懿平
(重庆理工大学 金龙精密铜管集团股份有限公司 华中科技大学)
摘要:
电子产品作为现代电子行业的产物,已逐渐成为社会发展的主导力量,在电子产品封装过程中,电子器件的封装温度过高会产生较大的热应力,进而降低其可靠性。随着电子器件趋于微型化、高功率化、高集成化,其服役温度越来越高,如何解决电子器件“低温封装、高温服役”这一问题已迫在眉睫。本文就低温电子封装材料及方法,从封装母材、连接材料及连接方法三个方面进行总结,指出只有从母材、焊材及焊接方法同时入手,才能达到最佳技术效果,提出在母材表面制备链长更长的、易去除的临时保护层,采用烧结纳米银、纳米铜或瞬时液相混合焊料,借助与焊缝非直接接触的超声搅拌等材料和方法有望克服低温封装的技术瓶颈,同时提出采用微米级混合焊料并辅以超声振动实现连接的新思想。
1 前言
随着5G技术、物联网技术、生物芯片技术等的崛起,现代电子行业也迎来了迅猛发展,支撑这些高新技术的电子产品逐渐趋于微型化、便携化和多功能化[1]。在电子产品的制造过程中,芯片的集成与封装一直以来都是行业的焦点,由于芯片与封装体存在热膨胀系数差异,在封装温度很高的情况下产生的热应力会降低其可靠性,甚至导致电路失效。近年来低温封装逐渐成为行业主流,其相关研究已在中国、美国、日本及欧洲等诸多大学和研究机构中广泛开展[2-4]。降低封装温度的方法主要包括三个方面:一是表面活化处理、表面纳米化(图形+结构)或表面无氧保护等封装母材表面处理技术,如Takigawa等[5]使用表面活化键合法(SAB)在室温条件下成功实现了GaN与LiNbO3的连接,Zhou等[6]使用电镀的方法在Cu基板上制备出纳米Ni阵列并使用Au膜覆盖其表面以实现对Cu基板的纳米化处理,Ghosh等[7]在Cu-Cu键合过程中使用自组装单层膜(SAM)来保护Cu表面使其免受氧化和其他污染;二是选用低温焊料、纳米焊料或混合焊料等连接材料,如Yang等[8]分别使用Sn5Bi、Sn10Bi和Sn58Bi三种低温焊料进行Cu-Cu互连,Fan等[9]使用树枝状Ag纳米结构物质作为连接材料,梅云辉等[10]将微米Ag颗粒(1~2μm)与纳米Ag颗粒(20~50nm)混合均匀并加入有机溶剂形成混合焊料,在280℃烧结温度下连接了IGBT与DBC衬底;三是采用超声辅助、激光瞬时加热或局部加热等特殊的低温封装方法,如甘贵生等[11]使用SAC0307颗粒(混入10%45μmZn颗粒)作为焊料,在220℃低温、4MPa压强下使用超声辅助实现了Cu-Cu互连,Kawano等[12]使用波长为532nm的脉冲纳秒激光辐照Si表面,仅在2min内就实现了Si与LiNbO3的键合,Kim等[13]使用980nm波长的均质矩形激光束辅助超薄倒装芯片封装(FCCSP),激光辐照仅在局部产生加热效果,大大降低了热输入。基于WLP、SiP、3D-TSV等先进封装对低温互连的强烈需求,本文从封装母材、连接材料、连接方法三个方面综述了近几年来电子封装低温互连技术的研究进展,并就发展方向提出一些自己的见解。
2 低温电子封装技术研究进展
2.1 焊接母材表面处理的研究
(1) 母材表面活化
表面活化键合技术(SurfaceActivatedBonding,SAB)是通过Ar原子或离子高速轰击材料表面,使材料表面具有高活性,同时经过高能粒子轰击,材料表面的有机物及杂质在真空环境下分解,为材料表面进行原子级接触提供了可能,然后通过施加一定压力,使两个已被活化的表面在真空环境中紧密接触,依靠化学键的作用,使表面能量降低,实现原子尺度上的牢固结合,在低温条件下就能达到良好键合强度的真空低温键合方法。上个世纪90年代,日本东京大学的Suga课题组首先采用离子束高速轰击材料表面的方法,使材料获得了高活性,但由于材料直接暴露于空气当中,很容易使其表面氧化及污染,为此课题组开发了专门的表面活化键合设备,使得材料能在绝对真空的环境下进行活化和键合,实现了半导体材料领域的Si-Si、Si-GaAs以及Si-LiNbO3的键合[14]。
随着5G技术及大功率电子的迅速崛起与普及,以GaN、SiC为代表的具有禁带宽度大、击穿场强大、介电常数小、电子饱和漂移速度高、绝缘性能好等优异物理性能的第三代半导体(物性参数见表1[15,16])应运而生,高温、高频、大功率和高密度等极端工作环境对低温封装提出了新要求,诸多文献报道表明表面活化键合技术很好地契合了这些封装需求。如Mu等[17]采用氩离子束轰击GaN与Si表面,发现离子束轰击后的GaN表面有轻微的光滑效应,GaN-Si的结合强度与传统硅强度相当。Liang等[18]利用表面活化键合技术在室温下成功制备了GaN-金刚石异质接头,GaN/金刚石界面存在较小的压应力,但明显小于由晶体生长形成的GaN-on-diamond结构。Ryo等[19]采用含铁氩离子束轰击GaN和LiNbO3,沉积的含Fe中间层在LiNbO3表面和GaN表面间形成了牢固的结合(图1),在室温条件下得到了抗拉强度26MPa的键合接头。Mu等[20]采用溅射沉积Si中间层的表面活化键合技术,仅在室温条件下就实现了GaN与更高导热率的单晶CVD金刚石衬底的键合;采用对SiC表面进行活化并溅射沉积Fe-Si中间层,在室温条件、4MPa压强下得到了剪切强度为18MPa的SiC-Si接头[21];在SiO2表面溅射Si层并采用表面活化键合技术,极大减少了界面孔洞,SiC表面和溅射Si层后SiO2表面的粗糙度分别为0.25nm和0.33nm,溅射Si层使SiO2-SiC键合界面(图2)的表面能从0.2J/m2提高到2.4J/m2,成功实现了室温条件下SiC与SiO2之间的键合[22]。Ryo等[23]使用Ar离子束快速轰击SiC和LiNbO3表面进行活化,在室温条件下将其表面直接接触进行键合,测得SiC-LiNbO3接头的剪切强度为11MPa。Kang等[24]使用O2对SiC和Si基衬底进行持续时间60s左右的表面活化,然后在不到200℃的低温条件下成功得到了SiC-SiO2、SiC-Si和SiC-玻璃的无空隙、稳定键合接头。
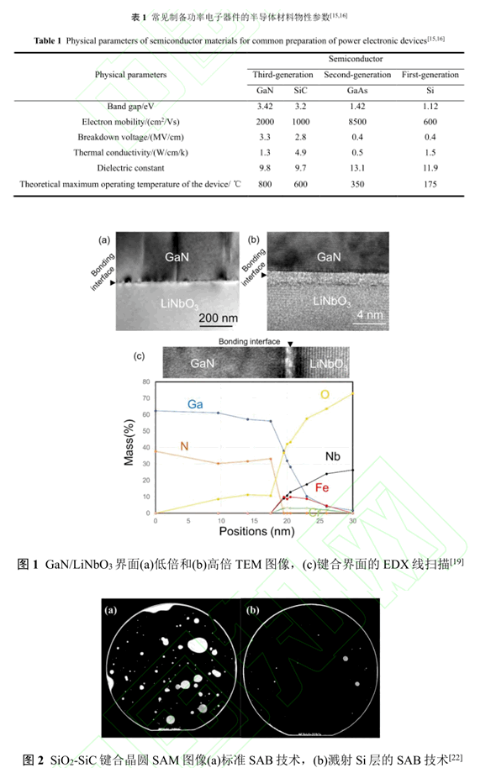
在电子封装领域中,陶瓷基板具有优良电绝缘性能、高导热特性、优异的软钎焊性和高的附着强度,并可像PCB板一样能刻蚀出各种图形,具有很大的载流能力,已成为大功率电子器件电路结构技术和互连技术的基础材料。AlN具有相对较高的热导率(约200W/m·K),常被作为高功率器件的散热器及第三代半导体的封装基板。多项研究表明,AlN基板可以通过表面活化键合技术直接键合到AlN、Al和Si基板上[25]。如Matsumae等[26]采用改进SAB技术(图3),在Ar离子束高速轰击AlN表面去除有机污染物和氧化物后,再溅射沉积Si附着层,标准SAB接头中Si-Si键的结合强度仅为0.9J/m2,改进SAB接头中Si-N键的结合强度高达2.5J/m2。Kaaos等[27]通过O2、Ar、SF6、SF6+Ar和SF6+O2等离子体活化,对AlN表面进行SAB处理能使其表面亲水性增强、表面粗糙度降低,进而实现了室温条件下与Si直接键合。
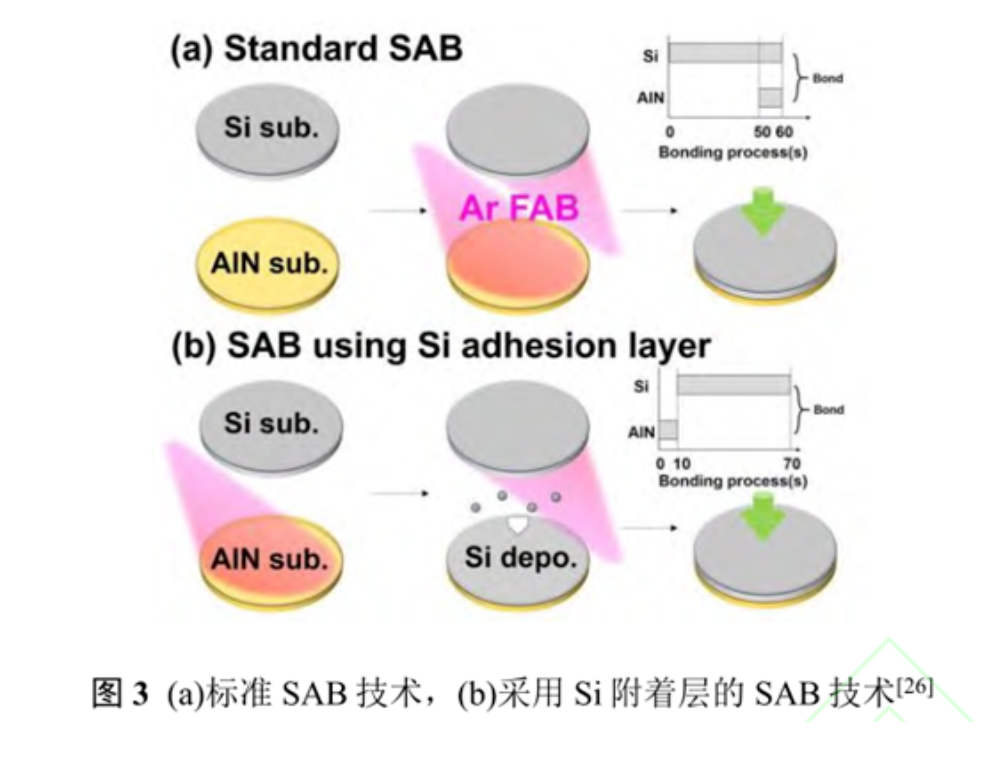
除了应用于陶瓷材料之间的键合外,表面活化键合技术还常用于金属材料之间。Takahashi等[28]研究了采用高能Ar离子束持续轰击60s以上以除去Nb表面的氧化膜(Nb2O5和NbO)和其它杂质,得到了清洁的待键合表面,为室温下超导器Nb-Nb间的SAB直接键合提供了可能。He等[29]通过表面活化键合技术将Cu-Cu在超真空室温环境下进行了键合,Cu-Cu键合界面(图4)结合良好,未见孔洞与空隙,接头结合强度达到了2.5J/m2。Wang等[30]采用氩气(混合5%氢气)等离子体预处理Si表面的Cu镀层,降低了Cu表面的氧含量,有效地提高了其表面活性,200℃下Cu-Sn连接界面无缺陷,接头剪切强度最高可达8MPa。He等[31]将含甲酸(HCOOH)的蒸汽通入流动氩气中并对Cu进行表面活化,在180℃左右到了剪切强度高达100MPa的Cu-Cu接头。Chua等[32]在Ar/N2等离子体环境下将Cu表面进行活化并在室温下键合,250℃退火后Cu-Cu接头平均剪切强度最高可达20.3MPa,接头经过-40~125℃的1000次温度循环后,暴露的Cu表面虽被严重氧化,但接头仍能很好地结合(图5)。
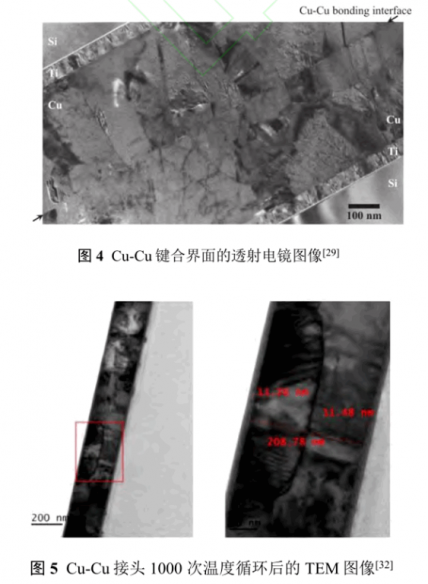
此外,Kang等[33]还提出了一种表面活化混合键合机制(活化和键合过程如图6),分别键合了Cu-Cu、SiO2-SiO2与Cu-SiO2。首先,用Ar/O2等离子体(其中O2含量为0.2%)对Cu和Si表面的热氧化物SiO2单步活化30~150s,Ar等离子体可以去除表面有机污染物和氧化物,O2等离子体可以有效提供−OH基团,在50%甲酸(FA)溶液中浸泡20min后用去离子水超声清洗30s,最后用流动的氮气干燥。Cu-Cu、SiO2-SiO2与Cu-SiO2三种样品在200℃(上压片)和25℃(下压片)的大气环境、2.5MPa压强中进行30min的热压连接,其中样品底部温度被稳定在135℃左右,结合界面的实际温度为185±3℃,随后连接样品在200℃下退火2h。结果发现当活化时间延长至120s时,Ar/O2→FA(表面活化后再甲酸处理)和FA→Ar/O2(甲酸处理后表面活化)活化得到的Cu-Cu接头最大剪切强度分别为13.46MPa和12.35MPa;对于SiO2-SiO2接头,FA→Ar/O2活化所得到样品的整体剪切强度高于Ar/O2→FA活化所得到样品,其最大剪切强度接近4MPa;使用FA→Ar/O2活化并低温键合的Cu与SiO2接头微孔较少、晶粒生长充分。
表面活化键合技术能成功应用于多种陶瓷材料与陶瓷材料、金属材料与金属材料、金属材料与陶瓷材料之间。该方法自诞生以来,就受到电子封装行业的广泛关注,但仍存在一些问题限制了该方法的大规模推广,如该方法对氧化物类材料像SiO2、石英等不适用,其键合强度很低,仍须退火工艺,此外该方法要求极高真空系统,设备昂贵,大规模生产成本较高。
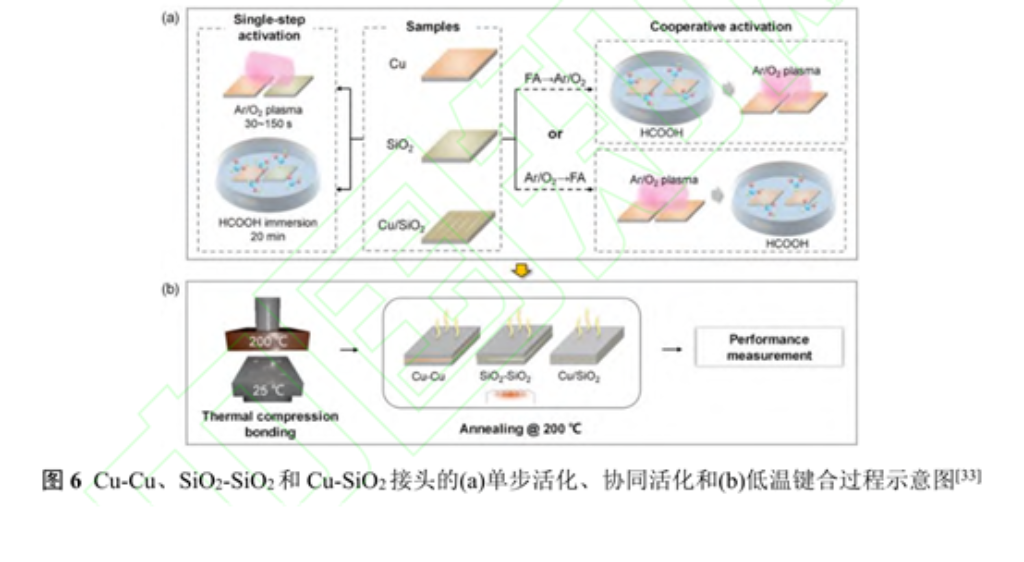
(2)母材表面纳米化
在电子封装中,除了母材表面活化外,还可以在母材表面溅射纳米连接层或形成纳米尺寸结构,利用纳米材料特殊的物化性质,同样也能达到降低封装温度、提高连接可靠性的目的。如Suga等[34]首先用Ar离子束轰击晶片表面,清除污染物和氧化层,同时在晶片表面溅射1nmFe粘结层;然后,用离子束溅射法在Fe粘结层上沉积10nmSi中间层;之后,再用Ar离子束轰击活化Si中间层,同时在Si中间层上再沉积1nmFe粘结层;最后在真空条件为10-5Pa、5kN压力的室温下,使活化表面相互接触300s得到了键合强度高于32MPa的SiC-SiC接头,过程如图7所示。又如Cai等[35]先在Si衬底上溅射50nm的Ti镀层和500nm的Cu镀层,再电镀上Cu-Zn合金,随后使用去合金化法去除Cu-Zn合金中的Zn,从而制备出具有纳米多孔结构的Cu表面层,在280℃、300N的压力条件下对两块经相同方法处理的Si衬底进行连接,样品平均拉伸强度达到8MPa,其连接层的横截面和工艺流程如图8所示。
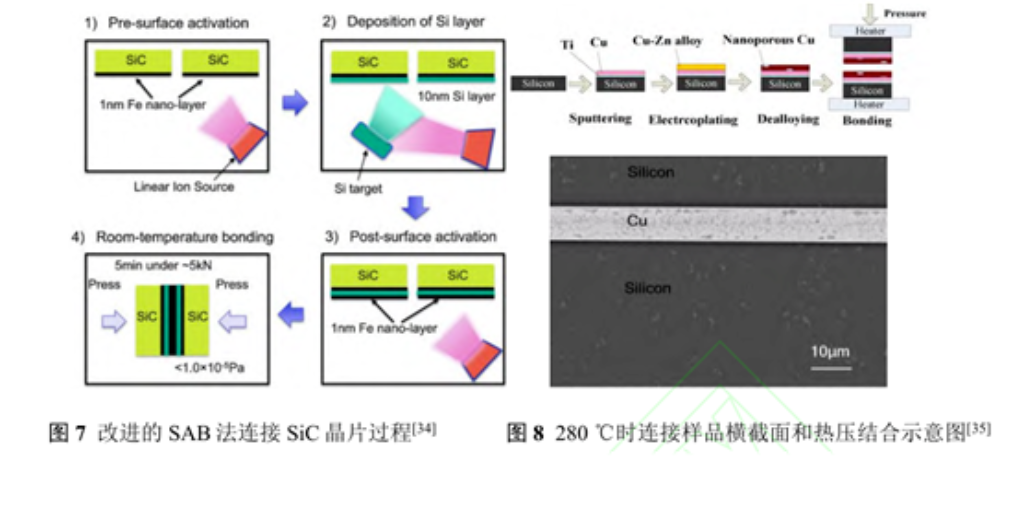
除了以上两种在母材表面形成纳米连接层方法外,也见在母材表面形成纳米尺寸结构的大量报道。如Hu等[36]提出了一种在Cu凸点上电镀一层镍锥阵列(Ni-MCAs)并与Ag层低温键合的方法,其中Ni-MCAs的平均高度为800~1000nm,在180MPa的键合压强和250℃的低温下连接20min,发现当连接温度为250℃时,Ni-MCAs有效嵌入到Ag层当中且界面没有出现空洞。Lu等[37]使用化学沉积法制备出Cu-Ni微锥阵列在190℃的低温条件下与Sn-3.0Ag-0.5Cu焊料结合,结合过程施加压力质量为500g、750g和1000g时得到的接头平均剪切强度分别为22.7MPa、32.6MPa和45.2MPa。还有相关文献[38]报道在Cu微锥表面化学镀Ag可得到具有高剪切强度的焊点,在190℃的低温下实现了Sn-3.0Ag-0.5Cu锡球焊料与Cu微锥基板(镀Ag)的热压结合,Cu微锥结构完全插入焊料当中,在结合界面上没有发现孔洞,焊点剪切强度高达43.4MPa。此外,有研究者[39]使用同样的方法在Cu微锥表面镀Sn,并在连接过程中用超声波进行辅助,成功实现了Cu-Cu之间的结合。Wang等[40]利用斜角沉积技术在Si晶片上溅射一层厚500nm的纳米Cu柱阵列(纳米柱直径为10~20nm,高度为760nm),在0.32MPa键合压强和200~400℃低温条件下就可以实现Cu-Cu的键合(图9)。
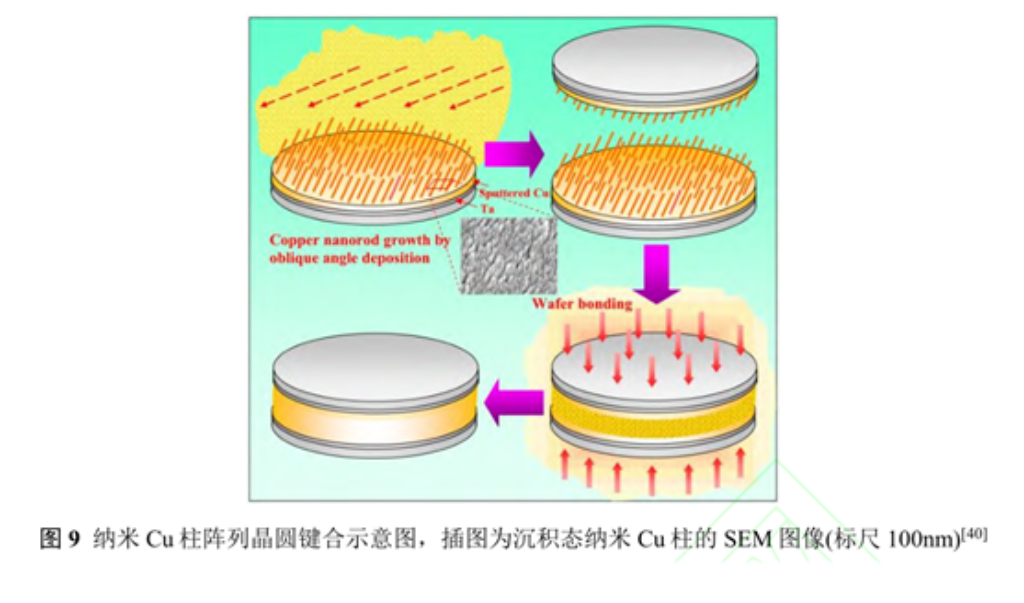
除了在母材表面形成纳米结构外,还有文献报道了在纳米结构上涂覆另一种纳米材料进行互连。Wang等[41]运用化学镀层法在尺寸为50px×25px的C194Cu基板上制备出一层Cu纳米锥状阵列(CuNCA),CuNCA中每一个锥体的尖端直径约为20nm,底部平均直径为2μm,高度在2~4μm之间(图10),而后将石墨烯涂覆在经过处理的CuNCA表面,最后在150℃低温、1500gf压力条件下将直径为760μm的SAC305焊球与CuNCA进行连接,经过相同热老化时间发现,未加入石墨烯层的Sn-Cu接头剪切强度下降了两倍,石墨烯层的加入有效延缓了IMC(Cu6Sn5)的生长,其接头的剪切强度并没有降低(图11)。在文献[42]中提出并讨论了这种纳米结构在互连过程中可能存在的机理,即纳米微锥结构插入到焊料当中时,会导致焊料塑性变形和“堆积”,并在结合界面上形成孔洞,但纳米微锥结构与焊料之间的固态扩散会使界面孔洞收缩,从而增加了微锥与焊料之间的接触面积,提高了焊点的剪切强度。Liu等[43]为了降低Cu-Cu键合时的温度并缩短键合时间,设计了使用脉冲激光沉积(PLD)技术将纳米Ag物质沉积在Cu焊盘上形成了凹凸的三维纳米结构,当连接条件为高温(250℃)低压(20MPa)或低温(180℃)高压(50MPa)、连接时间均为5min时,能得到剪切强度较高(>9MPa)的接头(图12为连接界面)。

Du等[44]提出了一种新型的低温氢热分解还原方法在Cu基板上直接合成了Cu纳米线(如图13),在300℃的低温和40MPa的压强下得到了剪切强度高达44.4MPa的键合接头。Mou等[45]将异丙醇(IPA)处理后的Cu纳米膏涂覆在Cu基板上,然后在2MPa的压强、250℃和275℃的低温下进行Cu-Cu键合,得到的接头剪切强度分别达到了28.3MPa和35.1MPa。Panigrahi等[46]通过在Cu表面沉积一层3nm厚的超薄Ti层来抑制Cu的氧化,并将Cu表面的粗糙度从2.1nm降低至0.4nm,从而在160℃低温和0.25MPa低压下实现了Cu-Cu键合。Hou[47]提出了一种基于冷喷涂沉积和氧化还原工艺的新方法,首先在Cu基板上形成紧密排列的微米级Cu颗粒,然后通过氧化作用在Cu颗粒上形成Cu2O纳米粒子,在甲酸气氛中Cu2O纳米粒子被完全还原为Cu纳米粒子,最后在300℃低温、15MPa压强下得到了剪切强度最高为32.9MPa的Cu-Cu接头。
在电子封装中,对母材表面的纳米化处理利用了纳米材料特殊的物化性质,可以降低封装温度、增大接触面积并提高结合强度,同时也在一定程度上降低了封装过程对连接表面平整度的苛刻要求,但由于纳米材料具有极高的表面能,这会导致其性质非常活泼,且纳米材料易氧化,在连接前就有可能发生聚合,此外材料表面过分纳米化会导致氧化反应更为严重,氧化物更难去除,故该方法还在不断改进中。
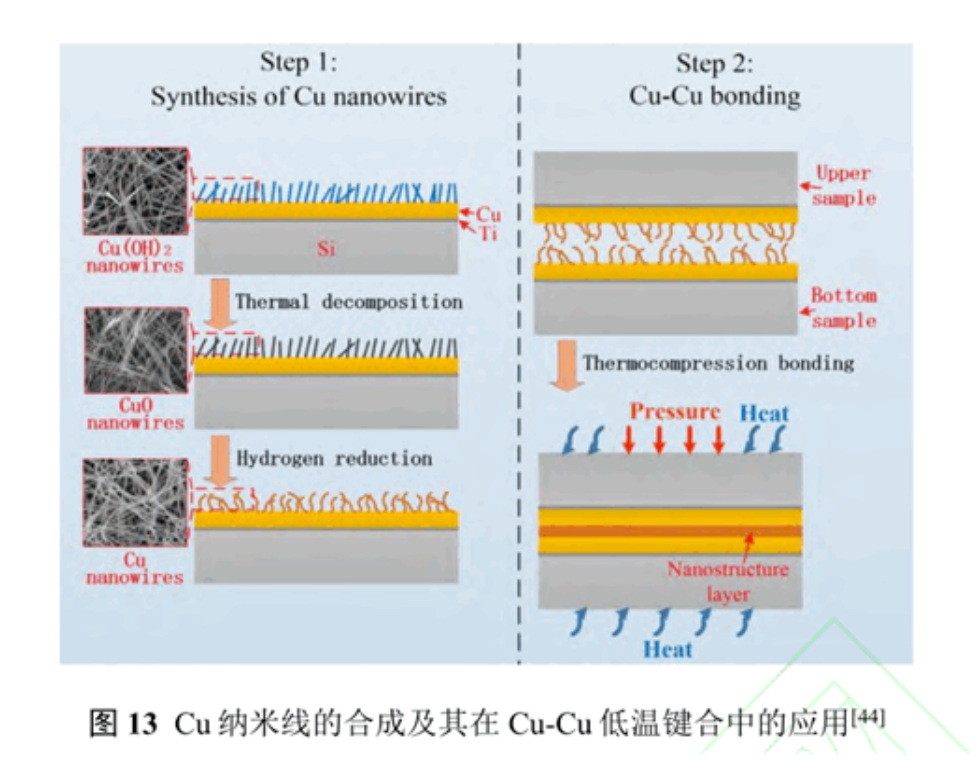
(3)母材SAM表面处理
SAM表面处理是指使用自组装单层膜(SAM)作为母材表面的临时保护层,可防止母材在空气中快速氧化和污染,常用的SAM为烷基硫醇(alkane-thiol)。目前,对于SAM的沉积有两种常用的方法:湿式沉积和气相沉积。湿式沉积成本低廉、操作方便,是直接将样品浸没在SAM溶液中,以使SAM结合到样品表面,每个样品的沉积时间通常为数小时到一整天,但SAM溶液长时间放置会产生聚合作用,因此对于实际生产制造来说这种方法显然不适合。相比之下,气相沉积法在沉积之前先利用等离子体处理材料表面,使得材料在沉积时与SAM有高度的反应性,仅在5min沉积后材料表面就能产生SAM膜,不仅增加了反应速度,还有助于化学键的形成。
Lykova等[48]采用SAM对Cu表面进行钝化并在-40℃保存一周,发现其表面几乎没有发生氧化现象,长链SAM(十六烷基硫醇)比短链(六烷基硫醇)对Cu表面的保护作用更有效,且SAM的保护作用随其链长的增加和温度的降低而增加;他们还分别使用电化学沉积(ECD)和经过SAM钝化后物理气相沉积(PVD)制备了两种类型的Cu基板,并在250℃的低温下实现了Cu-Cu键合,PVDCu-Cu接头在连接时间为45min时的剪切强度最高,均值达到了196MPa[49]。Wang等[50]提出了一种新型等离子体自组装单层膜(PcSAM)预处理方法以改善电镀Cu的表面性能,PcSAM(六烷基硫醇)预处理后Cu表面的氧含量降低至1.39%,仅在200℃条件下就实现了Cu-Sn键合,剪切强度高达68.7MPa。Tan等[51]在镀铜硅片表面使用SAM处理,在250℃低温下得到的Cu-Cu键合接头剪切强度为54.0~65.8MPa,经过SAM(六烷基硫醇、十二烷基硫醇)处理后的键合界面可见分层面已完全消失,Cu晶粒生长布满了整个键合层(图14)。Bakish等[52]使用SAM(九烷基硫醇、十四烷基硫醇)表面处理,在120~150℃下成功键合了Si与InP,其接头剪切强度超过了表面活化键合的Si-InP接头。Ang等[53]通过SAM(十二烷基硫醇)处理Au表面,防止表面污染的同时还在键合处通过热解吸降低了封装温度,160℃下得到了平均冲击强度达到了26.9g的Au-Au接头。Lim等[54]在250℃低温下键合了SAM处理的Cu-Cu表面发现,由于键合前长链SAM(十二烷基硫醇)不完全解吸,短链SAM(六烷基硫醇)处理的样品剪切强度最佳。Liu等[55]通过在烧结之前的Cu基板上进行SAM表面处理(十八烷基硫醇)以抑制纳米Ag氧化,280℃下使用烧结纳米Ag得到的Cu-Cu接头剪强度达12.72MPa,远高于未采用SAM处理时的3.77MPa。Ghosh等[56]使用SAM(丙烷基硫醇)处理Cu表面,其接触角急剧降低,表面由亲水性变为疏水性,用He等离子体解吸SAM层后Cu表面接触角进一步降低,在200℃低温、4kN键合压力下得到了最大载荷为800N的Cu-Cu接头。
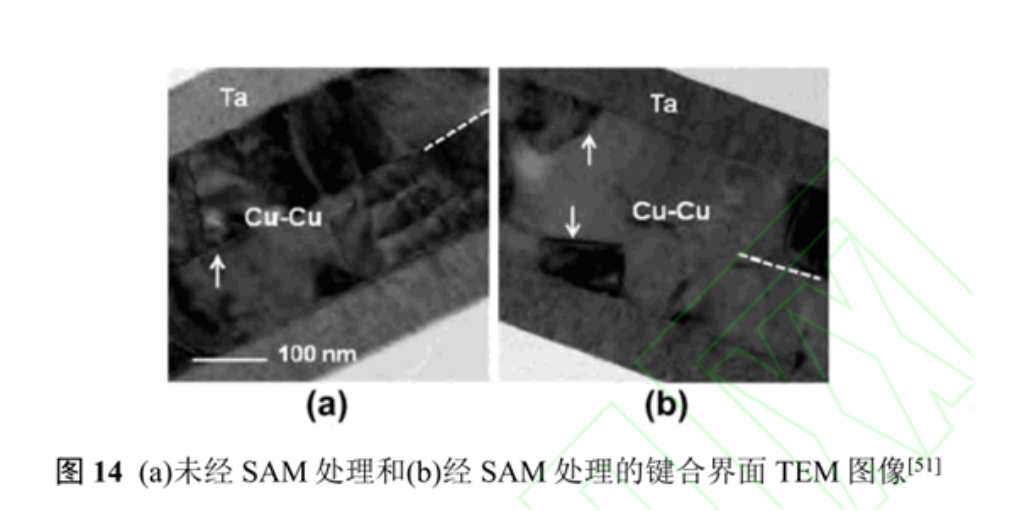
当SAM表面处理应用于电子封装当中时,除了能保护母材表面不受氧化和污染以及降低封装温度外,还能有效提高连接接头的电学性能。Peng等[57]使用未经SAM处理和经过SAM(六烷基硫醇)处理的Cu表面进行键合,未经SAM处理的接头接触电阻值约为3.53mΩ,而经过SAM处理后接头接触电阻平均值降低了7.1%,约为3.28mΩ。此外,Lim等[58]还采用SAM(六烷基硫醇)处理,在250℃低温、5500N键合压力条件下得到了Cu-Cu热压接头,接头密封空腔(横截面如图15)具有良好的气密性,泄漏率低于10-9atmcm3/s,与未经SAM处理的对照样品相比至少提高了29%,比MILSTD-883标准定义的5×10-8atmcm3/s小了一个数量级。
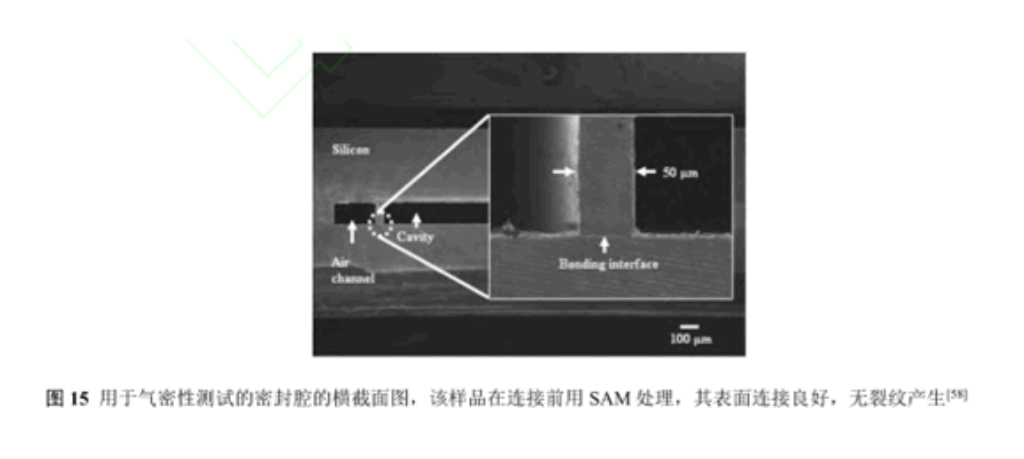
SAM表面处理工艺简单、容易操作、成本低廉,对后续工艺无不利影响,能够在较低温度下得到剪切强度较高的连接接头,但仍有待进一步深入研究,如单层膜链长选择,虽然已有研究表明烷烃硫醇(alkane-thiol)的链长越长,防氧化作用越明显,但同时也会导致完全去除烷烃硫醇(alkane-thiol)的退火温度升高。SAM技术有望在未来为3D封装提供高质量的低温键合接头,也有望在硅微电子技术中得到更为广泛的应用。
2.2低温焊接材料的研究
(1)低温焊料的研究
传统的Sn-Pb焊料具有成本低、熔点低、湿润性好等优点,能满足各类电子产品的使用,但Sn-Pb焊料中Pb属于有毒重金属,会对人体和环境造成极大危害。早在2006年,欧盟就颁布了ROHS禁令,规范电子电气产品的材料及工艺标准,使之更加有利于人体健康及环境保护,其中重点规定了Pb的含量不能超过0.1%[59]。随着人们环保意识的增强,以SAC305为主的Sn-Ag-Cu焊料因具有良好的抗蠕变性能和抗跌落性能,且环境性表现优异,逐渐代替Sn-Pb焊料成为市场的主流,但Sn-Ag-Cu焊料熔点较高,且在连接过程中容易生成脆性的Ag3Sn,降低接头可靠性;还有研究者熔炼并研究了Sn-4.0Bi-3.7Ag-0.9Zn焊料[60],该焊料具有较高的显微硬度和抗拉强度,但也存在熔点(202℃)较高的问题,难以符合电子封装向低温化发展的趋势。故寻找一种低熔点、高可靠性、环境友好型的低温焊料目前已成为电子封装行业亟待解决的问题(典型无铅焊料见表2[59])。
与Sn-Pb(183℃)和SAC305(220℃)焊料相比,Sn-Bi和Sn-In焊料的共晶点分别为138℃和118℃,是低温电子封装技术的理想焊料。然而,Sn-Bi合金太脆而Sn-In合金太软,均具有一定局限性,研究者们进行了大量的研究,在这两种焊料当中添加了其他元素,以改善其性能。其中,Cr作为一种过渡金属元素,成本低廉,对改善合金性能非常有效,通过向焊料中添加Cr,能使合金具有更细的组织、更好的抗氧化性和塑性,还能有效改善焊料基体组织不均匀、老化过程中界面层生长等问题[61]。Zhu等[62]将Cr掺杂到Sn-Bi焊料中形成3种不同的焊料(SnBi-0.1Cr、SnBi-0.2Cr、SnBi-0.3Cr),在200℃的低温下经过120s的连接时间发现,Cr的掺入不仅提高了焊点的机械性能,还细化了焊料组织(图16);SnBi-0.1Cr、SnBi-0.2Cr和SnBi-0.3Cr焊点的延伸率相对于Sn-Bi焊点分别提高了3%、56%和53%,焊料的断裂方式由脆性断裂向韧性断裂转变,焊点中Cu6Sn5IMC层厚度逐渐减小且形貌由细长的扇贝状转变为连续粗糙的扇贝状,裂纹路径由部分IMC层向全部IMC层转变。此外,Sebo等[63]通过向Sn-Bi焊料中加入Ag发现,随着Ag含量的增加,Sn-Bi焊料的力学性能先升高后降低,当Ag含量较低时,焊料中形成颗粒状或针状的Ag3Sn化合物,当Ag含量超过1wt.%时Ag3Sn开始偏析成片状或块状。Jiang等[64]向Sn-Bi焊料中掺杂Ti,多次回流后Sn-58Bi-0.1Ti焊料的剪切强度高于Sn-58Bi焊料。Liu等[65]通过向Sn-Bi焊料中分别加入每英寸110目和500目的多孔Cu片来提高其性能,并在180℃的低温下将焊料片连接到Cu基板上,测试表明多孔Cu片的加入有助于焊料中富Bi相和β-Sn相的细化,从而提高焊点硬度(图17)。Xiong等通过向Sn-Bi焊料中添加CuZnAl颗粒来减少瞬时液相连接过程中Cu/Sn58Bi/Cu焊点孔洞的形成,发现随着CuZnAl颗粒的加入,Cu原子的扩散通量降低,界面IMC生长受到抑制,焊点孔洞显著减少。

除了向低温焊料中掺杂一种或多种金属元素以及金属粒子外,还可以在焊料中加入纳米材料以改善其性能。Ma等[67]将石墨烯纳米片(GNSs)加入Sn-Bi焊料中,发现GNSs添加量为0.03wt.%时,焊料的显微组织和力学性能表现最佳,在100℃时效360h后SnBi-0.03GNSs的粗大组织和生长晶粒得到有效抑制,其抗拉强度和弹性模量较Sn-Bi焊料分别提高了15%和24%。Peng等[68]研究了纳米粒子对Sn-Bi焊点机械性能的影响,发现添加微量SiC纳米粒子能显著提高Sn-Bi/Cu焊点的力学性能,SiC纳米颗粒可以防止位错滑动,同时细化晶粒,还能降低裂纹源产生的概率,提高塑性。Ma等[69]将碳纳米管(CNTs)和石墨烯纳米片(GNSs)加入Sn-Bi焊料后,发现它们可以连接两个富Bi相晶粒或直接嵌入富Bi相中,起到了很好的钉扎和缓冲作用,能减少应力集中导致的断裂,改善了焊点的机械性能。Yang等[70]报道了涂有Ni的碳纳米管(Ni-CNTs)对Sn-Bi焊料性能的影响,发现当Ni-CNTs添加量为0.05wt.%时焊料的晶粒最细,焊点的抗拉强度达到最大值,而后随着Ni-CNTs含量的增加其焊点的抗拉强度下降(图18)。

目前低温焊料的研究主要集中于Sn-Bi系,关于Sn-In系焊料的研究报道很少。随着便携式、可折叠的柔性电子产品逐渐普及,对低温封装技术的要求越来越高,低温焊料将会成为未来电子封装行业的主流。低温焊料的研究与开发、电子封装低温互连、优异的高温性能、极端多变场的可靠性是行业永恒不变的主题。
(2)纳米焊料的研究
对通过选用连接材料来降低封装温度而言,使用低温焊料可以满足上述需求,但低温焊料较低的机械强度使其无法完全满足“低温封装,高温服役”这一行业新需求。随着材料科学的进步,特别是进入21世纪以来,纳米材料优秀的、独特的物化性质引起了电子封装行业的广泛关注。纳米材料是指三维空间尺度至少有一维处于纳米量级(1~100nm)的材料,它是由尺寸介于原子、分子和宏观体系之间的纳米粒子所组成的新一代材料。纳米材料具有许多特性,如体积效应、表面效应、量子尺寸效应等,由于这些效应,纳米材料有着与普通材料不同的物理或化学性质,比如当Ag颗粒尺寸达到纳米级别后,其熔点会显著降低至100℃左右,故可用低温烧结纳米Ag颗粒作为电子封装中材料的互连层,以满足在高温下持续服役的要求。
烧结纳米Ag互连层的制作工艺主要包括[71]:①在基板上涂覆或者丝网印刷纳米Ag焊膏,将芯片放置在纳米焊膏上;②进行预加热干燥,使焊膏中的有机物挥发,然后在高温下进行无压或压力辅助烧结,工艺参数有升温速率、烧结温度、烧结辅助压强、烧结时间和气体环境等;③烧结完成后形成在封装器件与基板之间的纳米Ag互连层。Dai等[72]采用烧结纳米Ag技术将Si二极管功率器件(2.5kV,50A)在250℃、10MPa、5min的烧结条件下封装于AlN衬底上,功率循环测试表明当选择有效热阻增加20%为失效标准时,烧结纳米Ag接头寿命是Pb-5Sn接头寿命的10倍。Hutter等[73]在230℃、30MPa、3min的烧结条件下将Si基功率芯片封装于Cu基板上,经30~180℃的温度循环测试发现烧结纳米Ag接头的可靠性是Sn-Ag焊料接头的10倍。选用烧结纳米Ag颗粒作为焊料时,压力的施加可以使烧结后的纳米Ag颗粒致密度更高,使烧结材料与母材的连接更为紧密,但过大的烧结压力会对器件造成一定程度的损伤,影响其可靠性[74]。针对这一问题,吴炜祯等[75]采用无压烧结纳米Ag颗粒的方法,在10℃/min升温速率、250℃下制备了尺寸大小不同的焊点,焊点的剪切强度随保温时间的延长而提高,随焊点面积增大而降低;当保温时间达到30min以上、焊点尺寸小于3mm×3mm时,其剪切强度高于70MPa,当焊点尺寸为10mm×10mm时仍有20MPa以上的剪切强度。
常见的纳米焊料除了纳米Ag外,对于纳米Cu的相关报道也有许多。Yoichi等[76]在室温条件下,用水合肼还原乙酸铜(II)络合物的水溶液,成功获得平均粒径为50~60nm的纳米Cu颗粒(NPs),利用金属掩膜及丝网印刷将纳米Cu颗粒涂覆到玻璃基板上,并在200℃N2气氛下无压烧结30分钟,测得烧结纳米Cu电阻率为16μΩ·cm,与以往研究相比该烧结温度下Cu电阻率非常低,Cu-Cu接头剪切强度高达39MPa(TEM图像见图19)。由于纳米Cu极容易氧化生成Cu2O或CuO,尽管氧化物能使烧结接头更为致密进而提高接头的剪切强度[77],但对接头的导电率却是不利的。为了解决上述问题,Yu等[78]提出了一种激光烧结工艺,将纳米Cu颗粒(100~120nm)涂覆在玻璃基板上并用激光进行烧结,烧结得到的样品电阻率最低为5.3μΩ·cm,远低于200℃热压烧结得到的样品电阻率(122μΩ·cm)。此外,王春青等[79,80]还提出了一种使用Cu6Sn5纳米颗粒作为焊料,在200℃低温、5MPa压强下烧结20min得到了界面均匀、无孔隙的Cu-Cu接头。Cu6Sn5具有熔点高达415℃、与Cu基板的热膨胀系数几乎相同、导电导热性良好、抗剪切强度高等特点[81],脆性的Cu6Sn5通过纳米化的途径可以转化为非脆性、超塑性和耐高温的焊料,这种方法有望广泛应用于其他IMC,如Cu-Sn、Ni-Sn、Ag-Sn、Zn-Sn、Cu-Al等。
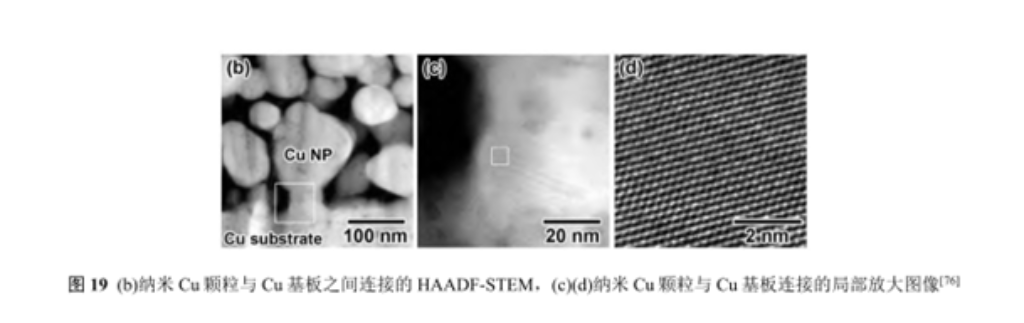
选用纳米材料作为连接材料时,可以降低封装温度并提高连接性能,此外还可以用金属膜、有机盐等包裹纳米颗粒,使颗粒表面改性形成纳米复合焊料。李明雨等[82,83]将纳米颗粒包裹上金属膜并与有机溶剂混合形成焊膏,其中一种使用Sn膜包裹纳米Ag颗粒[84],并与α-松油醇溶剂混合,在0.5MPa压强、260℃下烧结20min得到了Cu-Cu接头,其剪切强度为35.3MPa,电阻率为9.5μΩ·cm,接头性能优于未使用Sn膜包裹的烧结纳米Ag颗粒Cu-Cu接头。何鹏等[85,86]使用柠檬酸盐包裹纳米Ag颗粒形成Ag浆,柠檬酸盐与Ag离子通过形成相关配合物(如[Ag2+citrate]或[Ag3(C6H5O7)n+1]3n−)来控制Ag颗粒成核和生长,柠檬酸盐的吸附作用还能防止颗粒的团聚,加之柠檬酸盐本身所具有的较低分解温度和缩聚作用为后续烧结提供了有利条件,在260℃、1MPa压强下烧结30min得到了剪切强度为28.2MPa的Cu-Cu键合接头。Ji等[87]采用Ag包裹的纳米Cu颗粒(Cu@AgNPs)作为焊料,在160℃超声辅助烧结下实现了Cu-Cu低温互连,180℃工作时该接头剪切强度高达54.27MPa,比同等温度下热压烧结所得到的接头剪切强度(3.91MPa)高了一个数量级,且随着烧结温度的升高,接头断口的韧窝尺寸越来越大,Cu@AgNPs逐渐形成块状组织,其中Ag为网格结构均匀地分散在Cu基体表面(图20)。Haque等[88]使用辛硫醇包裹纳米Cu颗粒并形成焊膏(10wt.%Cu),将焊膏涂覆在玻璃基板上进行烧结,还原性H2与纳米Cu颗粒表面的辛硫醇反应,促进了纳米Cu颗粒之间烧结颈的形成,从而使烧结致密度更高,H2环境下烧结得到的样品电阻率最低为5.8×10−6Ω·cm。
电子封装中选用纳米材料作为连接材料时,运用纳米材料的结构和物化特性,可在较低的温度下达到金属熔点或实现原子扩散和再结晶形成连接,使器件的封装温度和性能得到大幅改进。但该类技术过分依赖纳米材料的制备,纳米材料的性质很大程度上决定了连接的可靠性,这也限制了该方法的推广,使其目前还处于不断研发改进中。
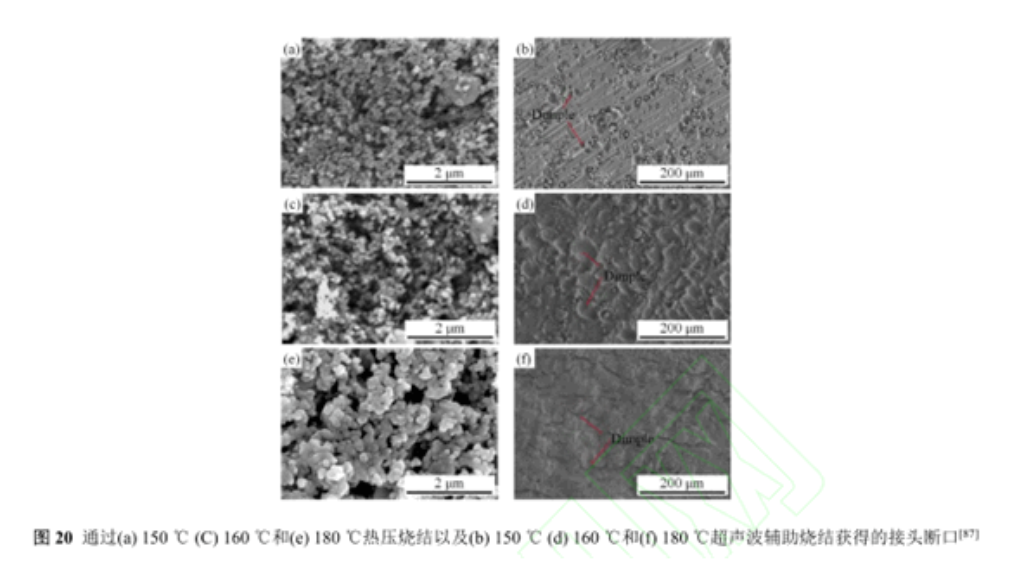
(3)混合焊料的研究
由于纳米材料优异的物化性能,使其广泛应用于电子封装领域。大量研究表明,纳米颗粒和微米颗粒混合可以同时弥补两种不同粒径焊料的不足之处,如纳米颗粒的加入可以使烧结接头更为致密,提高接头连接性能,而微米颗粒的加入可以减轻烧结时颗粒的团聚和裂纹的形成,因此以纳、微颗粒混合为主的混合焊料近年来也得到了广泛地研究[89]。梅云辉等[90,91]将纳米Ag颗粒(20~100nm)与微米Ag颗粒(1~5μm)以1.5:1的体积比例混合并加入机物制备成焊膏,在265℃低温无压烧结条件下,得到了平均剪切强度和瞬态热阻抗分别为53MPa和0.132℃/W的Ag-Cu接头,这与铜表面镀银得到的Ag-Cu接头数值(55MPa和0.118℃/W)相当。Dai等[92]将Cu纳米颗粒(40~60nm)与Cu微米颗粒(1~2μm)混合,加入17IPA(3-吲哚丙酸)并用匀质器处理成糊状浆料,与Cu微米颗粒焊料相比,混入了Cu纳米颗粒的混合焊料(混入比为1:3)烧结孔隙率降低了50%以上,且未观察到任何裂纹。甘贵生等[93]将15%Cu颗粒(500nm)、15%SAC0307颗粒(500nm)与70%Zn颗粒(45μm)混合形成混合焊料,在240℃低温、8MPa压强与超声辅助5s的情况下得到了平均剪切强度高达47.37MPa的Cu-Al接头,Cu颗粒的加入提高了主体焊料Zn颗粒的高温耐氧化性,SAC0307颗粒的加入降低了连接温度,同时使接头中Zn颗粒的连接更为紧密,对接头强度的提高有一定促进作用。Zuo等[94]将纳米Cu颗粒(100nm)与微米Cu颗粒(1µm)以9:1的质量比形成混合焊料,在250℃低温、4MPa压强下烧结5min得到了剪切强度超过20MPa的Cu-Cu接头。除了纳、微颗粒混合外,还可以在焊料中直接加入纳米材料[95],如Yakymovych等[96]向Sn-3.0Ag-0.5Cu焊料中添加纳米陶瓷颗粒(SiO2、TiO2和ZrO2),在250℃、300s下成功得到了焊料成分不同的Cu-Cu接头,纳米陶瓷颗粒的加入抑制了连接界面处Cu6Sn5的生长,改善了接头的微观结构。
除了纳、微颗粒混合形成混合焊料外,在瞬时液相连接(TLP)技术中,也常应用到混合焊料。瞬时液相连接(TLP)是在被连接母材中间加入低熔点的中间层,使中间层与部分母材表面反应,或在中间层中加入其它金属颗粒以及其它中间层形成混合焊料,在加热过程中中间层与母材部分熔化,通过重新凝固或扩散作用生成高熔点的金属间化合物或固溶体而形成连接的过程。一些研究表明在TLP键合过程引入Ag作为低熔点中间层材料,会在焊缝中形成固溶体。Shao等[97]应用TLP技术在280℃低温下得到了Ag-Sn接头,采用厚度为20μm的工业纯Sn箔作为焊料中间层,350℃时效120h后接头内的Ag3Sn晶粒或ζ相完全转变为Ag-Sn固溶体,接头剪切时发生韧性断裂;时效时间延长到240h后,Sn在Ag-Sn固溶体层中的分布更加均匀;时效延长到480h后(图21a),Cu衬底和Ag金属层之间的Ni缓冲层被完全消耗,Cu或Ni在初生Ni-Sn或Cu-SnIMC中表现出相当大的溶解性,Ni-SnIMC逐渐演变为Cu-Ni-SnIMC,大量(Cu,Ni)3Sn颗粒在接头边缘区域的Ag-Sn固溶体层内沉淀,并产生连续的Sn固溶体层内裂纹(图21);时效1000h后,接头没有发生严重的断裂,仍然具有约40MPa的高剪切强度。还有文献报道[98]在Cu/Sn/Cu互连结构中引入低熔点的Ag,在300℃和0.3MPa压强下保温420min制备了由Cu3Sn+Ag3Sn+Ag4Sn组成的TLP接头;350℃老化24h后,Ag3Sn完全转变为Ag-Sn固溶体,Cu-SnIMC层由Cu3Sn+Cu41Sn11组成;时效480h后,Cu3Sn+Cu→Cu41Sn11的转变结束,当时效时间增加到960h后Cu-Sn固溶体在许多区域与Ag-Sn固溶体密切接触(图22),在时效近1000h后,接头仍然保持较高的剪切强度(>40MPa),表明接头具有良好的热可靠性。
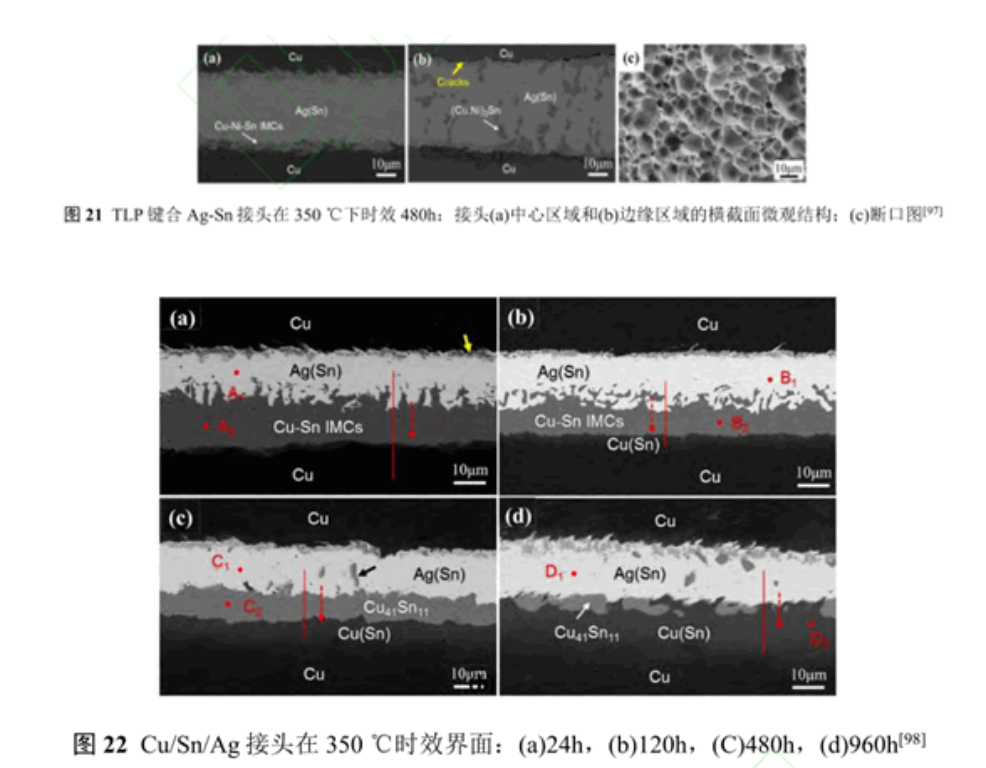
在TLP键合过程中,焊缝中除了形成固溶体能强化接头性能外,当其中一组元的含量超过其在另一组元中的溶解度时,就会有中间相析出而形成金属间化合物(IMC)。虽然焊缝中形成固溶体或金属间化合物都能强化接头,但固溶体的强度、硬度、熔化温度(和服役温度正相关)比金属间化合物略低,故国内外对金属间化合物接头进行了广泛的研究。按照IMC在焊缝中的含量,可以将TLP接头分为部分IMC接头和全IMC接头。Tatsumi等[99]将SAC305颗粒(3μm)和Cu颗粒(10μm)以1:3的比例与有机物混合制备成低熔点的中间层,在250℃无压情况将Kovar芯片(Ni-Co-Fe合金)与Cu基板直接连接,在200℃热时效1000h后接头的剪切强度保持在19MPa以上,最终焊缝由Cu颗粒、Cu6Sn5和Cu3SnIMC组成。Mo等[100]采用TLP技术在200℃低温下制备了Cu-SnIMC接头,随着样品在最高温度时保持时间的增加,IMC接头的显微组织逐渐由Cu6Sn5相转变为Cu3Sn相,并最终形成Cu3Sn全IMC接头。Brincker等[101]在Cu\Cu间加入低熔点的Sn,255℃下TLP键合10min时形成Sn+Cu3Sn+Cu6Sn5部分IMC接头,60min以上时形成Cu3Sn+Cu6Sn5的全IMC接头,接头剪切强度平均值在90~95MPa之间,且结合时间越长接头强度越高。邵华凯等[102]采用尺寸分别为10mm和6mm,高度为5.5mm的纯Cu柱作为基板,并分别在待连接面电镀4μmSn层作为低熔点的中间层,将Cu/Sn(8μm)/Cu结构在300℃和0.1MPa压强下进行低温瞬时液相连接(LTTLP),接头剪切强度随着连接时间的增加先增加后保持不变,接头依次由Sn型接头(Cu/Cu3Sn/Cu6Sn5/Sn)向Cu6Sn5型(Cu/Cu3Sn/Cu6Sn5)再向Cu3Sn型(Cu/Cu3Sn)转变。
直接形成全IMC接头的研究也有很多,如董红杰等[103]采用厚度40μm的纯Sn焊料作为低熔点的中间层,在Ni和Cu基板间实现了低温瞬时液相连接,延长等温反应时间获得了完全由(Cu,Ni)6Sn5和Cu3Sn两种IMC组成的焊接接头,在Ni-CuTLP接头的Sn/Ni和Sn/Cu界面处均形成了(Cu,Ni)6Sn5,从Ni侧到Cu侧化合物形貌依次是小颗粒状、针状和扇贝状,接头具有418.4℃的重熔温度和49.8MPa的平均剪切强度,能够满足高温功率器件封装中对耐高温互连的需求。Liu等[104]研究了超声辅助TLP连接快速形成Cu-Sn全IMC接头,焊料夹层由厚度为20mm的低熔点单一纯Sn箔制成,与传统TLP连接工艺形成的IMC接头相比,该接头Cu6Sn5晶粒明显细化,平均尺寸为3.5mm,弹性模量和硬度分别约为123GPa和6GPa,剪切强度高达60.1MPa。Sun等[105]将具有微孔的Cu片(厚1mm)浸渍到液态Sn中制备成混合焊料从而作为低熔点的中间层,在300℃和0.6MPa压强条件下,Cu/Cu3Sn/Cu全IMC接头平均剪切强度高达155MPa。Hwang等[106]采用TLP技术使用SAC305+10wt.%Ag颗粒作为低熔点中间层,在300℃低温无压条件下保温2h制备了无孔洞的Cu/Cu6Sn5/Cu3Sn/Ag3Sn/Cu全IMC接头,其接头剪切强度是SAC305接头的2.5倍,两种接头的形成如图23所示。Liu等[107]采用含有微晶Cu颗粒(6.2μm)的Sn涂层(50μm)作为低熔点中间层,在300℃低温无压条件下获得了Cu/Cu3Sn/Cu全IMC接头,未老化接头的剪切强度为24.2MPa,高于传统Pb-5Sn焊料接头的剪切强度。
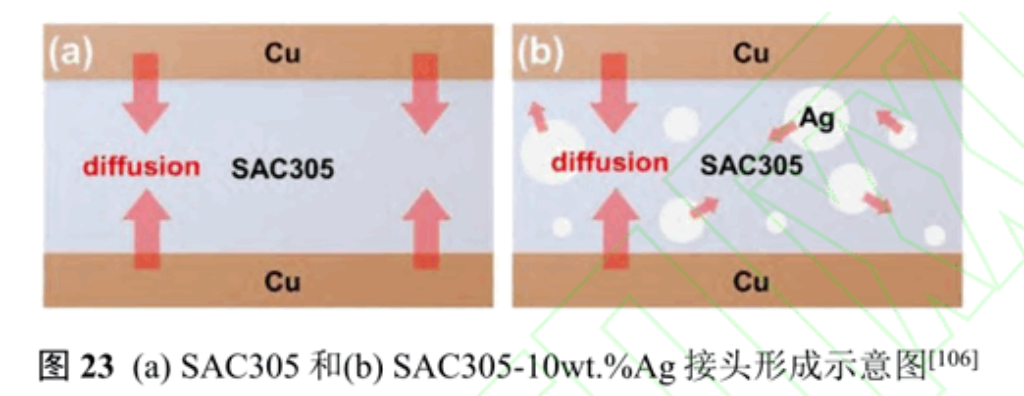
随着半导体技术的发展,第三代半导体可以实现电子器件在200℃以上稳定工作。当服役温度高于200℃时,绝大多数合金焊点的抗疲劳性能和抗蠕变性能均无法满足宽禁带半导体器件的封装可靠性要求,故急需发展新型的耐高温连接技术和材料;瞬时液相连接能使低熔点中间层熔化并与高熔点母材形成连接,很好地契合了第三代半导体材料的封装需求,因此广受行业关注。瞬时液相连接是介于钎焊与固相扩散焊之间的一种连接方法,其原理是在待焊母材中间加入中间层,利用中间层熔化、中间层体系间或中间层与母材之间发生共晶反应形成的液相填充间隙,通过液相组元向固态母材中的扩散实现等温凝固和成分均匀化。TLP技术的中间层材料必须具有较低的熔点,常用的低熔点材料有Sn、Bi以及In等元素,能与这些元素形成高熔点金属间化合物的有Cu、Ni、Ag以及Au等元素。所以,TLP技术可以实现材料的低温连接和高温应用,是封装宽禁带半导体器件的可行技术,且该技术连接得到的接头性能优异,而且适合连接特殊材料,如单晶材料、先进陶瓷、金属基复合材料等。但该技术也有存在一些明显的缺点,如连接半导体器件需先在母材表面镀覆金属,增加了成本和工序;连接时保温时间较长,而且连接完成后往往还需要退火处理;虽然耐高温能力相比传统焊料合金有明显提高,但是脆性的金属间化合物的高温可靠性仍存在隐患;工艺控制方法略微复杂,需要避免反应不充分或者过反应;低熔点的中间层材料的选择较少,导致混合焊料种类单一,所以应用也受到了较大限制。
免责申明:本文内容作者:黄天 甘贵生 刘聪 马鹏 江兆琪 许乾柱 陈仕琦 程大勇 吴懿平(重庆理工大学 金龙精密铜管集团股份有限公司 华中科技大学)。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
先艺电子、XianYi、先艺、金锡焊片、Au80Sn20焊片、Solder Preform、芯片封装焊片供应商、芯片封装焊片生产厂家、光伏焊带、银基钎料、助焊膏、高温助焊剂、高温焊锡膏、flux paste、陶瓷绝缘子封装、气密性封装、激光器巴条封装、热沉、heatsink、IGBT大功率器件封装、光电子器件封装、MEMS器件封装、预成型锡片、纳米银、纳米银膏、AMB载板、微纳连接技术、AuSn Alloy、TO-CAN封装、低温焊锡膏、喷印锡膏、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、silver sinter paste、Ceramic submount、预涂助焊剂焊片、气密封装焊料、气密性封焊、金锡热沉、金锡衬底、金锡焊料封装、芯片到玻璃基板贴片 (COG)、铟焊料封装、共晶焊、金锡烧结、金锡共晶烧结、共晶键合、金锡薄膜、金锡合金薄膜、合金焊料、金锡焊料、Au50Cu50焊片、Au焊片、Au88Ge12焊片、Au99Sb1焊片、Sn焊片、激光巴条金锡共晶焊、激光巴条焊接材料、背金锡、金锡盖板、金锡壳体、预置金锡壳体、预置金锡盖板、预涂焊料盖板、贴膜包装焊片、覆膜预成形焊片、金锡薄膜热沉、钨铜金锡热沉、SMT用预成形焊片、载带式预成形焊片、锡银焊料片、锡锑焊料片、中高温焊片、异形焊料片、IGBT焊料片、焊锡片、预成型锡片、金锡焊膏、纳米银锡膏、微组装焊料、金锡凸点、金锡bump、激光巴条共晶、Au80Sn20、AuSn Solder、晶振金锡封盖、电镀金锡、flux coating solder、共晶贴片、铟铅焊片、铟铅合金、锡铋焊片、锡铋焊料、金锡薄膜电路、ALN热沉、氮化铝热沉、碳化硅金锡热沉、SiC金锡热沉、金刚石热沉、硅基热沉、CMC热沉、CPC热沉
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








