技术 | 大面积烧结的进步提高了功率模块的性能
技术 | 大面积烧结的进步提高了功率模块的性能
文章来源于碳化硅芯观察 ,作者Sonu Daryanani
以碳化硅(SiC)或氮化镓(GaN)为代表的宽禁带半导体可在功率转换应用中实现更快的开关速度、更低的损耗和更高的功率密度。随着功率半导体效率的提高,碳化硅模组周围材料和组件关注度越来越高,因为需要这些产品配套来进一步增加系统性能,并确保WBG芯片能够充分发挥其潜力。特别是模组耐温性能的增加,例如当前需要将SiC模块的散热要求到175°C及以上,芯片连接、基板和散热器的机械和热性能要求正在不断提高。
传统的方法是使用锡焊将芯片连接到支撑基板上,例如直接黏合铜(DBC)和DBC到底板。在本文中,我们将突出一些银焊合作为锡焊替代品的优点。
焊料与烧结
基于锡 (Sn) 和铅 (Pb) 的焊料是最常见的芯片粘接材料。ROHS 合规性要求用银 (Ag) 和铜 (Cu) 替代铅。焊接过程中,焊料颗粒通常在 200°C – 250°C 范围内熔化,并润湿要接触的表面。
金属间相是在凝固的冷却阶段形成的。烧结是一种用低于熔点的粉末制造结构的方法。银烧结1于 1990 年首次推出,现在许多公司提供基于各种银颗粒配方的芯片粘接解决方案。烧结基于原子扩散,如图 1(a) 所示,在给定时间内结合使用热量和压力来促进向界面的扩散。与焊料不同,没有相变。
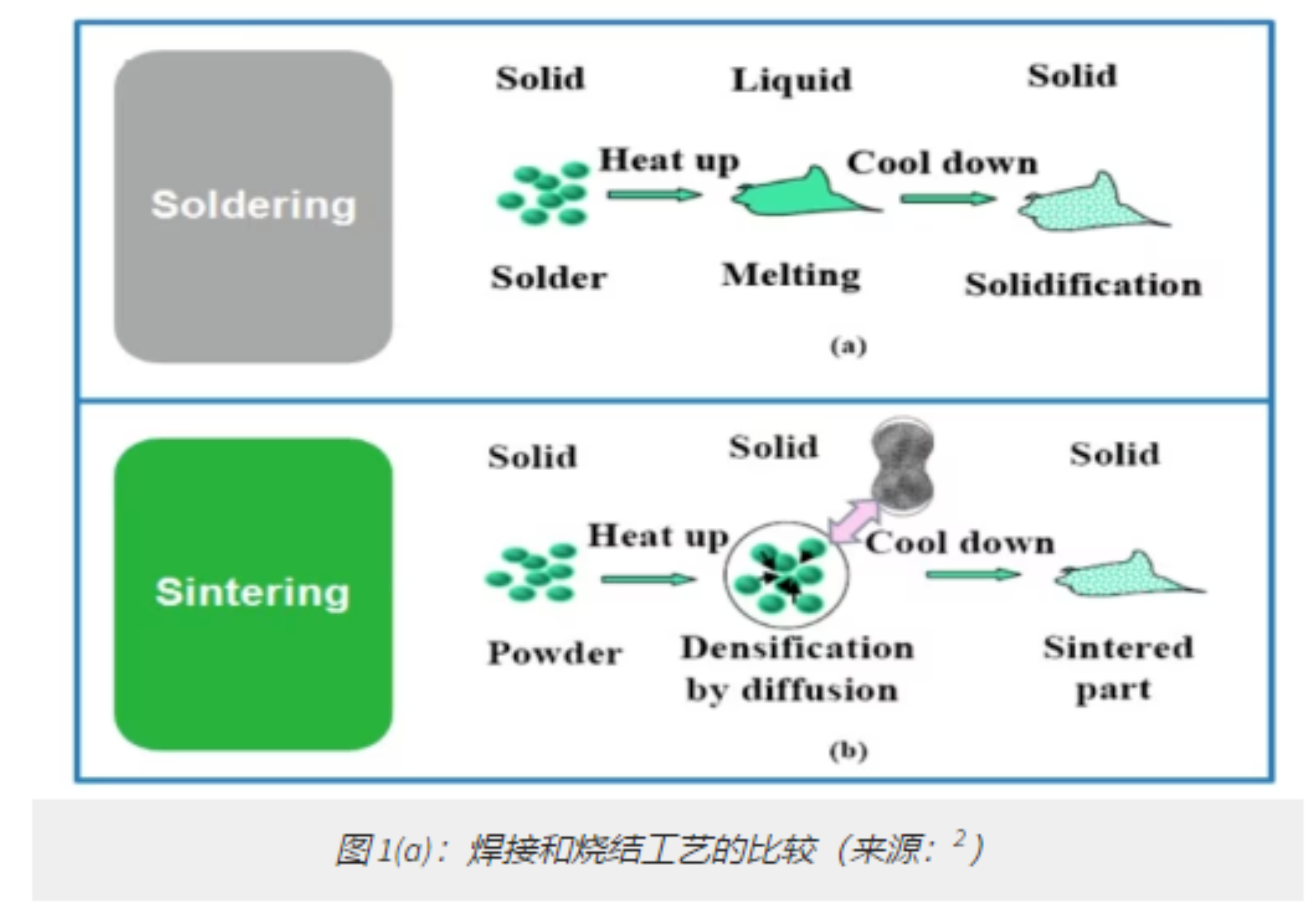
如图 1(b) 所示,与普通焊料配方相比,银烧结焊膏的导电性和导热性以及高温稳定性得到了很大改善。低热膨胀系数 (CTE) 和良好的拉伸强度使其在热循环和功率循环测试中具有优势。
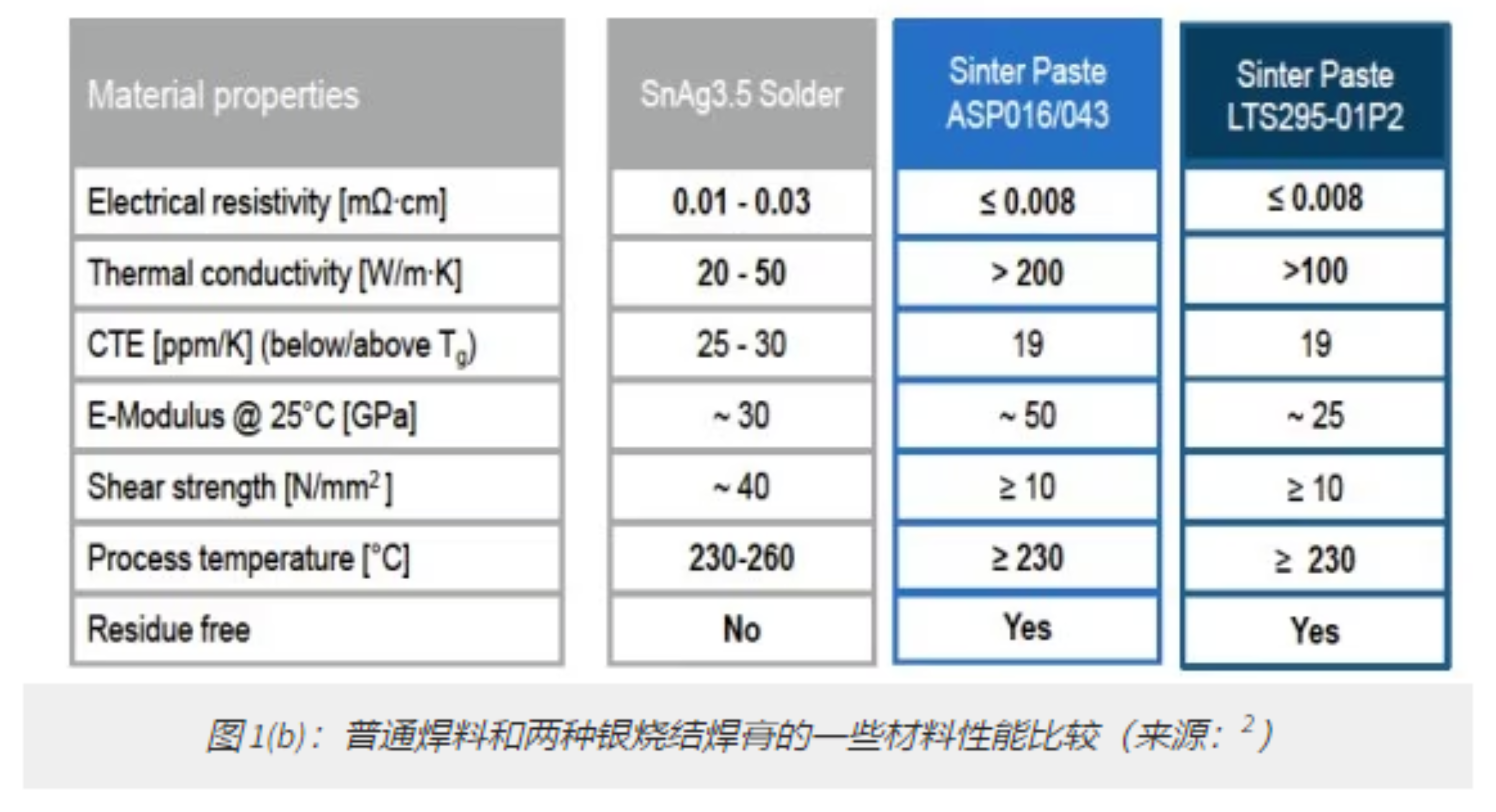
图 2 概述了烧结类型。压力辅助烧结对于 SiC 功率模块最为常见。随着烧结颗粒的尺寸从微米级减小到纳米级(即< 1μm),烧结温度和时间可以降低。纳米级压力可以在 5 至 15 MPa 范围内,温度从 200°C 至 300°C,时间从 1 至 10 分钟。

烧结浆料的应用通常通过干法放置的模板印刷来完成。
点胶技术相对较新,湿法放置使得该过程更容易出现错位。芯片转移薄膜 (DTF) 是芯片拾放后的流程,首先通过初始加热和加压步骤将薄膜转移到拾取的芯片上,然后将芯片 + 烧结薄膜放置在已拾取的芯片上。最后施加热量和压力。
许多团队使用银烧结焊料显着改善了芯片贴装工艺的温度循环 (TCT) 和功率循环寿命。图 3 显示了这样的一个示例。在 DBC 基板上进行的主动温度循环测试中,寿命增加了 17。
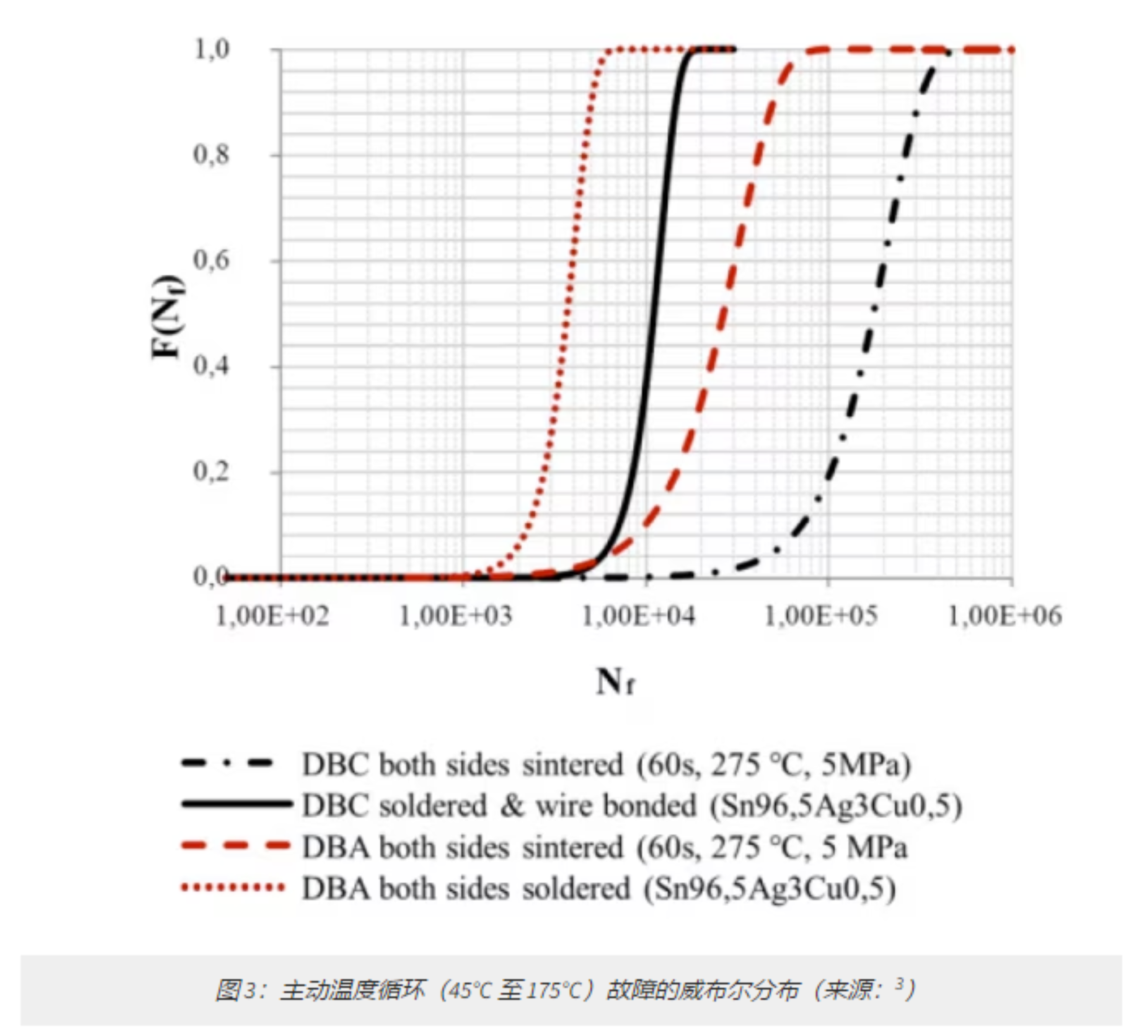
大面积银烧结
在最近举行的PCIM Europe 2023 会议上,Heraeus 产品经理 Florian Seifert 和压力烧结浆料项目负责人 Ulla Hauf 博士介绍了他们关于将银烧结浆料用于大面积烧结 (LAS) 应用的研究4。
如图 4 所示,功率模块组件中的烧结可用于:
· 芯片附着到基板上,例如 DCB/DBC 或活性金属钎焊 (AMB) 氮化硅。这些通常具有镍金 (Ni/Au) 表面处理。银迁移是一个问题,特别是对于高压烧结而言,需要仔细优化糊料和烧结条件以降低这种风险。
· 例如,在芯片顶部进行烧结可以使铜夹或金属柱取代传统的铝线接合。为了实现这一点,可以在芯片上放置金顶部金属表面处理。铜箔等后取放芯片顶部系统 (DTS)可实现重型铜线键合,与传统铝线相比,可提高热性能和可靠性能。
· 将基板固定到模块底板上。由于与裸芯片相比尺寸增加,这带来了新的挑战,尺寸范围可以从15×20 mm 2到>40×40 mm 2。此应用程序可归类为 LAS。
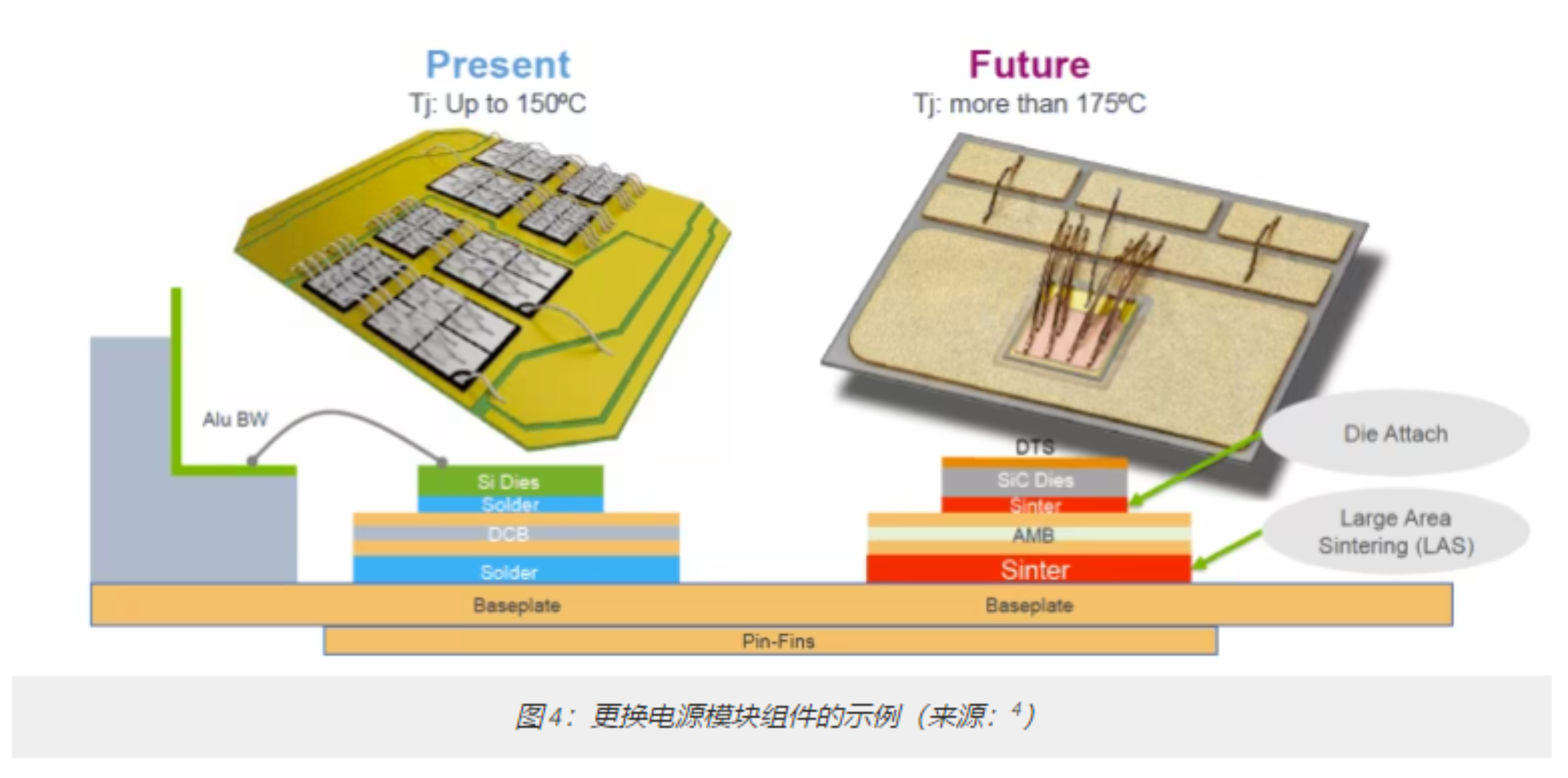
LAS 面临的一些具体挑战包括:
获得压力均匀的薄膜:更薄的烧结膜可以提高整体模块的导热率。虽然烧结在实现更薄的键合层厚度 (BLT) 方面比焊接具有特定优势,但该厚度需要随着模块尺寸的增加而增加,例如,从芯片贴装中使用的正常 <40-50 µm 增加到 >100-50 µm。150 微米。
高度差会使这变得更具挑战性,因为可能需要更高的压力,从而增加芯片/散热器机械完整性的风险。由于基板组件内的封装材料或焊点所施加的限制,干燥过程的操作窗口可能要小得多。温度、升温速率、总时间和气氛可能都需要优化。
烧结浆料本身的化学性质可能需要进行调整,以便在上面设置的操作窗口限制下更好地工作。
成本:Ag压力辅助烧结工艺成本较高,而热界面材料(TIM)具有成本优势。烧结和 TIM 的组合有时可以在成本和性能之间提供良好的折衷。
来自 Heraeus 的 LAS 流程如图 5 所示。

LAS 结果
图 6 所示的剪切强度测试结果证明了 Ag LAS 流的成功优化。与标准芯片贴装银烧结浆料相比,LAS 浆料在测试的尺寸范围内提高了 40% 以上的剪切强度。

如图 7 所示,在 1000 mm 2基材上循环 1,500 次后未观察到 LAS 料分层。
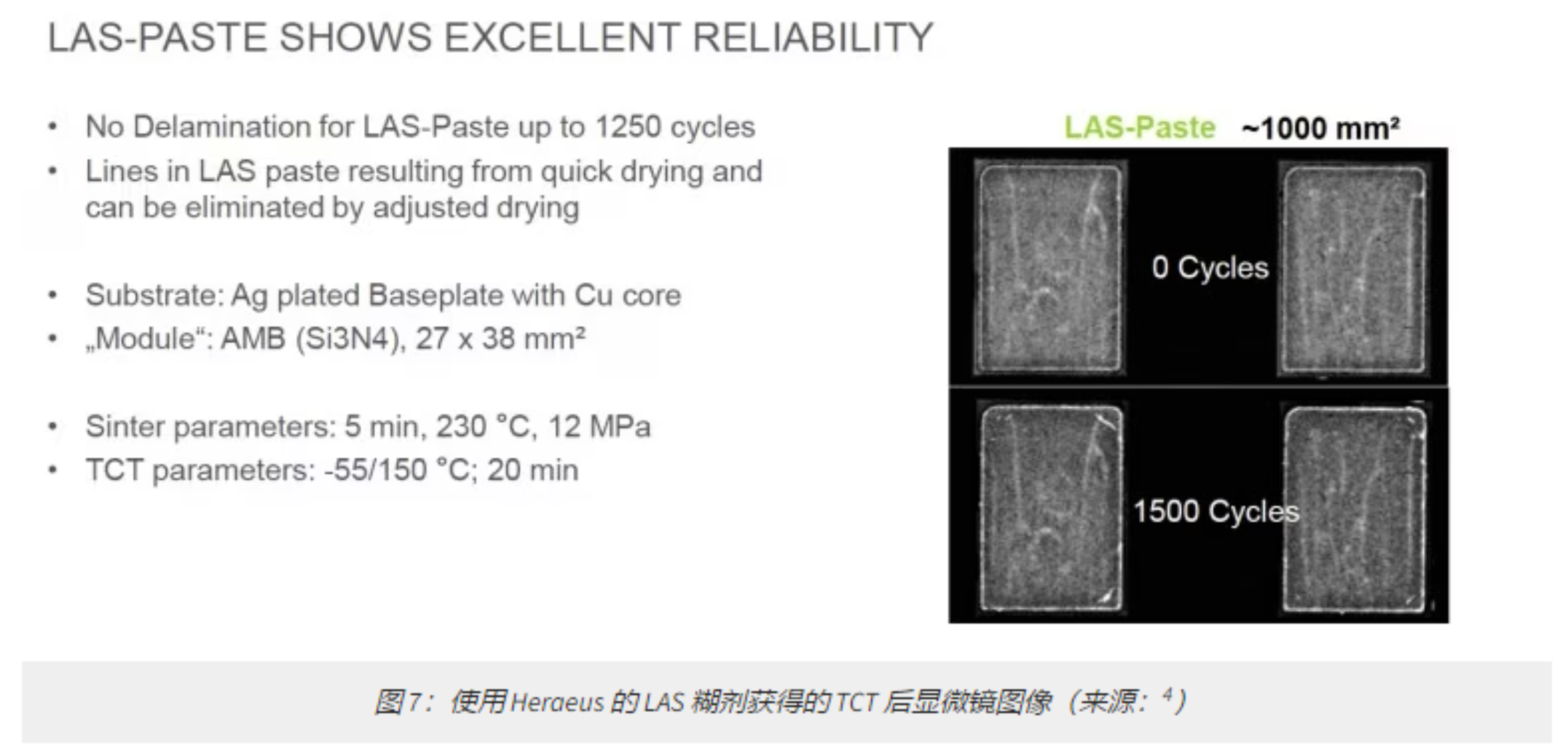
未来展望
电动汽车市场预计将强劲增长,而基于碳化硅的功率模块将在其中发挥关键作用,例如牵引逆变器应用。与焊料相比,银烧结在性能和可靠性方面具有多种优势。铜烧结预计将在未来的应用中发挥更大的作用,与银相比,其耐热性、抗迁移性和潜在成本优势得到改善。到 2030 年,LAS 目标市场预计将达到1.7亿美金。
参考:
1 H. Schwarzbauer、R. Kuhnert,“提高功率器件性能的新型大面积连接技术”,IEEE 工业应用汇刊,1991 年。
2 A.Miric、P. Dietrich,“电力电子应用的无机基材”。
3 S. Kraft、A. Schletz、M. Mürz,“电力电子应用中 DBC 和 DBA 基板上银烧结的可靠性”,CIPS 2012。4 F. Seifert 和 U. Hauf,“用于大面积压力烧结的优化浆料”银烧结浆”,PCIM 2023。
免责申明:本文内容转自:碳化硅芯观察 ,作者Sonu Daryanani。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
先艺电子、XianYi、先艺、金锡焊片、Au80Sn20焊片、Solder Preform、芯片封装焊片供应商、芯片封装焊片生产厂家、光伏焊带、银基钎料、助焊膏、高温助焊剂、高温焊锡膏、flux paste、陶瓷绝缘子封装、气密性封装、激光器巴条封装、热沉、heatsink、IGBT大功率器件封装、光电子器件封装、MEMS器件封装、预成型锡片、纳米银、纳米银膏、微纳连接技术、AuSn Alloy、TO-CAN封装、低温焊锡膏、喷印锡膏、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、silver sinter paste、Ceramic submount、低温共晶焊料、低温合金预成形焊片、Eutectic Solder、低温钎焊片、金锡Au80Sn20焊料片、铟In合金焊料片、In97Ag3焊片、锡银铜SAC焊料片、锡锑Sn90Sb10焊料片、锡铅Sn63Pb37焊料片、金锡Au80Sn20预成形焊片、Au80Sn20 Solder Preform、大功率LED芯片封装焊片生产厂家、TO封帽封装焊片、In52Sn48、铟银合金焊片、纯铟焊片供应商、铟In合金预成形焊片、锡银铜SAC305(Sn96.5Ag3.0Cu0.5)焊片、锡银铜预成形焊片焊箔供应商、锡锑焊片、Sn90Sb10 Solder Preforms、锡铅焊片、锡铅Sn63Pb37焊片供应商、锡铅Sn63Pb37焊片生产厂家、锡铅预成形焊片、金锡合金焊片选型指南、低温合金焊片应用、低温合金焊片如何选择、预成形焊片尺寸选择、xianyi electronic、半导体芯片封装焊片、光电成像器件的盖板密封焊接、无助焊剂焊片、圆环预成形焊片、方框预成形焊片、金属化光纤连接焊片、金基焊料、金锗焊料、金硅焊料、器件封装焊料、预涂助焊剂、带助焊剂焊片、金锡助焊剂、共晶助焊膏、预置焊片、金锡封装、箔状焊片、预制焊锡片、预镀金锡、预涂金锡
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








