AMB活性金属焊接陶瓷基板:陶瓷基板金属化的新范式
AMB活性金属焊接陶瓷基板:陶瓷基板金属化的新范式
转自:广州先进陶瓷展
陶瓷基板按照工艺分有很多种,除了直接键合铜(DBC)法、直接电镀铜(DPC)法、激光活化金属(LAM)法、低温共烧陶瓷(LTCC)、高温共烧陶瓷(HTCC)之外,还有目前备受关注的AMB法技术,即活性金属钎焊技术。AMB活性金属焊接陶瓷基板其实是DBC直接键合铜陶瓷基板技术的提升。
DBC与AMB工艺的区别
AMB活性焊铜工艺是DBC工艺技术的进一步发展,它是利用钎料中含有的少量活性元素与陶瓷反应生成能被液态钎料润湿的反应层,从而实现陶瓷与金属接合的一种方法。先将陶瓷表面印刷活性金属焊料而后与无氧铜装夹后在真空钎焊炉中高温焊接,覆接完毕基板采用类似于PCB板的湿法刻蚀工艺在表面制作电路,最后表面镀覆制备出性能可靠的产品。

AMB工艺流程
AMB基板是靠陶瓷与活性金属焊膏在高温下进行化学反应来实现结合,因此其结合强度更高,可靠性更好。但是由于该方法成本较高、合适的焊料较少、焊料对于焊接的可靠性影响较大。
AMB与DBC的区别的关键点在于AMB工艺中,陶瓷表面印刷了活性金属焊料,焊接界面强度高,可靠性更好。而DBC技术仅适用于氧化物陶瓷,例如氧化铝(Al2O3)和氧化锆掺杂氧化铝(也称为HPS)。非氧化物陶瓷必须先氧化,然后才能通过DBC技术与铜键合。氮化铝(AlN)可制成DBC或AMB基板,而氮化硅(Si3N4)仅能用作AMB基板。
AMB覆铜板三种材料
根据陶瓷材质的不同,目前成熟应用的AMB陶瓷基板可分为:氧化铝、氮化铝和氮化硅基板。
① AMB氧化铝基板
相对地,氧化铝板材来源广泛、成本最低,是性价比最高的AMB陶瓷基板,工艺最为成熟。但由于氧化铝陶瓷的热导率低、散热能力有限,AMB氧化铝基板多用于功率密度不高且对可靠性没有严格要求的领域。
② AMB氮化铝基板
AMB基板具有较高的散热能力,从而更适用于一些高功率、大电流的工作环境。但是由于机械强度相对较低,氮化铝AMB覆铜基板的高低温循环冲击寿命有限,从而限制了其应用范围。
AMB氮化铝基板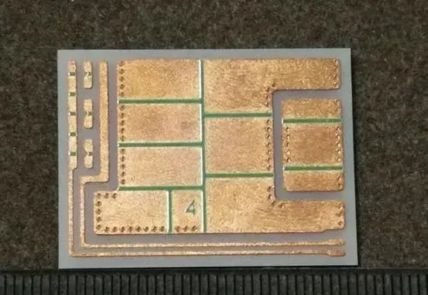
氮化铝AMB基板具有较高的散热能力,从而更适用于一些高功率、大电流的工作环境。但是由于机械强度相对较低,氮化铝AMB覆铜基板的高低温循环冲击寿命有限,从而限制了其应用范围。
③ AMB氮化硅基板
氮化硅陶瓷,具有α-Si3N4和β-Si3N4两种晶型,其中α相为非稳定相,在高温下易转化为稳定的β相。高导热氮化硅陶瓷内β相的含量一般大于40%。凭借氮化硅陶瓷的优异特性,AMB氮化硅基板有着耐高温、抗腐蚀和抗氧化和功率密度超高等优势:
● AMB氮化硅基板具有高热导率
AMB氮化硅基板具有较高的热导率(>90W/mK),厚铜层(达800μm)还具有较高热容量以及传热性。因此,对于对高可靠性、散热以及局部放电有要求的汽车、风力涡轮机、牵引系统和高压直流传动装置等来说,AMB氮化硅基板可谓其首选的基板材料。
AMB氮化硅基板
此外,活性金属钎焊技术,可将非常厚的铜金属(厚度可达0.8mm)焊接到相对较薄的氮化硅陶瓷上。因此,其载流能力较高,而且传热性也非常好。
● AMB氮化硅基板具有低热膨胀系数
氮化硅陶瓷的热膨胀系数(2.4ppm/K)较小,与硅芯片(4ppm/K)接近,具有良好的热匹配性。因此,AMB氮化硅基板,非常适用于裸芯片的可靠封装,封装后的组件不容易在产品的生命周期中失效。
AMB陶瓷基板的应用
与DBC陶瓷基板相比,AMB陶瓷基板具有更高的结合强度和冷热循环特性。目前,随着电力电子技术的高速发展,高铁上的大功率器件控制模块对IGBT模块封装的关键材料——陶瓷覆铜板形成巨大需求,尤其是AMB基板逐渐成为主流应用。

(图源:自京瓷官网)
日本京瓷采用活性金属焊接工艺制备出了氮化硅陶瓷覆铜基板,其耐温度循环(-40~125℃)达到5000次,可承载大于300A的电流,已用于电动汽车、航空航天等领域。该产品采用活性金属焊接工艺将多层无氧铜与氮化硅陶瓷键合,同时采用铜柱焊接实现垂直互联,对IGBT模块小型化、高可靠性等要求有较好的促进作用。
另外,在大功率电力半导体模块、高频开关、风力发电、新能源汽车、动力机车、航空航天等应用领域取得了进展。
AMB基板是靠陶瓷与活性金属焊膏在高温下进行化学反应来实现结合,因此其结合强度更高,可靠性更好。但是由于该方法成本较高、合适的焊料较少、焊料对于焊接的可靠性影响较大,只有少数美日中几家公司掌握了高可靠活性金属焊接技术。
各种陶瓷基板工艺和材料选择的依据
陶瓷是一种具有化学惰性的物质,并且耐腐蚀、耐湿气和耐高温,因此比在腐蚀性环境中会降解的有机电介质更受欢迎。在设计新基板时,电气、热力和机械性能同等重要。介电强度是满足隔热要求的重要影响因素,需要根据目标应用的标准、规范和规定进行设置。热导率太低不利于芯片与周围环境的热传导。当基板承受热机械应力时,其弯曲强度和断裂韧性对延长使用寿命有重要作用。
如果陶瓷基板在功率半导体器件中应用,首先要计算散热量。然后,根据芯片和环境温度,计算出所需的基板热阻。但是,铜和陶瓷的组合不一定都能达到所需的热阻。一方面,隔离电压决定了陶瓷的最小厚度。另一方面,铜与陶瓷的厚度比对可靠性有很大影响。最后,适用的标准组合将十分有限。
虽然陶瓷覆铜板工艺类型和基材都有多种组合,具体应用的时候,要结合电气,热力,机械性能,成本,可靠性,尺寸厚度综合来考虑。
免责申明:本文内容转自:广州先进陶瓷展,作者CAC2022。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10 Solder Preforms
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








