SiC功率模块封装材料的研究进展
SiC功率模块封装材料的研究进展
转自:半导体在线,来源:科技创新与应用,作者:程书博,张金利,张义政,吴亚光,王维(中国电子科技集团公司第十三研究所,石家庄050000)
摘要
随着SiC功率模块的高频高速、高压大电流、高温、高散热和高可靠发展趋势,基于封装结构和封装材料的SiC功率模块封装技术也在不断地更新换代。与封装结构相比,SiC功率模块封装材料的相关研究报道较少。该文从封装材料角度出发,综述近年来陶瓷覆铜基板、散热底板、黏结材料、互连材料及灌封材料的研究进展,同时引出相关封装材料的研究重点,以满足SiC功率模块的应用需求。
在新能源汽车、轨道交通、智能电网和航空航天等领域,功率模块正朝着高频高速、高压大电流、高温、高散热和高可靠的方向发展。与Si等第一代半导体材料相比,以SiC为代表的第三代半导体材料具备更快的电子饱和漂移速度、更高的击穿场强、更宽的禁带宽度、更高的热导率及更强的抗辐照等特性,可以满足功率模块的进一步发展需求。然而,新一代SiC功率模块由于封装技术的限制,尚未完全发挥出SiC半导体材料的优势。因此,SiC功率模块封装技术(封装结构和封装材料)的相关研究非常重要。事实上,近几年关于SiC功率模块封装结构的研究报道较多,而封装材料的相关报道则较少。本文从封装材料角度出发,同时结合功率模块的发展需求,对国内外SiC功率模块封装材料的研究进展进行综述。
1SiC功率模块封装材料的分类与功能
针对功率模块的高频高速、高压大电流、高温、高散热和高可靠发展需求,SiC功率模块衍生出了许多先进封装结构。不过,封装结构的设计优化,还需要搭配合适的封装材料,才能充分发挥SiC半导体材料的性能优势,进而满足SiC功率模块的发展需求。在此以传统功率模块封装结构为例,将封装材料分为陶瓷覆铜基板、散热底板、黏结材料、互连材料和灌封材料5大类。如图1所示。
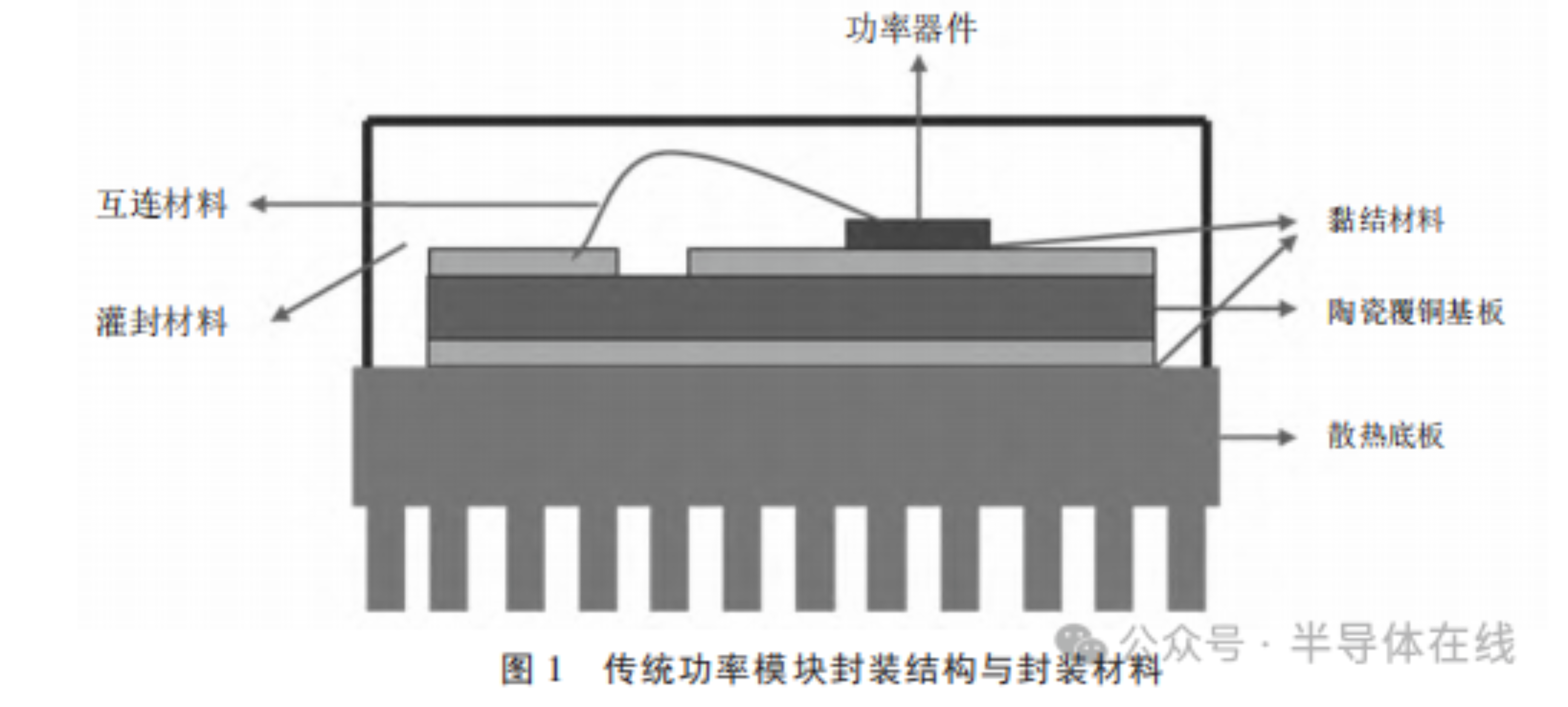
上述SiC功率模块封装材料的功能罗列如下:
①陶瓷覆铜基板是功率模块的载体,通过表面的图形化铜箔导体为功率器件提供电路连接,通过内部的陶瓷将表面导体电路与散热底板等金属材料隔离绝缘,另外,其还为功率器件提供了散热通道。因此,陶瓷覆铜基板需具备优异的机械性能、电性能及散热性能;
②散热底板一般与陶瓷覆铜基板相连接,以将其热量传递到外界环境或者冷却介质中。因此,散热底板应具备与陶瓷覆铜基板相匹配的热膨胀系数,且散热性能优异;
③功率器件底面与陶瓷覆铜基板之间、陶瓷覆铜基板与散热底板之间往往需要采用黏结材料将其连接为一体,以实现相应的机械、电或热连接等功能。因此,黏结材料应具备较强的抗蠕变和抗疲劳性能,合适的熔融温度、电导率和热膨胀系数,热导率高,且成本低、环境友好;
④功率器件顶部电极、导体电路、输入/输出端子之间一般采用互连材料形成电气连接,因此,互连材料需具备优异的导电性能,且抗疲劳性能优异;
⑤灌封材料一般为有机介质,通过灌封工艺填充在上述材料之间,以保护功率器件、互连材料等脆弱部件免受湿气或化学物质的侵蚀,并起到绝缘和散热作用。因此,灌封材料需具备优异的填充性能、耐蚀性能、绝缘性能及散热性能。
2SiC功率模块封装材料研究进展
2.1陶瓷覆铜基板研究进展
随着SiC功率模块的高可靠、大电流、高散热应用需求,陶瓷覆铜基板开始朝着高强度、高绝缘、高导热和覆厚铜(0.3mm以上)的方向发展。在陶瓷覆铜基板中,常用的陶瓷材料包括氧化铝、氮化铝、ZTA和氮化硅等。虽然氧化铝、氮化铝的绝缘性能好,尤其氮化铝还具备非常高的热导率,然而,这2种陶瓷的强度均较低(一般低于400MPa),不能覆接厚铜,无法满足SiC功率模块的高可靠和大电流发展趋势。ZTA和氮化硅的强度较高(一般高于600MPa),可以通过覆接厚铜承载更大的电流,还可以通过减薄陶瓷厚度来降低热阻,符合SiC功率模块的高可靠、大电流、高散热发展趋势。
在新能源汽车领域,ZTA覆铜板因成本低、可靠性高,目前在功率模块封装基板市场的占有率较高;氮化硅覆铜板因与SiC的热膨胀系数更匹配,而成为SiC功率模块的首选,在SiC功率模块封装基板的市场占有率逐年提升。事实上,这2种陶瓷覆铜基板的优异性能与陶瓷材料的本征特性密切相关。目前,ZTA和氮化硅陶瓷材料的相关研究主要集中在烧结工艺和助烧剂优化上。吴崇隽等采用流延成型和常压烧结工艺制备ZTA陶瓷,实验结果显示,ZTA陶瓷的机械性能随着ZrO2含量的提高呈现先增加后减小的趋势,当ZrO2含量为20%时,ZTA陶瓷的机械性能最佳,抗弯强度为865MPa,断裂韧性为5.7MPa·m1/2。Hu等采用2步气压烧结工艺来优化氮化硅陶瓷的性能:第一步在1525℃温度下烧结3h,促进氮化硅的α→β相转变和致密化;第二步在1850℃温度下烧结3h,抗弯强度达到801MPa,热导率达到79.42W/(m·K)。Liang等在氮化硅原粉中引入MgO和自制YB2C2(由Y2O3、B4C和C合成)助烧剂,并采用热压烧结工艺在1800℃/60MPa条件下烧结2h,氮化硅陶瓷强度达到1189.6±43.7MPa,断裂韧性达到9.46±0.14MPa·m1/2,热导率达到77W/(m·K)。
2.2散热底板研究进展
随着SiC功率模块的高温、高散热、高可靠应用需求,散热底板开始朝着高温适配、高导热、高强度的方向发展。在实际应用中,铜基散热底板材料由于热膨胀系数过大,在高温条件下很容易出现热应力失效等可靠性问题。而AlSiC散热底板材料不仅热膨胀系数可调,而且热导率大、强度高,符合SiC功率模块的高温、高散热、高可靠发展趋势。
目前AlSiC散热底板材料的相关研究主要集中在制备方法上,可分为两大类:原位合成法和外加法。其中,原位合成法是在制备过程中通过化学反应原位生成增强体,增强体细小均匀,且与基体相容性良好。外加法包括真空压力渗透法、熔融超高热等静压法、粉末冶金法和挤压铸造法等,可将增强体直接加入基体中,工艺相对简单可控,但增强体与基体之间的浸润性差,界面结合较弱。章呈[6]采用无压烧结和SPS烧结相结合的工艺,原位合成AlSiC材料(SiC含量20%),抗拉强度为172MPa,热导率约140W/(m·K)。王书唯等[7]采用干粉模压成型工艺制备碳化硅多孔预制坯,再通过真空压力渗铝法制备AlSiC材料,热导率为(176~206)W/(m·K),热膨胀系数为(8~9.5)/×10-6K,符合功率模块的应用需求。徐广等[8]采用熔融超高热等静压法,制得表面覆有铝金属的铝碳化硅材料,热导率达到220W/(m·K),热膨胀系数为(6.5~7.5)/×10-6K。
2.3黏结材料研究进展
随着SiC功率模块的高温、高可靠应用需求,黏结材料开始朝着耐高温、高界面强度的方向发展。此处的黏结材料主要用于功率器件底部与陶瓷覆铜基板的界面、陶瓷覆铜基板与散热底板的界面。随着无铅化的环保要求,Sn-Ag-Cu替代Pb-Sn被广泛应用于电子行业,然而,在功率模块应用时,Sn-Ag-Cu具有如下缺点:不耐高温(回流温度为220~260℃);不耐腐蚀,且容易产生锡须和金属间化合物,无法满足SiC功率模块的高温、高可靠发展趋势。针对上述问题,纳米金属黏结材料和瞬态液相黏结(TLP)材料应运而生。纳米金属黏结材料基于纳米材料的尺寸效应,可以实现低温黏结、高温服役的功能,最常见的是纳米银浆;瞬态液相黏结材料在高温加热时形成少量液相,可与母材形成黏结界面,包括Ag-Sn、Cu-Sn、Au-Sn、Au-In和Ag-In等。
目前,在功率模块中广泛应用的纳米银浆具备优异的机械、热和抗蠕变性能,但存在高成本、多孔洞、裸铜黏结困难等缺点。针对纳米银浆的高成本问题,Zuo等将20nm和100nm的纳米铜粉进行级配,制得低成本的纳米铜浆,在250℃/4MPa/20min条件下,黏结界面的剪切强度达到15MPa。针对纳米银浆的孔洞问题,Wei等在Ag-Sn微米级合金粉中加入有机添加剂,制得低孔洞Ag-Sn黏结材料,在300℃/20MPa/30min条件下,黏结界面的剪切强度达到32MPa,孔洞率低于4%;并且,经过2000h高温贮存后,黏结界面的剪切强度和孔洞率没有明显变化。针对纳米银浆裸铜黏结困难问题,Liu等先采用十八烷基硫醇(ODT)包覆DBC陶瓷覆铜基板,而后采用纳米银浆在大气环境下进行裸铜黏结,在280℃/2MPa/30min条件下,黏结界面的剪切强度达到12.72MPa。
2.4互连材料研究进展
随着SiC功率模块的高频高速、高可靠应用需求,互连材料开始朝着低寄生电感、抗电迁移、热膨胀系数匹配的方向发展。此处的互连材料指功率器件上表面电极与陶瓷覆铜基板或端子间的电互连。传统功率模块一般采用引线键合的方式进行互连,但引线键合因寄生电感大,容易出现开关损耗和电压突增现象,不符合SiC功率模块的高频高速发展趋势。事实上,互连材料本身对寄生电感的影响不大,但可以采用平面互连等新结构去减弱寄生电感的影响。Al是常用的功率模块互连材料,但容易因电迁移而产生空洞等缺陷,进而引发互连可靠性问题。与Al材料相比,Cu互连材料不仅电阻率低、熔点高、载流能力强,还具备较好的抗电迁移性能,符合SiC功率模块的高可靠发展需求。同时,Cu互连材料与新型平面互连结构相结合,可大大降低功率模块的寄生电感。除此之外,在一些双面散热封装结构中,功率器件的上表面电极还会通过垫块或垫片等与对面的覆铜板形成电互连。刘文[14]在双面散热功率模块中采用镀银Mo块,代替铝线将功率器件与覆铜板形成电气连接,这里的Mo块不仅与器件的热膨胀系数匹配,还因弹性模量较大、不易变形,能够有效地缓解应力。
2.5灌封材料研究进展
随着SiC功率模块的高压、高温、高可靠应用需求,灌封材料开始朝着耐高压、耐高温、高强度的方向发展。功率模块中常用的灌封材料是环氧树脂和有机硅材料,其中,环氧树脂存在耐热性差、脆性大、光照易黄变等问题,不符合SiC功率的高温和高可靠发展趋势。而有机硅凝胶具有高绝缘、耐高温、耐湿/光性,且杨氏模量小、热应力低的特性,非常适合SiC功率模块的高压、高温、高可靠应用需求。目前有机硅灌封材料主要从改性角度来提高材料的本征性能,比如主链改性、填料改性等。Zhang等在有机硅中引入B元素,使其与主链中的硅氧键共价结合,改善其热稳定性和机械性能,热分解温度达到675℃,抗拉强度达到4.65MPa。陈向荣等[16]在有机硅中引入硅烷偶联剂改性纳米氮化铝填料,经过250℃/500h老化实验后,未添加填料的均开裂,击穿场强由47.27kV/mm降至23.48kV/mm;添加量3%的均不开裂,击穿场强由43.61kV/mm提升到52.02kV/mm;王鑫等在有机硅中引入改性氢氧化钙粉体填料,改善了硅橡胶的机械性能,抗拉强度由6.83MPa提高到7.55MPa。
3结束语
基于SiC功率模块的高频高速、高压大电流、高温、高散热和高可靠应用需求,SiC功率模块封装材料也在不断地更新迭代:在陶瓷覆铜基板领域,ZTA覆铜板和氮化硅覆铜板通过助烧剂和烧结工艺优化,朝着高强度、高绝缘、高导热和覆厚铜的方向发展;在散热底板领域,铝碳化硅材料通过尝试不同制备方法,朝着高强度、高导热、热膨胀系数匹配的方向发展;在黏结材料领域,纳米铜浆和瞬时液相黏结材料可弥补纳米银浆的短板,朝着低成本、少孔洞、裸铜黏结的方向发展;在互连材料领域,Cu、Mo等互连材料与新的封装结构相结合,朝着低寄生电感、抗电迁移、热膨胀系数匹配的方向发展;在灌封材料领域,有机硅通过主链改性、填料改性等方式,朝着耐高压、耐高温、高强度的方向发展。随着封装材料的不断深入研究,SiC功率模块将逐步实现高性能、规模化应用。
免责申明:本文内容转自:半导体在线,来源:科技创新与应用,作者:程书博,张金利,张义政,吴亚光,王维(中国电子科技集团公司第十三研究所,石家庄050000)。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10SolderPreforms
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








