银烧结技术在功率模块封装中的应用
银烧结技术在功率模块封装中的应用
转自:集成电路在线
随着新一代IGBT芯片及功率密度的进一步提高,对功率电子模块及其封装工艺要求也越来越高,特别是芯片与基板的互连技术很大程度上决定了功率模块的寿命和可靠性。传统钎焊料熔点低、导热性差,难以满足高功率器件封装及其高温应用要求。此外随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,对封装的性能方面提出了更为严苛的要求。银烧结技术是一种新型的高可靠性连接技术,在功率模块封装中的应用受到越来越多的关注。
一、银烧结技术的优势特点
1.什么是银烧结技术
20世纪80年代末期,Scheuermann等研究了一种低温烧结技术,即通过银烧结银颗粒实现功率半导体器件与基板的互连方法。
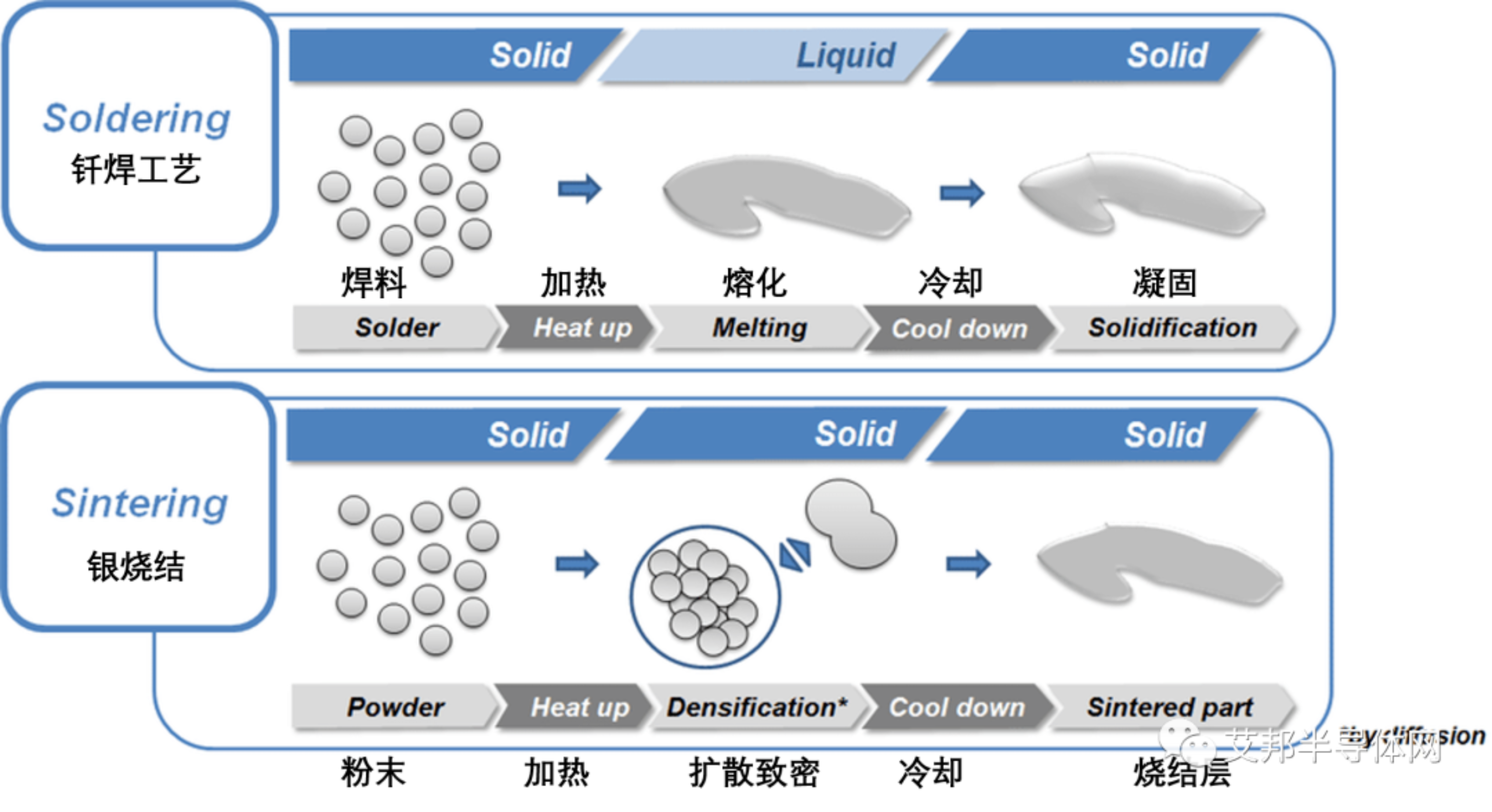
图 钎焊与银烧结对比
银烧结技术也被成为低温连接技术(Low temperature joining technique,LTJT),作为一种新型无铅化芯片互连技术,可在低温(<250℃)条件下获得耐高温(>700℃)和高导热率(~240 W/m·K)的烧结银芯片连接界面,具有以下几方面优势:
①烧结连接层成分为银,具有优异的导电和导热性能;②由于银的熔点高达(961℃),将不会产生熔点小于300℃的软钎焊连接层中出现的典型疲劳效应,具有极高的可靠性;③所用烧结材料具有和传统软钎焊料相近的烧结温度;④烧结材料不含铅,属于环境友好型材料。
表 互连材料性能对比

相对于焊料合金,银烧结技术可以更有效的提高大功率硅基IGBT模块的工作环境温度及使用寿命。目前,银烧结技术已受到高温功率电子领域的广泛关注,它特别适合作为高温SiC器件等宽禁带半导体功率模块的芯片互连界面材料。
2.银烧结技术原理
银烧结技术是一种对微米级及以下的银颗粒在300℃以下进行烧结,通过原子间的扩散从而实现良好连接的技术。所用的烧结材料的基本成分是银颗粒,根据状态不同,烧结材料一般为银浆(银膏)、银膜,对应的工艺也不同:
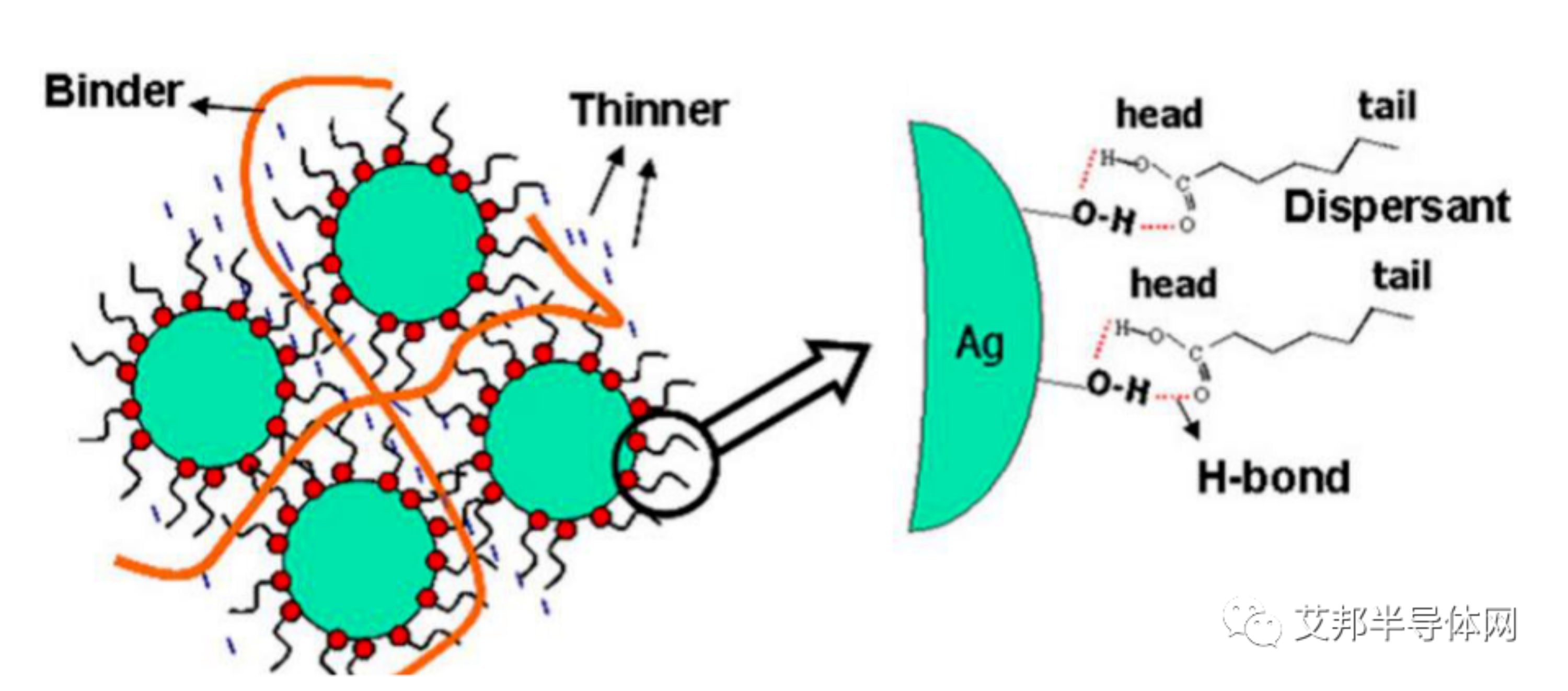
图 纳米银膏中分散剂、粘接剂和稀释剂的作用原理
银浆工艺流程:银浆印刷——预热烘烤——芯片贴片——加压烧结;
银膜工艺流程:芯片转印——芯片贴片——加压烧结。
芯片转印是指将芯片在银膜上压一下,利用芯片锐利的边缘,在银膜上切出一个相同面积的银膜并粘连到芯片背面。
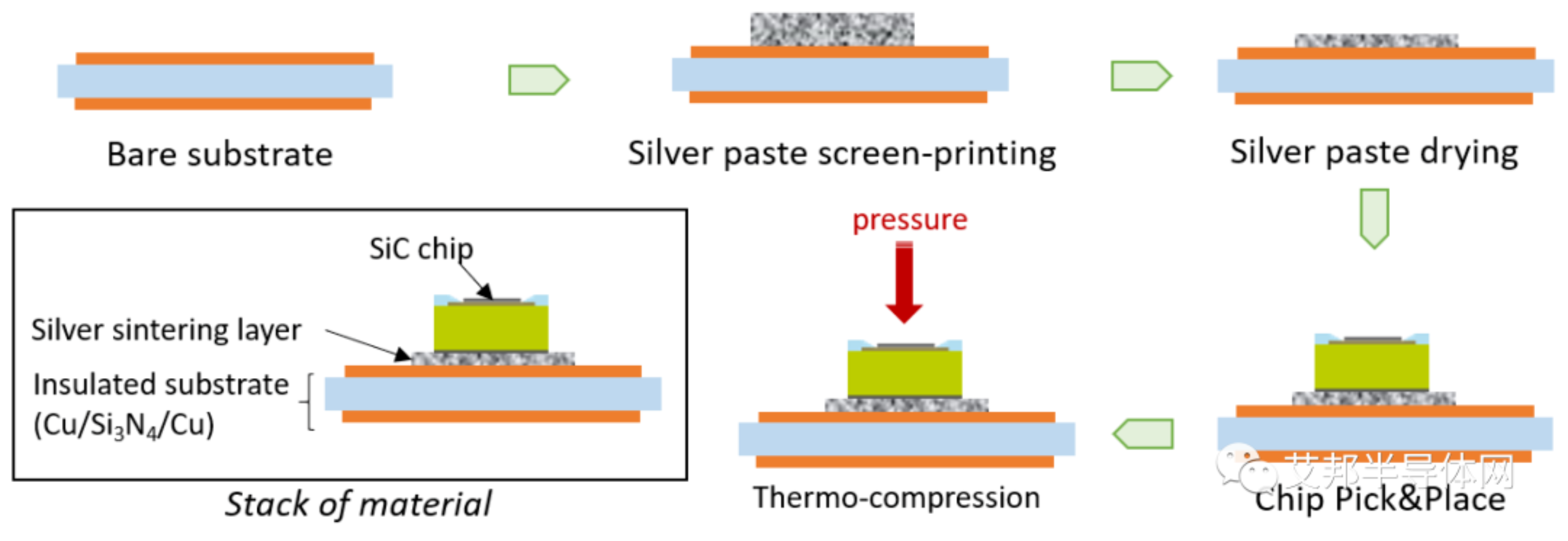
图 银烧结技术工艺流程
以纳米银浆为例,如下图所示,在烧结过程中,银颗粒通过接触形成烧结颈,银原子通过扩散迁移到烧结颈区域,从而烧结颈不断长大,相邻银颗粒之间的距离逐渐缩小,形成连续的孔隙网络,随着烧结过程的进行,孔洞逐渐变小,烧结密度和强度显著增加,在烧结最后阶段,多数孔洞被完全分割,小孔洞逐渐消失,大空洞逐渐变小,直到达到最终的致密度。
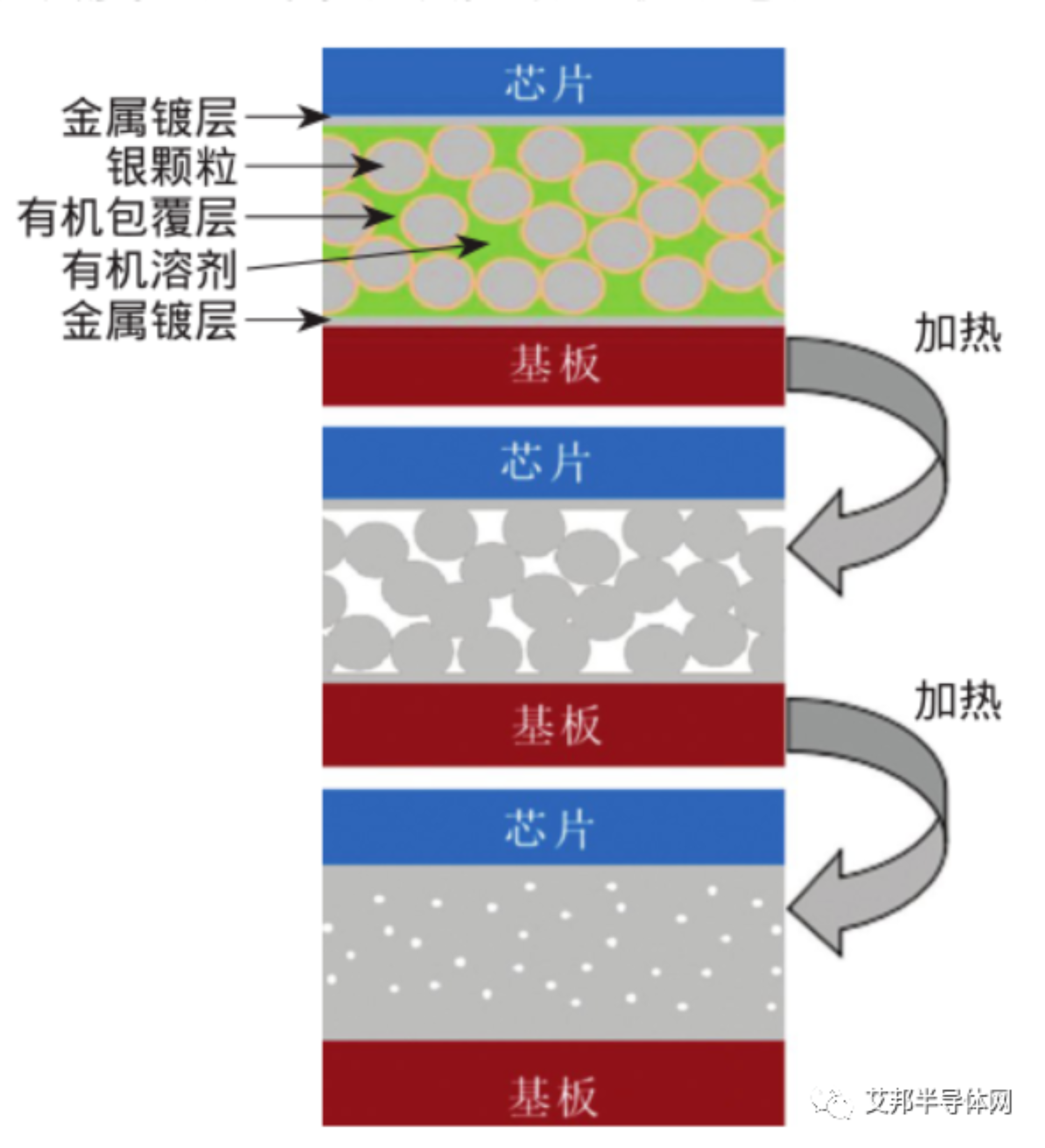
图 银浆烧结互联示意图
烧结得到的连接层为多孔性结构,孔洞尺寸在微米及亚微米级别,连接层具有良好的导热和导电性能,热匹配性能良好。

图 烧结银-电镀镍互连界面形貌
二、银烧结技术在功率模块封装的应用
作为高可靠性芯片连接技术,银烧结技术得到了功率模块厂商的广泛重视,一些功率半导体头部公司相继推出类似技术,已在功率模块的封装中取得了应用。
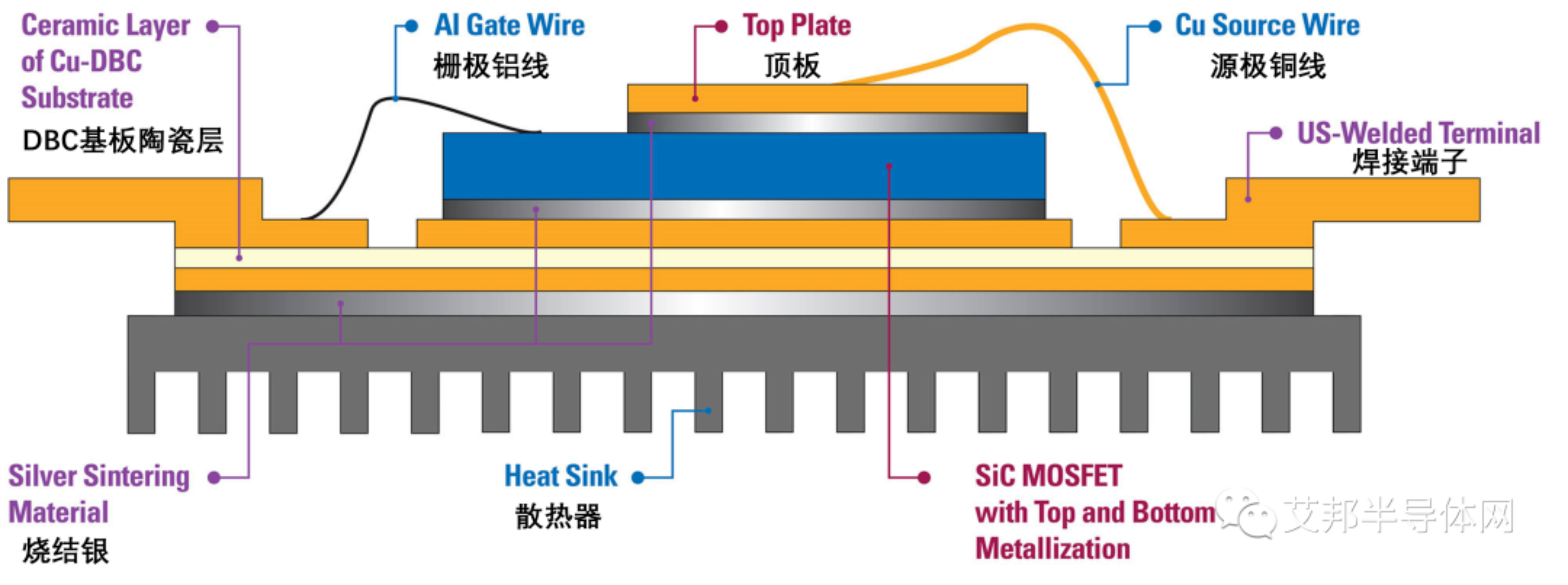
图 SiC MOSFET封装模块剖面图
2006年,英飞凌与开姆尼茨工业大学(Chemnitz University of Technology)等高校,采用银烧结技术的功率模块进行了高温循环测试。在Easypack功率模块中分别采用了单面银烧结技术和双面银烧结技术,测试结果表明,相对传统软钎焊工艺模块,采用单面银烧结技术的模块寿命提高5~10倍,采用双面银烧结技术的模块寿命提高10倍以上。2012年,英飞凌推出.XT封装连接技术(英飞凌高可靠封装与互连技术的统称),采用了扩散焊接工艺,在封装中实现了从芯片到散热器的可靠热连接。

图 大功率IGBT模块中的.XT技术
2007年,赛米控推出的功率模块技术SKiNTER,利用精细银粉,在高压及大约250°C温度条件下烧结为低气孔率的银层。其功率循环能力提升二至三倍,而且高运行温度下的烧结组件长期可靠。如下图所示,与烧结模块相比,焊接模块由于散热性差,很早就会因焊接老化引起芯片温度上升。芯片与DCB之间为烧结结合的模块使用寿命更长。
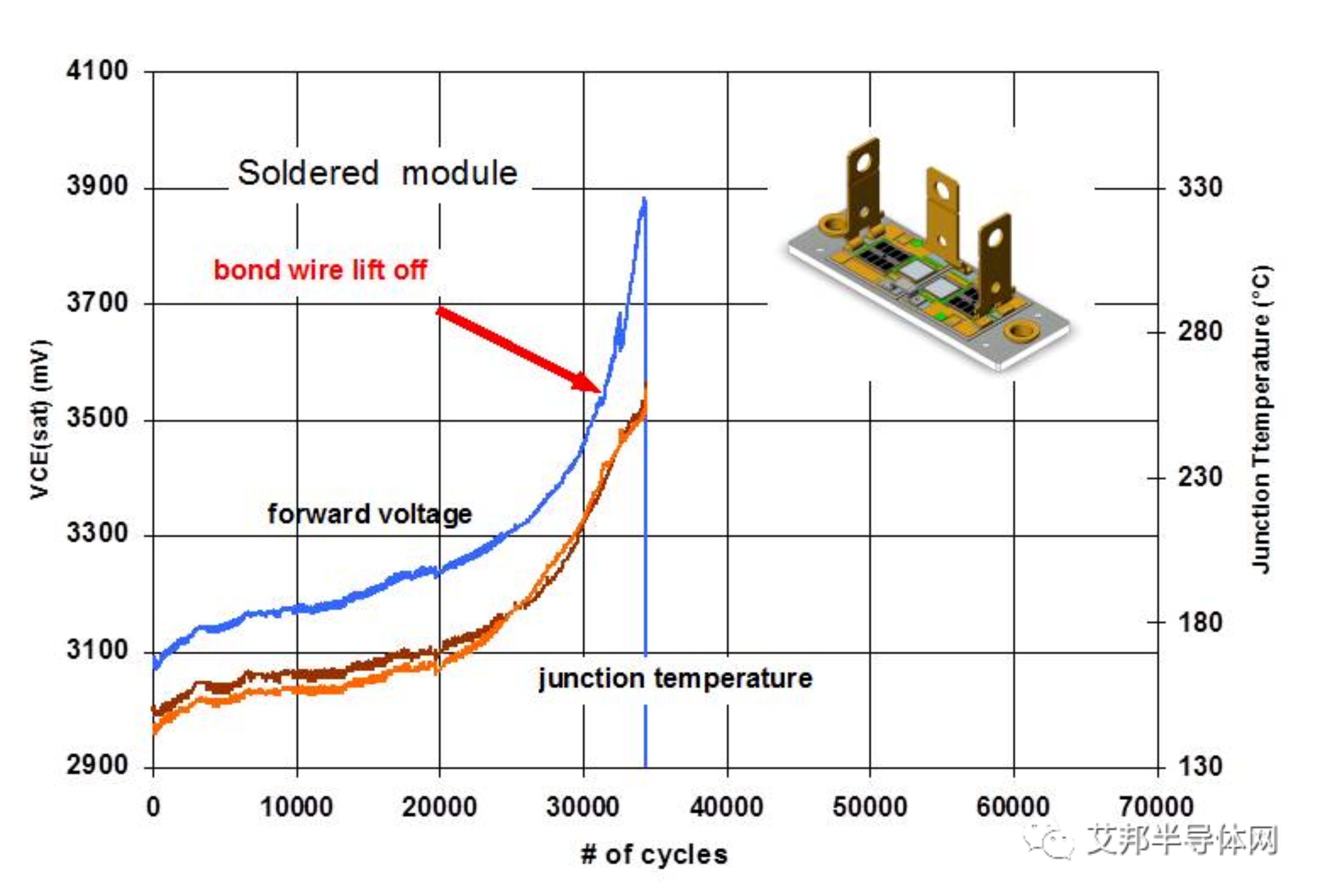
图 焊接功率模块与烧结功率模块最终的失效机理

图 焊接功率模块与烧结功率模块最终的失效机理,来源:赛米控
2015年,三菱电机采用银烧结技术制作出功率模块,循环寿命是软钎焊料(Sn-Ag-Cu-Sb)的5倍左右,并且三菱电机自主开发了加压烧结的专用设备。
如今,银烧结技术已经成为宽禁带半导体功率模块必不可少的技术之一,随着宽禁带半导体材料(SiC、GaN)的发展,银烧结技术将拥有良好的应用前景。
免责申明:本文内容转自:集成电路在线。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10 Solder Preforms
广州先艺电子科技有限公司是先进半导体连接材料制造商、电子封装解决方案提供商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成形焊片,提供微电子封装互连材料、微电子封装互连器件和第三代功率半导体封装材料系列产品,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








