厚膜电路无助焊剂共晶焊工艺
转自 众望微组装 微组装领域知识研讨分享
这篇文章主要摘取在厚膜电路当中共晶焊工艺的描述,涉及芯片背面金属化层、基板焊区金属化层、焊接压力、焊接气氛、焊接温度及焊接时间。
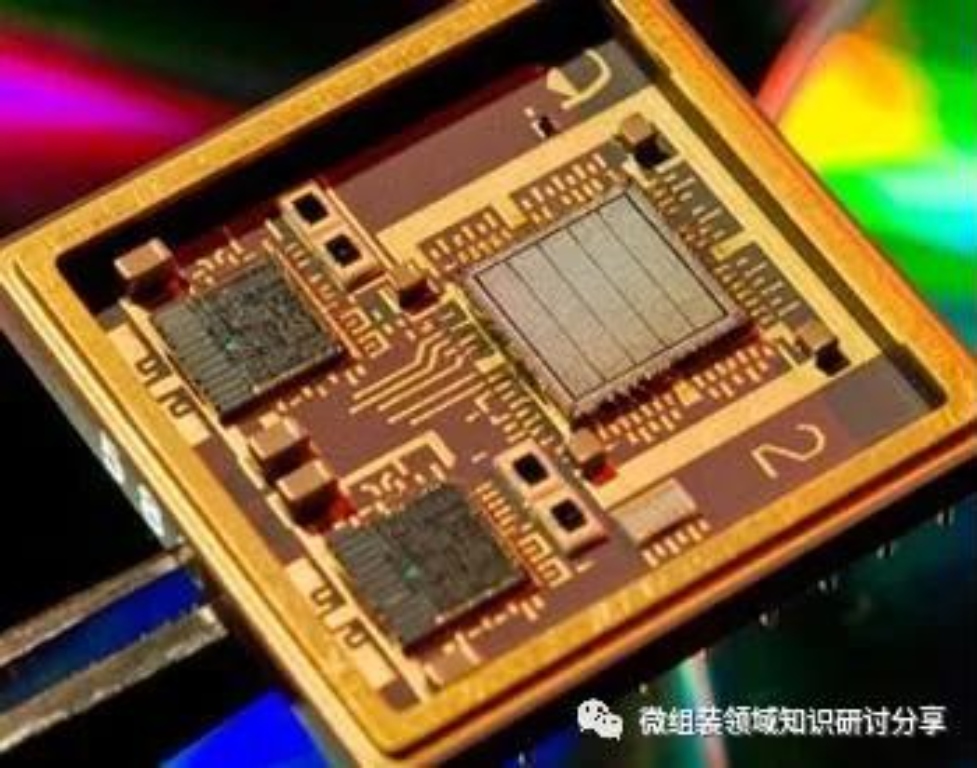
无助焊剂的共晶焊方法主要分为两大类:
1、加压法共晶,一般采用石墨夹具定位厚膜基板和元件,金属压块实现焊接压力 ,有效控制真空/气氛炉内气氛,通过预热、排气、真空、加温、降温和进气等过程,实现共晶全过程;
2、摩擦法共晶,采用镊子或吸嘴夹持元件,在焊接温度下,使芯片在基板表面焊区(已加焊料片)做相对摩擦,实现气氛和氧化物排出,达到低空洞率焊接。
无论哪种焊接方式,下述几个方面的工艺控制都极为重要:
1)、芯片背面金属化层;
2)、基板焊区金属化层;
3)、焊接压力( 主要针对加压法共晶);
4)、焊接气氛、焊接温度及焊接时间;
一、芯片背面金属化层影响研究
1、芯片背金共晶试验
采用焊料共晶时,裸芯片背面需要金属化(简称背金),金属化层分为单层金和多层金,单层金一般是在芯片背面溅射一层金或银,单层金因在焊接时很容易被含金或银焊料融蚀(俗称“吃金”),而导致芯片脱落,单层金芯片一般只适合环氧树脂粘接工艺。而焊接芯片背面一般溅射多层金,常见的镀层有(从内到外)钛镍银(TiNiAg)、钛镍金(TiNiAu)等,钛起到过渡作用,镍层起焊接作用,而金或银层则起防止镍层氧化的保护作用。
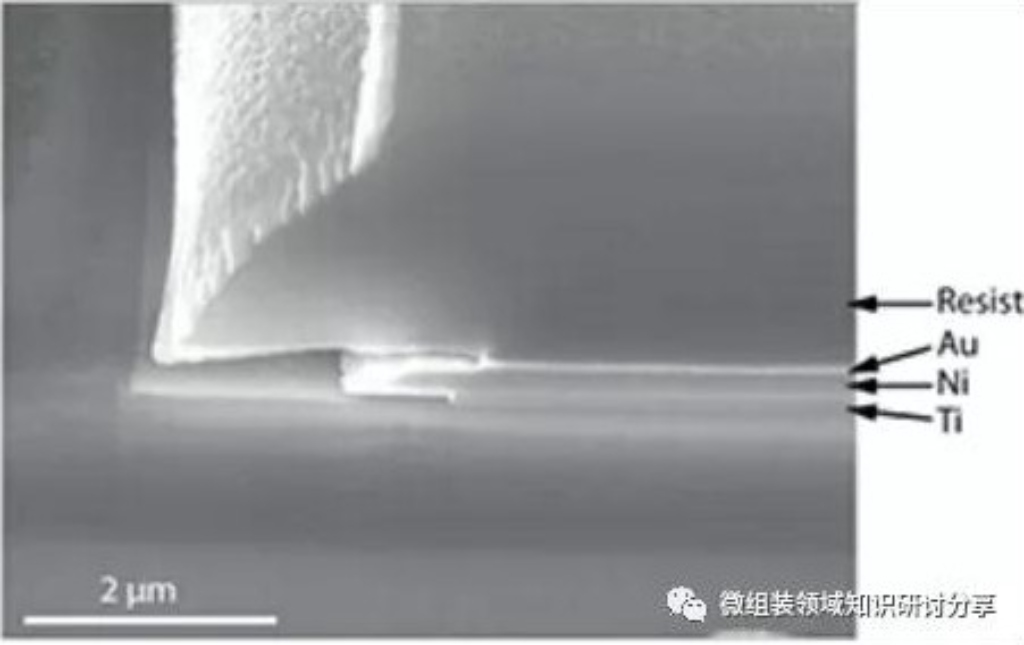


作为焊接层的镍层有着至关重要的作用,其厚度直接影响着焊接空洞率,随着焊接芯片的尺寸大小,对镍层的厚度要求也不相同,一般芯片越大,镀层要求越厚,芯片越小,则镀层要求越薄。以常规尺寸2*1mm的芯片为例,在焊接工艺过程条件相同情况下,分组进行芯片镀层(TiNiAg)厚度与空洞率的对比试验研究,结果见表2。

2、芯片背金共晶试验分析
在共晶时,熔融焊料首先熔掉芯片背面薄银层或薄金层,后与焊接层镍层焊接到一起。通过上述对比可知,当镍层厚度较小时,熔融焊料易从芯片边缘开始“吃”掉芯片镍层,形成从外到内的焊接空洞,之所以从外到内部,是由于共晶时芯片四周界的焊料量要远多于芯片底部,熔融能力要比芯片底部中心更强。
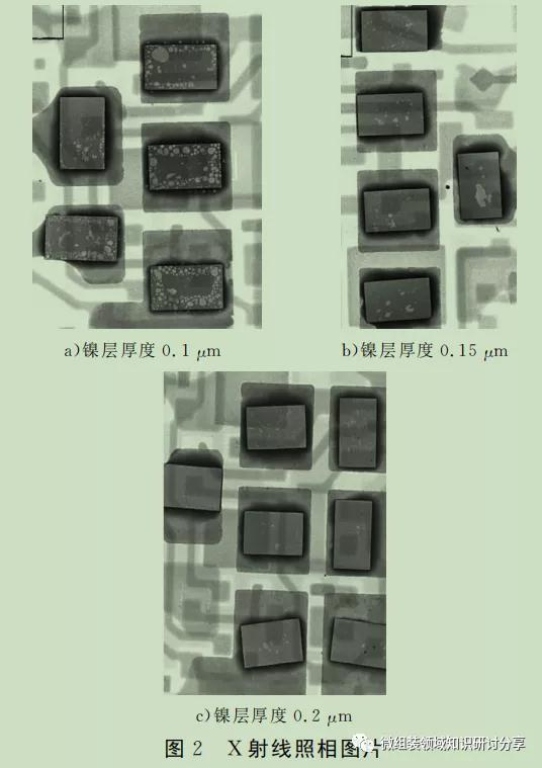
二、基板焊区金属化层影响研究
1、基板焊区金属化层共晶试验
相对于裸芯片溅射方式背金不同,厚膜混合电路一般采用丝网印刷的方式在陶瓷、氮化铝等基板表面沉积一层金属化层焊区,常见的焊区金属层有金、银和铂银等,一般单纯的金属层不适合焊接,因焊接过程中很容易被焊料熔融掉,因而基板焊区常选择掺杂阻焊金属,如铂银,但这类金属层的焊区厚度也至关重要。以不同厚度的铂银焊区为例,在共晶工艺过程条件相同情况下,进行金属层厚度与空洞率对比试验研究,结果见表3,X射线照相图片如图3所示。

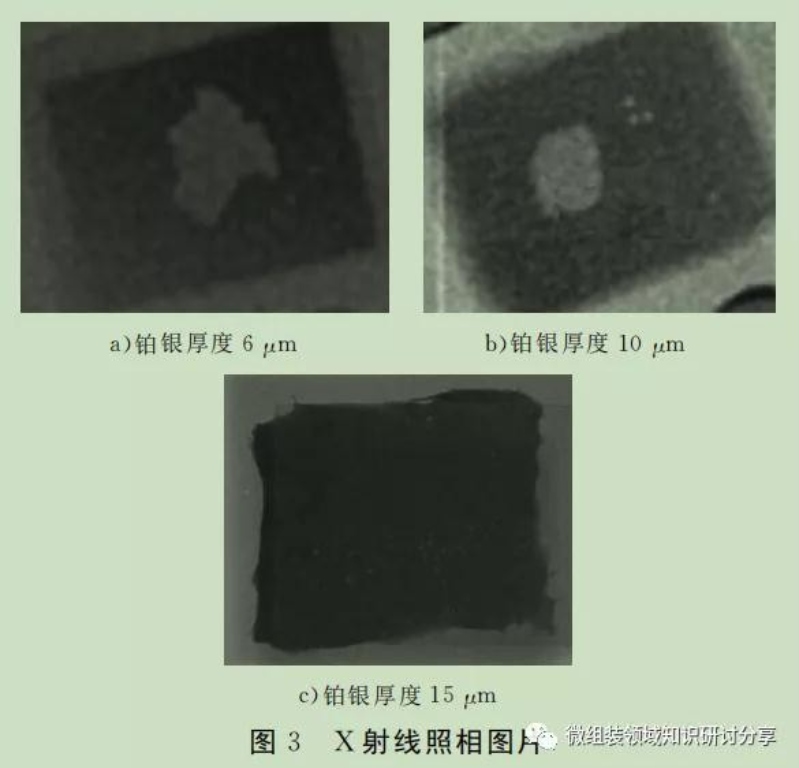
2、焊接压力共晶试验分析
在压力不足时,共晶时熔融焊料随机停留在某个区域,随着压力逐渐增加,焊料受压后基本均匀分布到芯片底部,并通过挤压逐渐排除随机分布的空洞。
四、焊接气氛、焊接温度及焊接时间研究
对于无助焊剂共晶焊,气氛保护尤为重要。在共晶时,如果惰性气氛不纯,混入氧气,当焊料熔融后,很快在其表面形成氧化膜,使焊料由于表面张力而缩成球状,严重影响焊料与焊接体的浸润效果,并大量增加焊接空洞率,甚至无法焊接。
对于焊接温度及焊接时间,焊接温度过高,焊接时间过长均可加速上述焊接空洞出现。一般而言,共晶炉设定的焊接温度比焊料合金的共融温度要高30-50度,但在满足焊接可靠性的情况下,焊接温度越低越好,焊接时间越短越好。对于摩擦法多芯片共晶,应依次完成所有芯片共晶,焊接总时间应控制好,避免当最后一个芯片完成后,第1个芯片因焊料长时间熔融芯片镀层或基片金属层而脱落,时间控制是多芯片共晶的难点,根据测试,采用Au80Sn20焊料共晶,总峰值焊接时间应严格控制在3min以内。
免责声明:以上文章来源众望微组装(微组装领域知识研讨分享),如有涉及侵权,请联系我们删除。
关键词:先艺电子、XianYi、先艺、金锡焊片、Au80Sn20焊片、低温共晶焊料、Solder Preform、芯片封装焊片供应商、芯片封装焊片生产厂家、低温钎焊片、太阳能电池片封装焊片、金锡合金焊片选型指南、预成形焊片尺寸选择、银基焊料、金属外壳气密封装、共晶烧结、金锡烧结、金锡共晶烧结、共晶键合、合金焊料、预成形锡片、锡带、SMT锡片、低温锡带、激光巴条焊接、激光巴条封装、载带式预成形焊片、覆膜预成形焊片、热沉、heat sink、光电子封装、MEMS封装、IGBT焊料片、锡片、中高温焊片、IGBT焊料片、锡片、纳米焊膏、纳米银膏、微组装、微纳连接、金锡bump、激光巴条共晶、Gold Tin Alloy、Gold Tin Solder、晶振封盖、电镀金锡、锡箔、锡环、锡框、flux coating、TO-CAN共晶、共晶贴片、低温锡膏、锡膏喷印、锡铋合金、纳米银焊膏、纳米银胶、纳米银浆、烧结银浆、烧结银膏、烧结银胶、导热银膏、导热银胶、导热银浆、银烧结膏、银纳米膏、Ag sinter paste、submount、薄膜电路、无助焊剂焊片、圆环预成形焊片、方框预成形焊片、金属化光纤连接焊片、金基焊料 、金锗焊料、金硅焊料、器件封装焊料、预涂焊料盖板、预涂助焊剂、预置焊片、金锡封装、箔状焊片、预制焊锡片、预镀金锡、预涂金锡、Fluxless Solder、气密封装钎焊、陶瓷绝缘子封装、气密性封焊金锡热沉、金锡衬底、金锡焊料封装、芯片到玻璃基板贴片 (COG)、铟焊料封装、金锡薄膜、金锡合金薄膜、合金焊料、金锡焊料、Au50Cu50焊片、Au80Cu20焊片、Au焊片、Au88Ge12焊片、Au99Sb1焊片、Sn焊片、激光巴条金锡共晶焊、背金锡、预置金锡盖板、贴膜包装焊片、金锡薄膜热沉、SMT用预成形焊片、载带式预成形焊片、IGBT大功率器件封装、锡银焊料片、锡锑焊料片、中高温焊片、异形焊料片、金锡焊膏、金锡凸点、Au80Sn20、铟铅焊片、铟铅合金、锡铋焊片
先艺电子、xianyi、www.xianyichina.com
广州先艺电子科技有限公司是先进半导体封装连接材料制造商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成型焊片,更多资讯请看www.xianyichina.com,或关注微信公众号“先艺电子”。








